Высоколегированные n+ области имеют малую глубину залегания  , это говорит о том, что диффузия будет протекать в 1 стадию. В качестве диффузанта n+ областей рекомендуется фосфор. Параметры которого представлены в таблице 3.1
, это говорит о том, что диффузия будет протекать в 1 стадию. В качестве диффузанта n+ областей рекомендуется фосфор. Параметры которого представлены в таблице 3.1
При расчете режимов одностадийной диффузии выбор времени и температуры диффузии так же, как и в случае двухстадийной диффузии, определяется из условия, что на глубине залегания p-n перехода концентрация введенной примеси равна концентрации исходной примеси
Концентрацию исходной примеси необходимо рассчитать на глубине 0,7 мкм в области «кармана» по следующей формуле (данные табл. 3.1):

Определим среднюю проводимость по формуле 3.1
Значение средней проводимости рассчитывается на поверхности, отсюда следует, что 

Из графика, представленного на рисунке 3.2 
Температурная зависимость коэффициента диффузии D(фосфор) определяется уравнением Аррениуса и имеет вид:

, где 1,5 – коэффициент, учитывающий большие концентрации примеси;
При одностадийной диффузии профиль распределения примеси подчиняется интегралу функции ошибок (3.12):
 (3.12)
(3.12)
Определим значение функции  по следующей формуле
по следующей формуле

Так как функция интеграла ошибок табулирована, то исходя из таблицы 3.4, получаем:

Таблица 3.4– Функция дополнения интеграла ошибок erfc z
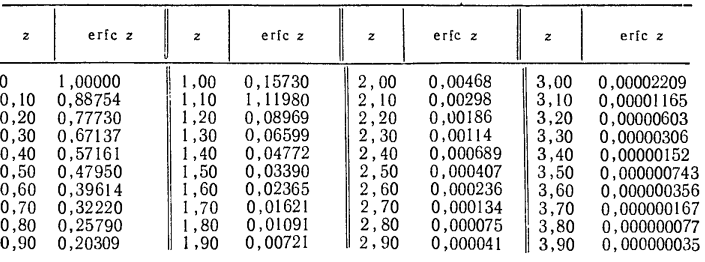
Из этого выражения выразим время загонки примеси (3.13):

 (3.13)
(3.13)
При  получаем:
получаем:

Параметры расчета одностадийной диффузии представлены в таблице 3.5
Таблица 3.5 Параметры расчета одностадийной диффузии фосфора

| 
| 
| 
| 
|
| 800
| 1073
| 
| 55954735
| 932578,9
|
| 850
| 1123
| 
| 6737724
| 112295,4
|
| 900
| 1173
| 
| 971769,7
| 16196,16
|
| 950
| 1223
| 
| 164200,6
| 2736,67
|
| 1000
| 1273
| 
| 31903,99
| 531,73
|
| 1050
| 1323
| 
| 7016,117
| 116,94
|
| 1100
| 1373
| 
| 1722,878
| 28,71
|
Наиболее удовлетворяет условию (  ) режим при
) режим при 
Для построения профиля легирования необходимы значения распределения исходной примеси по подложке  и распределения введенной примеси
и распределения введенной примеси  , представленные в формулах 3.14 и 3.15 соответственно.
, представленные в формулах 3.14 и 3.15 соответственно.
 (3.14)
(3.14)

Профили распределения примеси в базовой (Бор) и эмиттерной (Фосфор) области представлены на рисунке 3.3
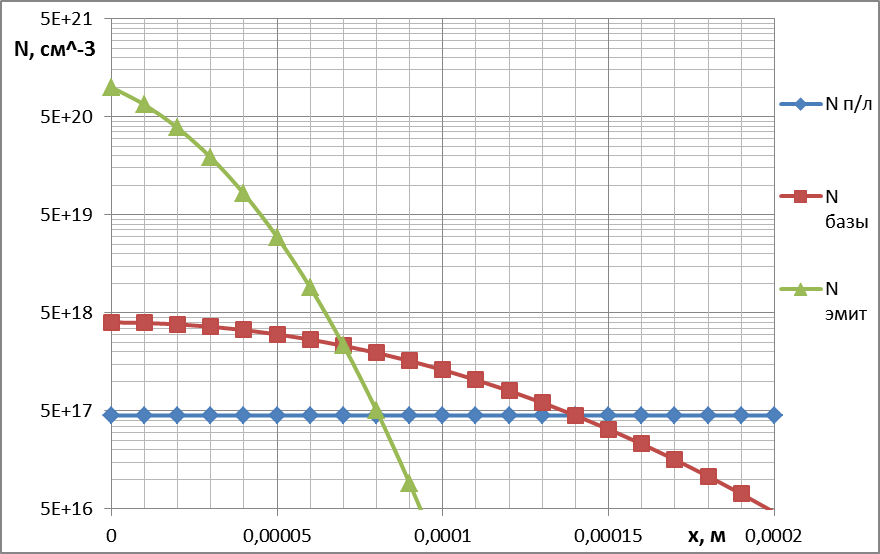
Рисунок 3.3 Профили распределения примеси в базовой (Бор) и эмиттерной (Фосфор) области
Для двух стадийной диффузии бора общее время диффузии составило 69 минут. Процесс диффузии характеризуется температурой и временем загонки примеси и температурой и временем ее разгонки. Для данного случая были выбраны следующие параметры:  и
и  ;
;  К и
К и  .
.
Одностадийная диффузия фосфора проходила в течение 28 минут при температуре 1323 К.
4 Расчёт погрешностей.
В основу расчета погрешностей диффузионных элементов положены функциональные связи выходных параметров этих элементов со свойствами и геометрией легированных областей. [4]
Для расчета точности зададимся параметрами резистора, таким образом, выберем резистор R3 с параметрами  , и длинной
, и длинной  .
.
Относительная погрешность сопротивления резистора определяется по формуле (4.1):
 (4.1)
(4.1)
, где  – относительная погрешность резистора по поверхностному сопротивлению;
– относительная погрешность резистора по поверхностному сопротивлению;
 – относительная погрешность по длине;
– относительная погрешность по длине;
 – онтосительная погрешность по ширине.
– онтосительная погрешность по ширине.
Погрешность изготовления резистора по длине имеет место лишь в том случае, когда длина резистора соизмерима с его шириной, и расчитывается аналогично погрешности по ширине. В большинстве же случаев длина резисторов много больше ширины и погрешностью по длине можно пренебречь.
Относительная погрешность резистора по поверхностному сопротивлению определяется по формуле:
 (4.2)
(4.2)
, где  - относительная погрешность средней проводимости;
- относительная погрешность средней проводимости;
 - относительная погрешность глубины залегания p – n – перехода.
- относительная погрешность глубины залегания p – n – перехода.
Относительную погрешность средней проводимости определим по формуле:
 (4.3)
(4.3)
, где  – тангенс угла наклона прямой, ограниченной точками с координатами
– тангенс угла наклона прямой, ограниченной точками с координатами  и
и  ;
;
 - относительная погрешность концентрации диффузионной области, равная 0,04.
- относительная погрешность концентрации диффузионной области, равная 0,04.
Тангенс угла наклона прямой определяется по формуле:
 , (4.4)
, (4.4)
 .
.
Теперь по формуле (4.3) определим относительную погрешность средней проводимости
 .
.
Относительная погрешность глубины залегания p – n – перехода определяется поформуле:
 (4.5)
(4.5)
, где  – энергия активации;
– энергия активации;
k – постоянная Больцмана;
 – температура разгонки, К;
– температура разгонки, К;
 - относительная погрешность по температуре разгонки;
- относительная погрешность по температуре разгонки;
 - относительная погрещность времени;
- относительная погрещность времени;
 - относительная погрешность концентрации диффузионной области, равная 0,04
- относительная погрешность концентрации диффузионной области, равная 0,04
 – поверхностная концентрация диффузионной области,
– поверхностная концентрация диффузионной области,  ;
;
 – концентрация исходной примеси,
– концентрация исходной примеси,  ;
;
 - относительная погрешность концентрации области, куда проводится диффузия, для монокристаллической подложки
- относительная погрешность концентрации области, куда проводится диффузия, для монокристаллической подложки  .
.
Определим относительную погрешность по температуре разгонки по формуле:
 (4.6)
(4.6)
, где  - точность поддержания температурной печи,
- точность поддержания температурной печи,  ;
;
 – температура разгонки, К.
– температура разгонки, К.
 . (4.7)
. (4.7)
Относительная погрешность времени определяется по формуле:
 , (4.8)
, (4.8)
,где  – точность поддержания времени печи,
– точность поддержания времени печи,  с;
с;
 – время разгонки, с.
– время разгонки, с.
 .
.
Теперь по формуле (4.5) определим относительную погрешность глубины залегания p – n – перехода:
 .
.
По формуле (4.2) определим относительную погрешность резистора по поверхностному сопротивлению:
 .
.
Для диффузионных резисторов, которые получают путем локальной диффузии через маску в слое  , относительная погрешность по ширине
, относительная погрешность по ширине  связана с тем, что примесь проникает не только перпендикулярно поверхности, но и под маску параллельно поверхности пластины. Величину боковой диффузии принимают равной удвоенной глубину залегания p – n – перехода.
связана с тем, что примесь проникает не только перпендикулярно поверхности, но и под маску параллельно поверхности пластины. Величину боковой диффузии принимают равной удвоенной глубину залегания p – n – перехода.
Относительная погрешность резистора по ширине определяется по формуле:
 (4.9)
(4.9)
,где  – относительная погрешность маски в слое SiO 2;
– относительная погрешность маски в слое SiO 2;
 - глубина залегания p – n – перехода, мкм;
- глубина залегания p – n – перехода, мкм;
b – ширина резистора, мкм;
 - относительная погрешность глубины залегания p – n – перехода.
- относительная погрешность глубины залегания p – n – перехода.
Относительная погрешность маски в слое SiO 2 определяется по формуле:
 (4.10)
(4.10)
,где  - абсолютная погрешность изготовления маски;
- абсолютная погрешность изготовления маски;
b – ширина резистора, мкм.
Абсолютная погрешность изготовления маски рассчитывается по формуле:
 (4.11)
(4.11)
, где  – точность установки совмещения и экспонирования, используемой при проведении контактной фотолитографии, УПСЭ-4:
– точность установки совмещения и экспонирования, используемой при проведении контактной фотолитографии, УПСЭ-4:
 ;
;
 – ошибка проявления фоторезиста. Возьмем позитивный фоторезист, для которого выполняется соотношение:
– ошибка проявления фоторезиста. Возьмем позитивный фоторезист, для которого выполняется соотношение:  ;
;  ;
;
 – ошибка травления рабочего слоя, которая при жидкостном химическом травлении равна удвоенной толщине пленки хрома:
– ошибка травления рабочего слоя, которая при жидкостном химическом травлении равна удвоенной толщине пленки хрома:  ,
,
 .
.
Погрешность изготовления ФШ по оптико-механическому методу складывается из погрешностей, допускаемых на каждом этапе изготовления ФШ:
1) изготовление оригинала ФШ;
2) изготовление промежуточного ФШ;
3) изготовление эталонного ФШ;
4) изготовление рабочего ФШ.
Погрешность изготовления оригинала ФШ определяется по формуле:
 , (4.12)
, (4.12)
, где  – точность вырезания рисунка на координатографе. Для автоматизированного координатографа
– точность вырезания рисунка на координатографе. Для автоматизированного координатографа  ;
;
 – масштаб увеличения оригинала.
– масштаб увеличения оригинала.
Возьмем масштаб увеличения оригинала равный 
тогда
 .
.
Погрешность изготовления промежуточного ФШ определяется по формуле:
 , (4.13)
, (4.13)
, где  – погрешность изготовления оригинала ФШ;
– погрешность изготовления оригинала ФШ;
 – ошибка редукционной установки ЭМ-513:
– ошибка редукционной установки ЭМ-513:  ;
;
 – ошибка проявления эмульсионного слоя:;
– ошибка проявления эмульсионного слоя:; 

 – масштаб промежуточного ФШ:
– масштаб промежуточного ФШ:  .
.
 .
.
Погрешность изготовления эталонного ФШ:
 , (4.14)
, (4.14)
, где  - погрешность изготовления промежуточного ФШ;
- погрешность изготовления промежуточного ФШ;
 - ошибка фотоповторителя ЭМ – 552:
- ошибка фотоповторителя ЭМ – 552:  ;
;
 - ошибка проявления эмульсионного слоя
- ошибка проявления эмульсионного слоя  ;
;
 .
.
Погрешность изготовления рабочего ФШ определяется по формуле:
 (4.15)
(4.15)
, где  - погрешность изготовления эталонного ФШ;
- погрешность изготовления эталонного ФШ;
 – точность установки совмещения и экспонирования, используемой при проведении контактной фотолитографии, УПСЭ-4:
– точность установки совмещения и экспонирования, используемой при проведении контактной фотолитографии, УПСЭ-4:  ;
;
 ошибка проявления фоторезиста:
ошибка проявления фоторезиста:  ;
;  .
.
 – ошибка травления рабочего слоя.
– ошибка травления рабочего слоя.
 .
.
Теперь по формуле (4.11) рассчитаем абсолютную погрешность изготовления маски:
 .
.
Зная абсолютную погрешность изготовления маски, определим относительную погрешность маски по формуле (4.10):
 .
.
Теперь по формуле (4.9) определим относительную погрешность резистора по ширине:
 .
.
Теперь найдем относительную погрешность сопротивления диффузионного резистора по формуле (4.1):
 .
.
В нашем случае относительная погрешность сопротивления диффузионного резистора получилась 33%, что не удовлетворяет условию  . Довольно большой вклад в погрешность вносит боковая диффузия. Погрешность вносимую боковой диффузией, можно значительно уменьшить на стадии проектирования фотошаблонов.
. Довольно большой вклад в погрешность вносит боковая диффузия. Погрешность вносимую боковой диффузией, можно значительно уменьшить на стадии проектирования фотошаблонов.
В нашем случае мы должны учесть, что боковая диффузия дает большую погрешность, и при проектировании фотошаблонов мы должны сделать все возможное, чтобы уменьшить ее.





 , это говорит о том, что диффузия будет протекать в 1 стадию. В качестве диффузанта n+ областей рекомендуется фосфор. Параметры которого представлены в таблице 3.1
, это говорит о том, что диффузия будет протекать в 1 стадию. В качестве диффузанта n+ областей рекомендуется фосфор. Параметры которого представлены в таблице 3.1




 (3.12)
(3.12) по следующей формуле
по следующей формуле

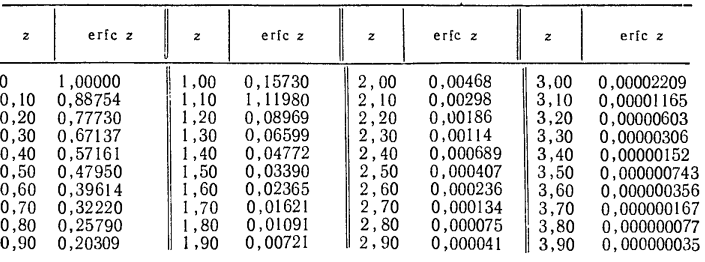
 (3.13)
(3.13) получаем:
получаем:












 ) режим при
) режим при 
 и распределения введенной примеси
и распределения введенной примеси  , представленные в формулах 3.14 и 3.15 соответственно.
, представленные в формулах 3.14 и 3.15 соответственно. (3.14)
(3.14)
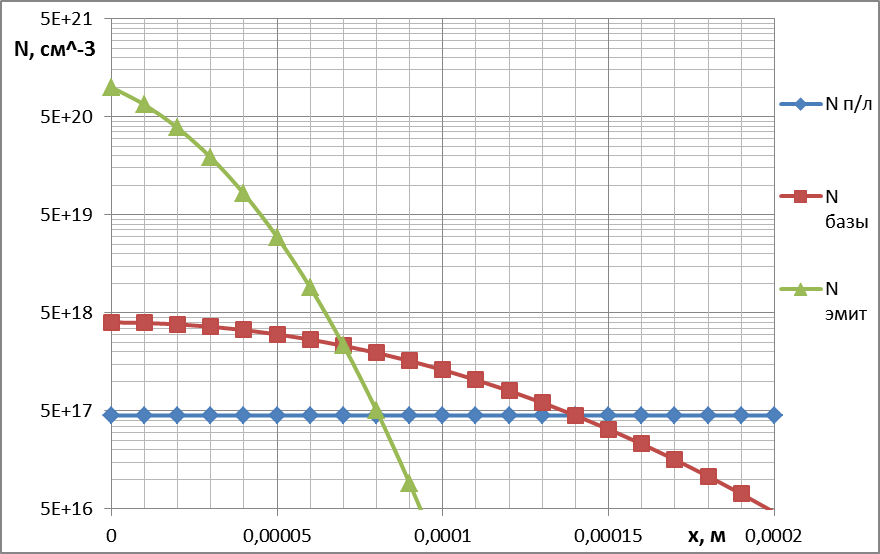
 и
и  ;
;  К и
К и  .
. , и длинной
, и длинной  .
. (4.1)
(4.1) – относительная погрешность резистора по поверхностному сопротивлению;
– относительная погрешность резистора по поверхностному сопротивлению; – относительная погрешность по длине;
– относительная погрешность по длине; – онтосительная погрешность по ширине.
– онтосительная погрешность по ширине. (4.2)
(4.2) - относительная погрешность средней проводимости;
- относительная погрешность средней проводимости; - относительная погрешность глубины залегания p – n – перехода.
- относительная погрешность глубины залегания p – n – перехода. (4.3)
(4.3) – тангенс угла наклона прямой, ограниченной точками с координатами
– тангенс угла наклона прямой, ограниченной точками с координатами  и
и  ;
; - относительная погрешность концентрации диффузионной области, равная 0,04.
- относительная погрешность концентрации диффузионной области, равная 0,04. , (4.4)
, (4.4) .
. .
. (4.5)
(4.5) – энергия активации;
– энергия активации; – температура разгонки, К;
– температура разгонки, К; - относительная погрешность по температуре разгонки;
- относительная погрешность по температуре разгонки; - относительная погрещность времени;
- относительная погрещность времени; – поверхностная концентрация диффузионной области,
– поверхностная концентрация диффузионной области,  ;
; – концентрация исходной примеси,
– концентрация исходной примеси,  - относительная погрешность концентрации области, куда проводится диффузия, для монокристаллической подложки
- относительная погрешность концентрации области, куда проводится диффузия, для монокристаллической подложки  .
. (4.6)
(4.6) - точность поддержания температурной печи,
- точность поддержания температурной печи,  ;
; . (4.7)
. (4.7) , (4.8)
, (4.8) – точность поддержания времени печи,
– точность поддержания времени печи,  с;
с; – время разгонки, с.
– время разгонки, с. .
. .
.  .
. , относительная погрешность по ширине
, относительная погрешность по ширине  (4.9)
(4.9) – относительная погрешность маски в слое SiO 2;
– относительная погрешность маски в слое SiO 2; - глубина залегания p – n – перехода, мкм;
- глубина залегания p – n – перехода, мкм; (4.10)
(4.10) - абсолютная погрешность изготовления маски;
- абсолютная погрешность изготовления маски; (4.11)
(4.11) – точность установки совмещения и экспонирования, используемой при проведении контактной фотолитографии, УПСЭ-4:
– точность установки совмещения и экспонирования, используемой при проведении контактной фотолитографии, УПСЭ-4: ;
; – ошибка проявления фоторезиста. Возьмем позитивный фоторезист, для которого выполняется соотношение:
– ошибка проявления фоторезиста. Возьмем позитивный фоторезист, для которого выполняется соотношение:  ;
;  ;
; – ошибка травления рабочего слоя, которая при жидкостном химическом травлении равна удвоенной толщине пленки хрома:
– ошибка травления рабочего слоя, которая при жидкостном химическом травлении равна удвоенной толщине пленки хрома:  ,
,  .
. , (4.12)
, (4.12) – точность вырезания рисунка на координатографе. Для автоматизированного координатографа
– точность вырезания рисунка на координатографе. Для автоматизированного координатографа  ;
; – масштаб увеличения оригинала.
– масштаб увеличения оригинала.
 .
. , (4.13)
, (4.13)  – погрешность изготовления оригинала ФШ;
– погрешность изготовления оригинала ФШ; – ошибка редукционной установки ЭМ-513:
– ошибка редукционной установки ЭМ-513:  ;
; – ошибка проявления эмульсионного слоя:;
– ошибка проявления эмульсионного слоя:; 

 – масштаб промежуточного ФШ:
– масштаб промежуточного ФШ:  .
. .
. , (4.14)
, (4.14) - погрешность изготовления промежуточного ФШ;
- погрешность изготовления промежуточного ФШ; - ошибка фотоповторителя ЭМ – 552:
- ошибка фотоповторителя ЭМ – 552:  ;
; - ошибка проявления эмульсионного слоя
- ошибка проявления эмульсионного слоя  ;
; .
. (4.15)
(4.15) - погрешность изготовления эталонного ФШ;
- погрешность изготовления эталонного ФШ; – точность установки совмещения и экспонирования, используемой при проведении контактной фотолитографии, УПСЭ-4:
– точность установки совмещения и экспонирования, используемой при проведении контактной фотолитографии, УПСЭ-4:  ошибка проявления фоторезиста:
ошибка проявления фоторезиста:  .
. .
. .
. .
. .
. . Довольно большой вклад в погрешность вносит боковая диффузия. Погрешность вносимую боковой диффузией, можно значительно уменьшить на стадии проектирования фотошаблонов.
. Довольно большой вклад в погрешность вносит боковая диффузия. Погрешность вносимую боковой диффузией, можно значительно уменьшить на стадии проектирования фотошаблонов.


