
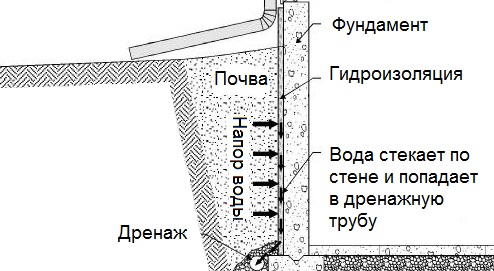
Общие условия выбора системы дренажа: Система дренажа выбирается в зависимости от характера защищаемого...

Индивидуальные и групповые автопоилки: для животных. Схемы и конструкции...
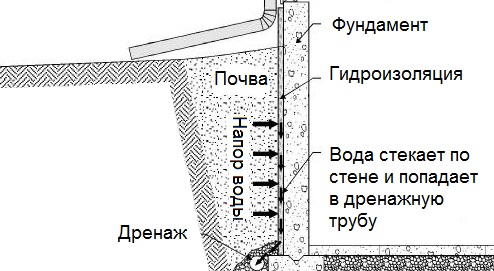
Общие условия выбора системы дренажа: Система дренажа выбирается в зависимости от характера защищаемого...

Индивидуальные и групповые автопоилки: для животных. Схемы и конструкции...
Топ:
Комплексной системы оценки состояния охраны труда на производственном объекте (КСОТ-П): Цели и задачи Комплексной системы оценки состояния охраны труда и определению факторов рисков по охране труда...
Оснащения врачебно-сестринской бригады.
Теоретическая значимость работы: Описание теоретической значимости (ценности) результатов исследования должно присутствовать во введении...
Интересное:
Распространение рака на другие отдаленные от желудка органы: Характерных симптомов рака желудка не существует. Выраженные симптомы появляются, когда опухоль...
Берегоукрепление оползневых склонов: На прибрежных склонах основной причиной развития оползневых процессов является подмыв водами рек естественных склонов...
Лечение прогрессирующих форм рака: Одним из наиболее важных достижений экспериментальной химиотерапии опухолей, начатой в 60-х и реализованной в 70-х годах, является...
Дисциплины:
|
из
5.00
|
Заказать работу |
|
|
|
|
Для изготовления кристаллов микросхем, оптопар и оптореле используется планарная технология. Последовательность выполнения операций по изготовлению кристаллов представлена в таблице 1.
Таблица 1- Технологический процесс изготовления кристаллов микросхем с приемкой «5»
| Наименование процесса | Метод выполнения | Параметры микроклимата | ||
| Класс чистоты на рабочем месте | Темпера-тура, 0С | Относи-тельная влажно-сть, % | ||
| Химическая обработка пластин | Травление | 22±2 | 50±10 | |
| Формирование диэлектрического слоя | Термическое окисление | 22±2 | 50±10 | |
| 1 фотолитография (нанесе-ние фоторезиста, совмеще-ние, проявление, снятие фоторезита, травление) | Контактная | 22±1 | 45±5 | |
| Разделительная диффузия бора | Нанесение БСС, загонка бора, рас-кисление БСС, разгонка бора | 22±2 | 50±10 | |
| Химическая отмывка пластин | 22±2 | 50±10 | ||
| 2 фотолитография | 22±1 | 45±5 | ||
| Формирование глубокого коллектора | Диффузия фосфо-ра, снятие ФС, разгонка фосфора | 22±2 | 50±10 | |
| 3 фотолитография | 22±1 | 45±5 | ||
| Формирование базовых областей | Ионное легирова-ние фосфором | 22±2 | 50±10 |
Продолжение таблицы 1
| Наименование процесса | Метод выполнения | Параметры микроклимата | ||
| Класс чистоты на рабочем месте | Темпера-тура, 0С | Относи-тельная влажно-сть, % | ||
| Формирование эмиттерных областей | Диффузия фосфора | 22±2 | 50±10 | |
| 5 фотолитография под контакты | 22±1 | 45±5 | ||
| Металлизация контактов | Вакуумное напыление алюминия | 22±2 | 50±10 | |
| 6 фотолитография по алюминию | 22±1 | 45±5 | ||
| Вжигание алюминия | Термическая обработка | 22±2 | 50±10 | |
| Создание защитного слоя ФСС | Осаждение пленки ФСС | 22±2 | 50±10 | |
| 7 фотолитография для вскрытия контактов | 22±1 | 45±5 | ||
| Прецизионная шлифовка пластин | 22±2 | 50±10 | ||
| Гидромеханическая отмывка | 22±2 | 50±10 | ||
| Контроль электрических параметров тестовых элементов пластин | Снятие ВАХ на Л2-52 | 22±2 | 50±10 | |
| Измерение электрических параметров кристаллов на пластине | Рассортировка на годные и брак на измерительном комплексе | 22±2 | 50±10 | |
| Контроль внешнего вида кристаллов на пластине | Выборочно под микроскопом при 100х | 22±2 | 50±10 |
После того, как процесс изготовления кристаллов закончен, пластины переходят на следующий этап производства. Последовательность выпол-нения операций по изготовлению микросхем представлена в таблице 2.
|
|
Таблица 2- Технологический процесс изготовления микросхем с приемкой «5»
| Наименование процесса | Метод выполнения | Параметры микроклимата | ||
| Класс чистоты на рабочем месте | Темпера-тура, 0С | Относи-тельная влажно-сть, % | ||
| Разделение пластин на кристаллы | Дисковая резка с последующей лом-кой и растяжкой | 22±2 | 50±10 | |
| Контроль внешнего вида кристаллов | Под микроскопом при 100х | 22±2 | 50±10 | |
| Посадка кристаллов в корпус | Наклейка | 22±2 | 50±10 | |
| Присоединение проволочных выводов (Al и Au) | Ультразвуковая или термокомпрес-сионная, или контактная сварка | 22±2 | 50±10 | |
| Контроль прочности сварных соединений (выборочно) | Приложение фиксированной нагрузки (для Au) или до полного разрушения сое-динения (для Al) | 22±2 | 50±10 | |
| Заливка (защита) компаундами | Дозированное нанесение с после-дующей сушкой | 22±2 | 50±10 | |
| Герметизация | Контактная шовная сварка в контроли-руемой азотной среде | 22±2 | 50±10 |
Продолжение Таблицы 2
| Наименование процесса | Метод выполнения | Параметры микроклимата | ||
| Класс чистоты на рабочем месте | Темпера-тура, 0С | Относи-тельная влажно-сть, % | ||
| Термовыдержка Термоциклированние | Выдержка в камере при повышенной температуре (или пониженной) без электрической нагрузки | 22±2 | 50±10 | |
| Испытание на воздействие линейного ускорения | Приложение к микросхемам центростремительного ускорения на центрифуге | 22±2 | 50±10 | |
| Измерение электрических параметров изделий | Сортировка на годные и брак на измерительном комплексе | 22±2 | 50±10 | |
| Проверка герметичности | Электронно-захват-ное течеискание на микросхемах, оп-рессованных элега-зом | 22±2 | 50±10 | |
| Маркирование | Офсетная печать | 22±2 | 50±10 | |
| Контроль внешнего вида готовых изделий | Визуальный осмотр | 22±2 | 50±10 | |
| Упаковка | Антистатическая индивидуальная укладка и группо-вая упаковка в картонную коробку | 22±2 | 50±10 |
|
|
6 Индивидуальное задание по производственной практике
студента группы 31-В Сорока Владимира Владимировича
1 Тема задания: Изучение техпроцесса контроля герметичности микросхем и разработка технологической документации.
2 Срок сдачи студентом отчёта «25» августа 2012г.
3 Исходные данные: Методика контроля герметичности ИЭТ с помощью электронно-захватного течеискателя 13ТЭ-9-001.
4 Содержание отчёта:
А) Назначение
Методика предназначена для контроля герметичностим ИЭТ методом электронно-захватного течеискания.
Б) Общие положения
Метод 401-8 – проверка герметичности микросхем путем обнаружения утечки введенного в них элегаза или содержащегося в них воздуха, регистрируемой электронно-захватным течеискателем в едином цикле испытаний (малые, средние и большие течи).
Принцип работы электронно-захватного течеискателя заключается в непрерывном засасывании воздуха щупом, который перемещается оператором над поверхностью корпуса ИЭТ, пропускании этого воздуха через детектор и регистрации детектором наличия в воздухе примесей пробного газа (элегаза). Определение местоположения течи и оценки ее величины осуществляется по изменению амплитуды сигнала детектора.
В) Аппаратура, материалы
Течеискатель электронно-захватный 13ТЭ-9-001, включающий в себя преобразователь электронно-захватный ПЭ-1 и блок измерительный БИТЭ-1.
Камера опресовки.
Камера измерительная.
Азот технический (сорт не ниже первого) или особой чистоты, ГОСТ 9293-74.
Аргон (любого сорта), ГОСТ 10157-79.
Элегаз (гексафторид серы SF6) или другой электроотрицательный газ, в т.ч. атмосферный воздух.
Г) Подготовка и проведение контроля
Промыть изделие в деионизованной воде и просушить на воздухе или в сушильном шкафу.
|
|
Поместить изделие в камеру опрессовки, откачать камеру до давления не более 100 Па, заполнить ее элегазом и опрессовать изделие.
Руководитель практики от предприятия:
_____________ «» __________ 2012 г.
подпись дата
Руководитель практики от университета
Н.А. Сафронова
_____________ «» __________ 2012 г.
подпись дата
Задание принял к исполнению.
Студент: В.В. Сорока
_____________ «» __________ 2012 г.
подпись дата
ЛИТЕРАТУРА
1. ОАО Протон [Электронный ресурс]: (с изм. и доп.) – Режим доступа: http://www.proton-orel.ru/; (дата обращения 08.08.2012)
2. Иванов А., Каноныхин Д. Знакомство с технологией шовно-роликовой герметизации // Силовая Электроника. 2011. №2. С. 90
3. ГОСТ 2.105-95 ЕСКД. Общие требования к текстовым документам.
4. ГОСТ 2.701-84 ЕСКД. Схемы. Виды и типы. Общие требования к выполнению.
5. ГОСТ 2.103-68 ЕСКД. Стадии разработки.
ПРИЛОЖЕНИЕ А
|
|
|

Индивидуальные очистные сооружения: К классу индивидуальных очистных сооружений относят сооружения, пропускная способность которых...

Индивидуальные и групповые автопоилки: для животных. Схемы и конструкции...

Наброски и зарисовки растений, плодов, цветов: Освоить конструктивное построение структуры дерева через зарисовки отдельных деревьев, группы деревьев...

Типы сооружений для обработки осадков: Септиками называются сооружения, в которых одновременно происходят осветление сточной жидкости...
© cyberpedia.su 2017-2024 - Не является автором материалов. Исключительное право сохранено за автором текста.
Если вы не хотите, чтобы данный материал был у нас на сайте, перейдите по ссылке: Нарушение авторских прав. Мы поможем в написании вашей работы!