Сверхвысокочастотными называют полупроводниковые диоды, используемые для преобразования, детектирования, усиления, умножения, генерирования и управления уровнем мощности сигналов сантиметрового и миллиметрового диапазона волн.
На высоких частотах (свыше 30 МГц) реактивности начинают сильно сказываться, особенно барьерная емкость, которая при закрытом диоде обусловливает паразитное прохождение переменной составляющей сигнала. Радикальный путь уменьшения барьерной емкости состоит в уменьшении площади р-n -перехода. Первым конструктивным вариантом на этом пути являются точечные формовочные диоды (рис. 4.18).

Рис. 4.18. Точечный формовочный диод
Базой диода является монокристалл германия или кремния n -типа. С одной стороны, база имеет омический контакт с держателем, а с другой - к ней прижимается вольфрамовая игла с небольшим количеством примеси на конце. Для образования перехода применяют электроформовку - пропускание короткого импульса тока. Под действием импульса тока место контакта разогревается, и примесь диффундирует в базу, образуя область эмиттера микроскопических размеров. Точечные диоды могут пропускать выпрямленный ток до нескольких десятков миллиампер и иметь обратные напряжения до 150 В. Общая емкость таких диодов не превышает 1 пФ, что позволяет использовать их на частотах до 300 - 600 МГц.
Для работы в диапазоне СВЧ применяются бесформовочные точечные диоды (рис. 4.19). В таких диодах используется переход металл - полупроводник (переход Шоттки) между вольфрамовым эмиттером и полупроводниковой базой диода. Острозаточенная игла-пружина создает переход с диаметром не менее 30 мкм, что обеспечивает уменьшение барьерной емкости до сотых долей пикофарады.

а
б
Рис. 4.19. Точечный бесформовочный диод: а – точечный
переход металл – полупроводник; б – конструкция
СВЧ-диода: 1 – верхний вывод; 2 – настроечный штифт;
3 – вольфрамовая игла – пружина; 4 – керамический
изолятор; 5 – кристаллодержатель с кристаллом – нижний вывод
Диапазон рабочих частот бесформовочных диодов достигает десятков гигагерц. Так как это СВЧ-диапазон, то конструкция корпуса выбирается 30 мкм, что обеспечивает уменьшение барьерной емкости до сотых долей пикофарады. Диапазон рабочих частот бесформовочных диодов достигает десятков гигагерц. Так как это СВЧ-диапазон, то конструкция корпуса выбирается с расчетом минимизации индуктивности выводов и обеспечения удобства сочленения с коаксиальными кабелями, волноводами и полосковыми линиями. Существенный недостаток таких диодов - чувствительность к механическим и электрическим нагрузкам. Даже кратковременно рассеиваемая мощность в таких диодах не должна превышать 100 мВт при обратных напряжениях 3 - 5 В. Для защиты от внешних излучений точечные диоды СВЧ хранятся и транспортируются в специальных металлических защитных колпачках.
Импульсные диоды
Импульсные диоды – полупроводниковые диоды, используемые в качестве ключевых элементов в схемах при воздействии импульсов малой длительности (микросекунды, доли микросекунд).
Одно из важнейших требований к ним – надежная работа в цепях с высокой частотой, например до 500 МГц. Импульсные диоды обладают высоким быстродействием, т.е. малым временем восстановления высокого обратного сопротивления при изменении полярности приложенного напряжения с прямой на обратную. Улучшение временных параметров достигается снижением емкости перехода и сокращением времени жизни носителей заряда. Этому требованию удовлетворяют диоды точечного типа. Могут быть использованы и диоды с р-п- переходом, изготовленным по диффузионной технологии. В цепях с напряжением до нескольких киловольт применяются выпрямительные столбы, состоящие из последовательно соединенных выпрямительных элементов, объединенных в одном корпусе.
Условия работы импульсных диодов обычно соответствуют высокому уровню инжекции, то есть относительно высоким токам. Поэтому свойства и параметры импульсных диодов определяются переходными процессами, рассмотренными в главе 2.
При переключении диода с прямого направления на обратное в начальный момент времени через диод идет большой обратный ток, ограниченный в основном объемным сопротивлением базы (при идеальном генераторе напряжения). С течением времени накопленные в базе неосновные носители заряда рекомбинируют или уходят из базы через р-п -переход, после чего обратный ток уменьшается до своего стационарного значения (рис. 4.20, а). Переходный процесс, в течение которого обратное сопротивление полупроводникового диода восстанавливается до постоянного значения после быстрого переключения с прямого направления на обратное, называют восстановлением обратного сопротивления диода.

Рис. 4.20. Осциллограммы токов и напряжений импульсного диода при его работе в схемах с генератором напряжения (а) и с генератором тока (б)
При пропускании импульса тока в прямом направлении через диод наблюдается выброс напряжения в первый момент после включения (рис. 4.20, б). Вызвано это повышенным падением напряжения до тех пор, пока не произойдет накопление неосновных носителей заряда в базе диода в результате инжекции и не уменьшится объемное сопротивление базы. Переходный процесс, в течение которого прямое сопротивление полупроводникового диода устанавливается до постоянного значения после быстрого включения диода в прямом направлении, называют установлением прямого сопротивления диода.
Специфическими параметрами импульсных диодов являются время установления прямого напряжения диода и время восстановления обратного сопротивления.
Время установленияпрямого напряжения диода t уст - это интервал времени от момента подачи импульса прямого напряжения на диод до момента достижения заданного значения прямого тока.
Время восстановления обратного сопротивления t вос - это интервал времени от момента прохождения тока через ноль после переключения диода с заданного прямого тока в состояние заданного обратного напряжения до момента достижения обратным током заданного низкого значения.
По времени восстановления импульсные диоды подразделяют на три группы:
- высокого быстродействия (t вос £ 10 нс);
- среднего быстродействия (10 нс £ t вос £ 100 нс);
- низкого быстродействия (t вос > 100нс).
Импульсные диоды характеризуются также величинами максимального прямого и обратного импульсного тока, максимального импульсного прямого сопротивления.
Время, в течение которого обратный ток постоянен, называют временем среза.
Для импульсных диодов время среза t ср и время восстановленияобратного сопротивления диода являются важными параметрами. Для уменьшения их значения существуют несколько способов. Во-первых, можно уменьшать время жизни неравновесных носителей в базе диода за счет введения глубоких рекомбинационных центров в квазинейтральном объеме базы. Во-вторых, можно делать базу диода тонкой для того, чтобы неравновесные носители рекомбинировали на тыльной стороне базы.
Другим способом уменьшения времени восстановления обратного сопротивления является использование базы с неравномерной концентрацией примеси. У таких диодов концентрация примесей в базе при приближении к р-п -переходу уменьшается, поэтому неравномерной оказывается и концентрация основных носителей ‑ электронов. За счет этого электроны диффундируют в сторону р-п -перехода, оставляя вдали от него нескомпенсированный заряд положительных ионов. Это приводит к возникновению электрического поля в базе, направленного в сторону перехода. Под действием этого поля дырки, инжектированные в базу при включении диода в прямом направлении, концентрируются (накапливаются) у границы р-п -перехода. Поэтому такие диоды называют диодами с накоплением заряда.
5. Биполярные транзисторы
5.1. Структура и основные режимы работы
В 1948 г. американские ученые Дж. Бардин и В. Браттейн создали полупроводниковый триод, или транзистор. Это событие имело громадное значение для развития полупроводниковой электроники. Транзисторы могут работать при значительно меньших напряжениях, чем ламповые триоды, и не являются простыми заменителями последних: их можно использовать не только для усиления и генерации переменного тока, но и в качестве ключевых элементов.
Транзистором называется полупроводниковый прибор с двумя электронно-дырочными переходами, предназначенный для усиления и генерирования электрических сигналов. Определение «биполярный» указывает на то, что работа транзистора связана с процессами, в которых принимают участие носители заряда двух сортов (электроны и дырки).
Биполярный транзистор (БТ) состоит из трех областей монокристаллического полупроводника с разным типом проводимости: эмиттера, базы и коллектора (рис. 5.1).
Переход, который образуется на границе эмиттер – база, называется эмиттерным, а на границе база – коллектор – коллекторным. В зависимости от типа проводимости крайних слоев различают транзисторы p-n-р и n-р-n.
Область транзистора, расположенная между переходами, называется базой (Б). Примыкающие к базе области чаще всего делают неодинаковыми. Одну из них изготовляют так, чтобы из нее наиболее эффективно происходила инжекция в базу, а другую – так, чтобы соответствующий переход наилучшим образом осуществлял экстракцию инжектированных носителей из базы.
Область транзистора, основным назначением которой является инжекция носителей в базу, называют эмиттером (Э), а соответствующий переход – эмиттерным.
Область, основным назначением которой является экстракция носителей из базы, называют коллектором (К), а переход – коллекторным.
Условные обозначения обоих типов транзисторов, рабочие полярности напряжений и направления токов показаны на рис. 5.1.


Рис. 5.1. Схематическое изображение биполярного
плоскостного транзистора и его условное изображение:
а - p- n- p -типа; б - n- p- n -типа; в – распределение концентраций основных носителей заряда вдоль структуры транзистора
в равновесном состоянии; W - толщина базы
По технологии изготовления транзисторы делятся на сплавные, планарные, а также диффузионно-сплавные, мезапланарные и эпитаксиально-планарные (рис. 5.2).
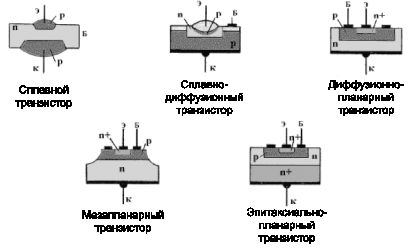
Рис. 5.2. Разновидности транзисторов
по технологии изготовления
Конструктивно биполярные транзисторы оформляются в металлических, пластмассовых или керамических корпусах (рис. 5.3).
Каждый из переходов транзистора можно включить либо в прямом, либо в обратном направлении. В зависимости от этого различают три режима работы транзистора:
- режим отсечки – оба p-n -перехода закрыты, при этом через транзистор обычно идет сравнительно небольшой ток;
- режим насыщения – оба p-n -перехода открыты;
- активный режим – один из p-n -переходов открыт, а другой закрыт.

Рис. 5.3. Конструктивное оформление
биполярного транзистора
В режиме отсечки и режиме насыщения управление транзистором невозможно. В активном режиме такое управление осуществляется наиболее эффективно, причем транзистор может выполнять функции активного элемента электрической схемы.
Если на эмиттерном переходе напряжение прямое, а на коллекторном переходе – обратное, то включение транзистора считают нормальным, при противоположной полярности – инверсным.
По характеру движения носителей тока в базе различают диффузионные и дрейфовые биполярные транзисторы.
Основные характеристики транзистора определяются в первую очередь процессами, происходящими в базе. В зависимости от распределения примесей в базе может присутствовать или отсутствовать электрическое поле. Если при отсутствии токов в базе существует электрическое поле, которое способствует движению неосновных носителей заряда от эмиттера к коллектору, то транзистор называют дрейфовым, если же поле в базе отсутствует – бездрейфовым (диффузионным).
Схемы включения транзистора
Различают три схемы включения транзистора в зависимости от того, какой из электродов транзистора является общим для входного и выходного сигналов (рис. 5.4): с общей базой (ОБ); с общим эмиттером (ОЭ) и с общим коллектором (ОК). Первый закон Кирхгофа применительно к транзистору дает равенство
 , (5.1)
, (5.1)
то есть ток эмиттера в транзисторе распределяется между базой и коллектором.
В этих схемах источники постоянного напряжения и резисторы нагрузки обеспечивают режимы работы транзисторов по постоянному току.

Рис. 5.4. Основные схемы включения транзисторов
Входные сигналы переменного тока создаются источниками Uвх. Они изменяют ток эмиттера транзистора, а соответственно и ток коллектора, и ток базы согласно уравнению (5.1), то есть
 . (5.2)
. (5.2)
Если из равенства (5.2) вычесть равенство (5.1), получим
 . (5.3)
. (5.3)
Тогда
 . (5.3,а)
. (5.3,а)
Транзистор в любой схеме применения характеризуется коэффициентом прямой передачи по току, который определяет отношение приращения выходного тока к вызвавшему его приращению входного тока при постоянном напряжении в выходной цепи, то есть
 при
при  . (5.4)
. (5.4)
Для схем с ОБ входным током является ток эмиттера, выходным – ток коллектора. Так как эмиттерный переход находится в открытом состоянии, то входное сопротивление схемы – сопротивление эмиттер–база (Rвх = Uвх / Iв х) будет малым (единицы – десятки Ом).
Тогда для этой схемы включения транзистора коэффициент прямой передачи по току
 . (5.5)
. (5.5)
Следовательно, схема с общей базой не обладает усилительными свойствами.
Коэффициент усиления по напряжению на малом сигнале для этой схемы можно определить как
 , (5.6)
, (5.6)
где rэ – дифференциальное сопротивление перехода эмиттер–база. Так как отношение Rн / rэ значительно больше входного сопротивления, то схема с ОБ может усиливать входное напряжение.
Коэффициент усиления по мощности
 . (5.7)
. (5.7)
Так как отношение Rн/rэ > a 2, то можно утверждать, что схема с ОБ обладает некоторым усилением по мощности. Например, теоретические расчеты показали, что для схемы с ОБ при a = 0,98 коэффициент усиления по напряжению КU может быть равен 196, а по мощности К P = 192.
Для схемы с ОЭ входным током является базовый ток, а выходным током коллекторный. Входное сопротивление в этой схеме будет примерно на два порядка больше, чем в схеме с ОБ:
 . (5.8)
. (5.8)
Коэффициент прямой передачи по току в схеме с ОЭ равен:
 , (5.9)
, (5.9)
то есть эта схема обладает усилением по току. Из этой формулы видно, что чем больше будет коэффициент a, тем больше будет величина b. Например, при a = 0,96 получим b = 24, при a = 0,99 имеем b = 99.
Коэффициент усиления по напряжению
 (5.10)
(5.10)
такой же, как и в схеме с общей базой.
Так как схема с ОЭ обладает усилением по току и по напряжению, то величина коэффициента усиления по мощности будет наибольшей
 , (5.11)
, (5.11)
где КP(об) – коэффициент усиления по мощности в схеме с ОБ.
Для схемы с ОК входным током является ток базы, а выходным током служит ток эмиттера. Тогда коэффициент усиления по току К I = DIэ/[ DIэ (1 – a) ] = 1 / (1 – a) будет наибольший. Входное сопротивление транзисторов в схеме с ОК
 (5.12)
(5.12)
значительно превышает входное сопротивление транзисторов в схемах с ОБ и ОЭ. Коэффициент усиления по напряжению равен
 . (5.13)
. (5.13)
Так как Rн >> rэ, то в схеме с ОК КU» 1.
Коэффициент усиления по мощности в схеме с ОК равен КP = КIКU» 1/(1– a), т.е. приблизительно равен коэффициенту усиления по току. Обобщенные данные по параметрам для различных схем включения транзистора представлены в табл. 5.1.
Таблица 5.1
Параметры для схем включения транзистора
| Параметр
| Обозначение
| Схема включения транзистора
|
| ОБ
| ОЭ
| ОК
|
| Усиление
по току
| KI
| менее 1
| (10 -250)
| (10 -250)
|
| Усиление
по напряжению
| KU
| Среднее
(30 - 300)
| Высокое
(50 - 2000)
| менее 1
|
| Усиление
по мощности
| KP
| Среднее
(30–300)
| Высокое
более 1000
| Среднее
(10–250)
|
| Входное
сопротивление
|
Rвх
| Низкое
(20 – 120)
Ом
| Среднее
(150 Ом -1,5кОм)
| Высокое
(10 - 500
кОм)
|
| Выходное
сопротивление
|
Rвых
| Высокое
(1 - 1,5
МОм)
| Среднее
(10 - 100
кОм)
| Низкое
(10 - 100
Ом)
|
Практические схемы включения транзистора отличаются от приведенного на рис. 5.4 добавлением радиокомпонентов (резисторов, конденсаторов, индуктивностей и др.) для задания рабочего режима, нагрузки, разделения постоянной и переменной составляющих.
Таким образом, для всех схем включения транзистора общим является усиление по мощности.
Необходимо обратить внимание на то, что при обрыве базового вывода при подключенных к транзистору источниках питания, коллекторный ток в зависимости от конструкции транзистора (в первую очередь от толщины базы) может резко возрасти, что приведет к выходу транзистора из строя. Поэтому при работе с транзисторами рекомендуется базовый вывод всегда подключать к схеме первым и отключать последним.
5.3. Основные физические процессы
в биполярных транзисторах
В рабочем режиме биполярного транзистора протекают следующие физические процессы: инжекция, диффузия, рекомбинация и экстракция.
Рассмотрим транзистор р-п-р -типа в нормальном активном режиме, то есть эмиттерный переход включен в прямом направлении, а коллекторный - в обратном, в схеме с ОБ.
Из-за наличия двух р-п -переходов биполярный транзистор может производить усиление по току, напряжению и мощности. Дырки (основные носители заряда в эмиттерной области р-п-р -транзистора) инжектируются прямо смещенным эмиттерным переходом в п -область базы, а электроны из области базы одновременно проходят через переход в р -область. Эмиттерная р -область легирована обычно сильнее, концентрация акцепторов в ней Nаэ = 1019 - 1020 см-3, а концентрация доноров в базе Nдб = 1014 – 1015 см-3, т.е. инжекция электронов из п -области в р -область много меньше, чем инжекция дырок из р -области в п -область. Дырки, попавшие в базу, оказываются в избытке у эмиттерного перехода и начинают свое движение (диффузию) вдоль базы туда, где их концентрация меньше, то есть к обратно смещенному коллекторному переходу. Далее дырки втягиваются полем обратно смещенного коллекторного перехода в противоположную область (коллектор) – экстракция зарядов – и выходят через коллекторный вывод. В базе также происходит рекомбинация инжектированных дырок с электронами (основными носителями). Для уменьшения потерь дырок в базе необходимо, чтобы ее толщина была как можно меньше. Если база тонкая, то практически все дырки дойдут до коллекторного перехода (98 – 99 % дырок), т.е. дырочный ток коллектора составляет 0,98 – 0,99 дырочного тока эмиттера I pк = (0,98 – 0,99) I pэ, а 1 – 2 % дырок теряется в базе за счет рекомбинации.
Процесс переноса инжектированных носителей через базу – диффузионный. Характерное расстояние, на которое неравновесные носители распространяются от области возмущения, – диффузионная длина L p. Поэтому если необходимо, чтобы инжектированные носители достигли коллекторного перехода, длина базы W должна быть меньше диффузионной длины L p. Условие W < L p является необходимым для реализации транзисторного эффекта – управления током во вторичной цепи через изменение тока в первичной цепи.
В процессе диффузии через базу инжектированные неосновные носители рекомбинируют с основными носителями в базе. Для восполнения прорекомбинировавших основных носителей в базе через внешний контакт должно подойти такое же количество носителей. Таким образом, ток базы – это рекомбинационный ток.
Продиффундировавшие через базу без рекомбинации носители попадают в электрическое поле обратно смещенного коллекторного p‑n -перехода и экстрагируются из базы в коллектор. Таким образом, в БТ реализуются четыре физических процесса:
- инжекция из эмиттера в базу;
- диффузия через базу;
- рекомбинация в базе;
- экстракция из базы в коллектор.
Эти процессы для одного типа носителей схематически показаны на рис. 5.5, а, б.

Рис. 5.5. Зонная диаграмма биполярного транзистора:
а - в равновесном состоянии; б - в активном режиме
Если бы эмиттерный и коллекторный переходы находились на большом расстоянии друг от друга, то есть толщина базы W была бы значительно больше диффузионной длины неосновных носителей в базе, то носители, инжектируемые эмиттером, не доходили бы до коллектора, так как рекомбинировали бы в базе. В этом случае каждый из переходов можно рассматривать в отдельности, не учитывая их взаимодействия, причем вольт-амперная характеристика эмиттерного перехода представляла бы прямую ветвь характеристики диода, а коллекторного перехода – обратную ветвь.
Основная особенность биполярного транзистора заключается во взаимном влиянии переходов друг на друга. В биполярных плоскостных транзисторах для эффективного влияния эмиттерного перехода на коллекторный необходимо выполнение следующих требований:
- толщина базы транзистора W должна быть много меньше диффузионной длины инжектируемых в нее носителей Lб, то есть W = 1,5 – 25 мкм < Lб;
- концентрация основных носителей в базе должна быть много меньше концентрации основных носителей в области эмиттера;
- концентрация основных носителей в области коллектора должна быть несколько меньшей, чем в области эмиттера;
- площадь коллекторного перехода должна быть в несколько раз больше площади эмиттерного перехода.
На рис. 5.5, а показана зонная диаграмма биполярного транзистора в схеме с общей базой в условиях равновесия. Значками (+) и (–) на этой диаграмме указаны основные и неосновные носители.
Для биполярного транзистора в схеме с общей базой активный режим (на эмиттерном переходе – прямое напряжение, на коллекторном – обратное) является основным.
Рассмотрим компоненты токов в эмиттерном и коллекторном переходах (рис. 5.5, б). Для любого p- n -перехода ток J определяется суммой электронного J n и дырочного J p тока, а они в свою очередь имеют дрейфовую и диффузионную составляющие:
 (5.14)
(5.14)
При приложении к эмиттерному переходу прямого напряжения U э > 0 в биполярном транзисторе p- n-р происходит инжекция дырок из эмиттера в базу I эр и электронов из базы в эмиттер I эn. Ввиду того, что эмиттер легирован намного сильнее базы, ток инжектированных дырок I эр будет значительно превышать ток электронов I эn. Инжектированные в базу дырки в результате диффузии будут перемещаться к коллекторному переходу, и если ширина базы W много меньше диффузионной длины L p, почти все дырки дойдут до коллектора и электрическим полем коллекторного перехода будут переброшены в р -область коллектора. Возникающий вследствие этого коллекторный ток лишь немного меньше тока дырок, инжектированных эмиттером.
Вольт-амперные характеристики БТ в активном режиме (U к < 0, | U к | >> 0):
 , (5.15)
, (5.15)
где I э – ток в цепи эмиттера, I к – ток в цепи коллектора, I б – ток на базовом выводе.
В активном режиме к эмиттеру приложено прямое напряжение и через переход течет эмиттерный ток I э, имеющий две компоненты:
 , (5.16)
, (5.16)
где I эр – ток инжекции дырок из эмиттера в базу, I эn – ток инжектированных электронов из базы в эмиттер. Величина «полезной» дырочной компоненты равняется I эp = γ · I э, где γ – эффективность эмиттера. Величина дырочного эмиттерного тока, без рекомбинации дошедшая до коллектора, равняется γ c I э, где c - коэффициент переноса неосновных носителей через базу.
Ток базы I б транзистора будет состоять из трех компонент, включающих электронный ток в эмиттерном переходе I эn = (1 – γ)· I э, рекомбинационный ток в базе (1 - c) γI э и тепловой ток коллектора I к0.
Тепловой ток коллектора I к0 имеет две составляющие:
 , (5.17)
, (5.17)
где I 0 – тепловой ток, I g – ток генерации.
На рис. 5.6 приведена схема биполярного транзистора в активном режиме, иллюстрирующая компоненты тока в схеме с общей базой.

Рис. 5.6. Схема, иллюстрирующая компоненты тока
в биполярном транзисторе в схеме с общей базой
В схеме с ОЭ входной цепью является цепь базы. Так как ток базы существенно меньше тока эмиттера, то можно получить усиление по току. Изменяя базовый ток, меняем количество основных носителей в области базы, то есть заряд базы и, следовательно, понижается потенциальный барьер между эмиттером и базой. Это вызывает инжекцию неосновных носителей заряда из эмиттера. Большинство инжектированных носителей доходит до коллекторного перехода, изменяя его ток. Основные носители заряда, введенные в базу из вывода базы, могут либо рекомбинировать и исчезнуть, либо быть инжектированы в эмиттер, что мало вероятно. Таким образом, на одной основной носитель заряда, вошедший в базу, приходится много неосновных носителей заряда прошедших от эмиттера к коллектору. В этом заключается усиление по току в схеме с ОЭ.
5.4. Модуляция сопротивления базы
Как известно, ширина р-п- перехода зависит от напряжения на нем. В активном режиме эмиттерный переход смещен в прямом направлении, его ширина мала и изменение этой ширины при изменении U ЭБ незначительно. Коллекторный переход, смещенный в обратном направлении, имеет сравнительно большую ширину, и изменения ее при изменениях напряжения U КБ оказываются практически равными изменениям толщины базы.
Изменение ширины базы, под действием изменения напряжения смещения коллекторного перехода U КБ называется модуляцией ширины базы или эффектом Эрли (рис. 5.7).
Изменение ширины базы существенно влияет на физические процессы в базе.

Рис. 5.7. Эффект Эрли – эффект модуляции ширины базы биполярного транзистора
При постоянном токе эмиттера J э = const и соответственно постоянном градиенте концентрации инжектированных носителей  с увеличением напряжения на коллекторе U КБ увеличивается ширина обедненной области lp- n коллекторного перехода, что вызывает уменьшение ширины квазинейтрального объема базы W. Это, в свою очередь, влечет за собой уменьшение концентрации инжектированных носителей р n(0) на границе эмиттерного перехода (так как градиент
с увеличением напряжения на коллекторе U КБ увеличивается ширина обедненной области lp- n коллекторного перехода, что вызывает уменьшение ширины квазинейтрального объема базы W. Это, в свою очередь, влечет за собой уменьшение концентрации инжектированных носителей р n(0) на границе эмиттерного перехода (так как градиент  должен оставаться постоянным) (рис. 5.8). Поскольку концентрация инжектированных дырок на границе эмиттерного перехода р n(0) = p 0· exp (b U ЭБ) определяется напряжением на эмиттере, то ее уменьшение возможно только при уменьшении напряжения U ЭБ на эмиттере. Таким образом, если поставлено условие: J э = const,
должен оставаться постоянным) (рис. 5.8). Поскольку концентрация инжектированных дырок на границе эмиттерного перехода р n(0) = p 0· exp (b U ЭБ) определяется напряжением на эмиттере, то ее уменьшение возможно только при уменьшении напряжения U ЭБ на эмиттере. Таким образом, если поставлено условие: J э = const,  , то при увеличении коллекторного напряжения U КБ должно происходить уменьшение эмиттерного напряжения U ЭБ.
, то при увеличении коллекторного напряжения U КБ должно происходить уменьшение эмиттерного напряжения U ЭБ.

Рис. 5.8. Влияние эффекта модуляции ширины базы БТ
на концентрацию неосновных носителей на границе
эмиттер – база
При постоянном напряжении на эмиттерном переходе U ЭБ = const с увеличением U КБ, то есть при уменьшение ширины квазинейтрального объема базы W,концентрация дырок у эмиттерного перехода остается неизменной р n(0) = const. Тогда изменяется градиент концентрации инжектированных носителей  , что эквивалентно изменению тока эмиттера J э, в данном случае он увеличивается.
, что эквивалентно изменению тока эмиттера J э, в данном случае он увеличивается.
Следовательно, если одна из входных величин (J э или U ЭБ) задана, то вторая оказывается функцией коллекторного напряжения. Такое влияние называется внутренней обратной связью по напряжению.
Коэффициент обратной связи по напряжению в биполярном транзисторе в схеме с общей базой показывает, как изменится напряжение на эмиттерном переходе при единичном изменении напряжения на коллекторном переходе при условии, что ток эмиттера поддерживается постоянным  .
.








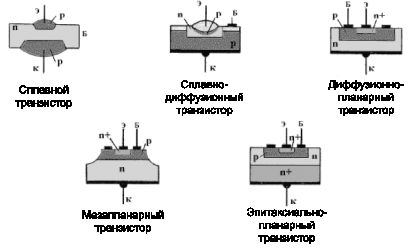

 , (5.1)
, (5.1)
 . (5.2)
. (5.2) . (5.3)
. (5.3) . (5.3,а)
. (5.3,а) при
при  . (5.4)
. (5.4) . (5.5)
. (5.5) , (5.6)
, (5.6) . (5.7)
. (5.7) . (5.8)
. (5.8) , (5.9)
, (5.9) (5.10)
(5.10) , (5.11)
, (5.11) (5.12)
(5.12) . (5.13)
. (5.13)
 (5.14)
(5.14) , (5.15)
, (5.15) , (5.16)
, (5.16) , (5.17)
, (5.17)

 с увеличением напряжения на коллекторе U КБ увеличивается ширина обедненной области lp- n коллекторного перехода, что вызывает уменьшение ширины квазинейтрального объема базы W. Это, в свою очередь, влечет за собой уменьшение концентрации инжектированных носителей р n(0) на границе эмиттерного перехода (так как градиент
с увеличением напряжения на коллекторе U КБ увеличивается ширина обедненной области lp- n коллекторного перехода, что вызывает уменьшение ширины квазинейтрального объема базы W. Это, в свою очередь, влечет за собой уменьшение концентрации инжектированных носителей р n(0) на границе эмиттерного перехода (так как градиент  должен оставаться постоянным) (рис. 5.8). Поскольку концентрация инжектированных дырок на границе эмиттерного перехода р n(0) = p 0· exp (b U ЭБ) определяется напряжением на эмиттере, то ее уменьшение возможно только при уменьшении напряжения U ЭБ на эмиттере. Таким образом, если поставлено условие: J э = const,
должен оставаться постоянным) (рис. 5.8). Поскольку концентрация инжектированных дырок на границе эмиттерного перехода р n(0) = p 0· exp (b U ЭБ) определяется напряжением на эмиттере, то ее уменьшение возможно только при уменьшении напряжения U ЭБ на эмиттере. Таким образом, если поставлено условие: J э = const, 
 .
.


