Случайные флуктуации атомов примеси, или RDF, представляют собой статистически случайную вероятность, с которой примесные ионы (атомы) занимают определенные места в кристаллической решетке. Количество и положение легирующих примесей может варьироваться в активных областях прибора, и это может иметь серьезные последствия в определении поведения отдельных приборов.
Вообще говоря, RDF становится проблематичной, когда ожидаемое общее количество легирующих примесей в полупроводниковых приборах достигает счетного числа, обычно меньше, чем 100 или около того. Это происходит, когда размер прибора уменьшается не пропорционально увеличению концентрации легирующей примеси, например, в канале объемного МОПТ. Когда общее количество атомов примесей достигает счетного числа, любое целое число флуктуаций в этом количестве составляет относительно большую вариацию полной концентрации примеси. Уменьшение среднего числа атомов примеси в обедненной области транзистора как функция технологической нормы представлено на рис.4.
Например, транзистор с длиной канала LG = 100нм, шириной W = 150нм, толщиной слоя обеднения  = 10нм и номинальной концентрацией примеси
= 10нм и номинальной концентрацией примеси
N = 1,33∙1018см-3 имеет в среднем 200 атомов примеси, и добавление или вычитание одного примесного иона приводит в результате всего лишь к 0,5% изменению числа атомов легирующей примеси. С другой стороны, МОПТ с
LG = 30нм, W = 50нм,  = 5нм, и N = 1,33∙1018 см-3 имеет в среднем всего десять атомов примеси и добавление или вычитание одного примесного иона дает уже в результате 10% изменение общего числа атомов легирующей примеси.
= 5нм, и N = 1,33∙1018 см-3 имеет в среднем всего десять атомов примеси и добавление или вычитание одного примесного иона дает уже в результате 10% изменение общего числа атомов легирующей примеси.

Рис.4. Среднее число атомов примеси в обедненной области транзистора в зависимости от технологической нормы
Кроме того, когда общее количество примесей сильно дискретизировано, значительное влияние оказывает пространственная неоднородность в их распределении. В больших полупроводниковых областях с большим количеством примесей, электростатический потенциал из-за отдельных примесей будет усредняться в макроскопическом масштабе и становиться более или менее однородным. В очень небольших приборах с низким количеством примесей, однако, потенциал не будет усредняться, и микроскопические флуктуации станут более выражены. В этом случае, эффекты RDF в канале МОП-транзистора могут привести к значительному изменению параметров прибора, таких как пороговое напряжение, рабочий ток и ток утечки.
Происхождение RDF
RDF вызывается случайным расположением атомов примеси, которое следует распределению Пуассона в области канала. Этот эффект с начала семидесятых годов был предсказан как одна из фундаментальных проблем управления параметрами прибора. Тенденция эффекта RDF при масштабировании показана на рис. 5 с использованием номинальных параметров прибора, прогнозируемых ITRS. Когда размер прибора уменьшается, общее количество примесей в канале уменьшается, как показано на рис. 4; такое уменьшение приводит к резкому увеличению разброса порога.
Примеси могут быть добавлены в полупроводник путем осаждения или имплантации; однако, точное расположение и количество примесей всегда случайно по своей природе.
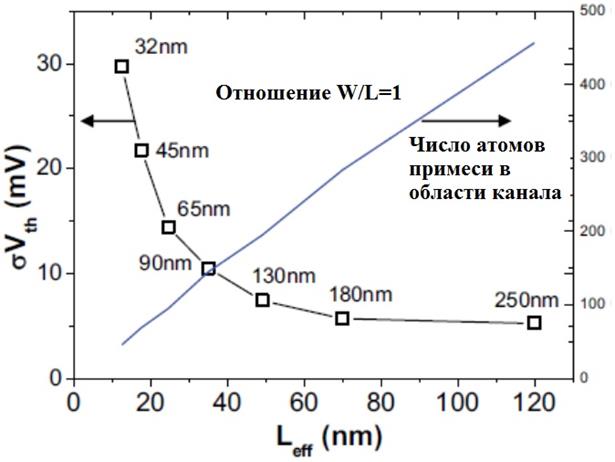
Рис.5. Тенденция разброса Vth вследствие RDF в соответствии с предсказаниями ITRS.
В то время как макроскопический профиль легирования может регулироваться настройкой дозы и энергии импланта в процессе ионной имплантации, точное количество и расположение дополнительных примесей всегда неопределенно из-за случайности ионных столкновений и кинетики диффузии. Во время имплантации не все ионы примеси будут сталкиваться в полупроводнике с одинаковой кинетической энергией и траекторией, и в результате их распределение можно определить как случайный процесс (Монте-Карло). Кроме того, последующий отжиг приведет к дальнейшему перераспределению легирующей примеси через микроскопические механизмы диффузии.
Индуцированные RDF изменения разделяются на RDF подложки (тела) и RDF истока/стока (S/D). RDF тела, которые индуцируются флуктуациями легирующих примесей подложки, является широко изученными и рассматриваются как доминирующий источник разбросов в масштабированном приборе. В отличие от RDF тела, S/D RDF, которые возникают от флуктуации примесей истока/стока, не вносят вклад в падение порогового напряжения. Когда размер прибора масштабируется к суб-25нм, флуктуации S/D примесей приводят к флуктуациям эффективной длины канала и емкости области перекрытия. Исследования показывают, что RDF S/D является вторичным эффектом по сравнению с RDF тела.
Другой аспект RDF заключается в пространственном положении атомов примеси, которое возникает преимущественно вследствие случайного рассеяния ионов при имплантации. Вариации вследствие пространственного распределения влияют на транспортные свойства в инверсионном слое.
По данным моделирования на основе исследования, проведенного корпорацией Intel, на RDF приходится около 65% от общего стандартного отклонения  , то есть RDF является наиболее значимой причиной разброса.
, то есть RDF является наиболее значимой причиной разброса.
Возможно сокращение эффекта RDF на уровне МОПТ путем управления вертикальным профилем примеси (инженерия канала) − использование ретроградного неравномерного профиля примеси. Ретроградное легирование означает низкую поверхностную концентрацию примеси до определенной глубины, обозначаемой xs, после которой концентрация примеси возрастает до высокого значения. Преимущество использования такого профиля канала состоит в сокращении RDF для конкретной технологической нормы. Это объясняется снижением эффективной концентрации примеси и флуктуации числа атомов примеси, связанной с этим. В дополнение к этому она дает дополнительную степень свободы для настройки профиля для получения оптимального порогового напряжения, необходимого для обеспечения тока утечки в выключенном состоянии, и глубины обеднения для контроля ККЭ.
3. Вариации края линии шероховатости
Когда напечатанный рисунок содержит боковые линии, которые не являются идеально гладкими после процесса изготовления, говорят, что он демонстрирует шероховатость края линии − LER. Это искажение в МОПТ, в основном, создается травлением затвора, а также инструментами, используемыми в литографии процесса. Пример этого проиллюстрирован на
рис. 5 для двух разных типов фоторезиста. Возрастание роли LER обусловлено тем, что её величина не масштабируется соответственно с технологией; улучшение в процессе литографии не уменьшает эффективно такую локальную вариацию.
В настоящее время LER является одной из наиболее распространенных форм отклонений процесса и является серьезной проблемой для проектировщиков приборов, потому что она непосредственно изменяет размер и форму важных активных областей, таких как металлургическая длина затвора L g и ширина транзистора W в планарных транзисторах. Численное моделирование показывает, что LER-эффект значительно увеличивает утечки и разбросы порога. В непланарных транзисторах (например, FinFEТ) LER также может привести к случайным флуктуациям толщины тела, которая может внести значительный вклад в общее непостоянство прибора в глубоко масштабированных технологиях.
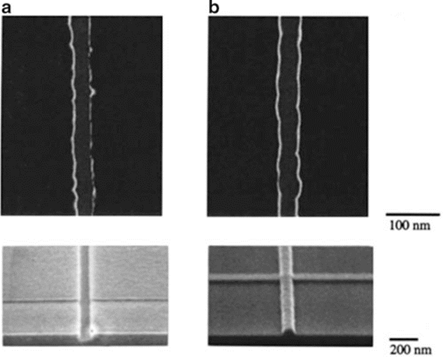
Рис.6 Изображения краев резиста (а − ZEP-520, b − SAL-601), полученные с помощью атомного силового микроскопа (вверху) и сканирующего электронного микроскопа (внизу) [1].
Истоки LER
В то время как случайные флуктуации в линиях рисунка происходят как в front-end[1], так и в back-end процессах, основной проблемой, связанной с LER/LWR являются вариации рисунка поликремниевого затвора. Хотя есть много факторов, которые могут способствовать LER, первичные истоки восходят к литографии и травлению в процессе изготовления. Во время процесса литографии, такие факторы, как различие в экспозиции, дробовой шум, шероховатость маски и свойства материала резиста могут напрямую повлиять на качество рисунка. Во время процесса травления шероховатости боковой кромки резиста частично переносятся на вытравленную деталь рисунка. Кроме того, процесс травления может вызывать дополнительные шероховатости от случайности кинетики травления.
В реальности при экспозиции даже неэкспонированные области фоторезиста получают конечную дозу облучения в результате оптических диффракционных эффектов, тем самым снижая контрастность изображения. Дробовой шум также может быть возможным механизмом LER, когда доза облучения достаточно низкая, и статистические флуктуации числа электронов или прибытия фотонов могут вызвать колебания дозирования вдоль профиля. Шероховатости или дефекты в масках могут быть напрямую переданы в слои фоторезиста в процессе экспонирования и также могут быть источником LER.
Свойства материала резиста играют важнейшую роль в общем LER в структуре рисунка. Дискретизация полимеров резиста в цепочки из повторяющихся мономерных блоков становится значимой, когда требования к величине LER приближаются к размерам самих мономеров (1–2 нм). Зернистость молекул фоторезиста определяет его края в процессе литографии. Соответствующие неровности (шероховатости) края линии передаются на линию края затвора при травлении, когда фоторезист используется как маска. LER возникает из-за медленной скорости растворения крупных полимерных агрегатов в процессе удаления нежелательного фоторезиста. Неровный край фоторезиста передается физической линии рисунка на полупроводнике, например, как рисунок поликремниевого затвора. Этот процесс иллюстрирует рис.7. Таким образом, поликремниевый затвор имеет присущую ему линию края шероховатости (LER) и линию ширины шероховатости (LWR), которые сегодня находятся на той же самой шкале фактических размеров прибора. Экспериментальные данные показывают, что эффект LER начал проявляться, когда длина затвора стала меньше 90нм.

Рис.7. Изображение края линии фоторезиста, определяемой литографией и травлением.
Моделирование LER
LER − стохастический (случайный) процесс, и, следовательно, требует статистического описания. Он обычно характеризуется среднеквадратической амплитудой (отклонением) σLER,, поскольку она описывает насколько велики большие или маленькие шероховатости. Типичные значения для σLER порядка нескольких нанометров. Когда обсуждается величина LER, мы всегда будем обращаться к амплитуде LER с значением 1-сигма (т. е., σLER), если не указано иное.
Важно проводить различие между шероховатостью края линии (LER) и шероховатостью ширины линии (Line Width Roughness − LWR): когда LER существует вдоль обеих боковых сторон напечатанной полосы, флуктуации обоих краев полосы приводят в результате к полной флуктуации ширины напечатанной полосы (рис. 8).
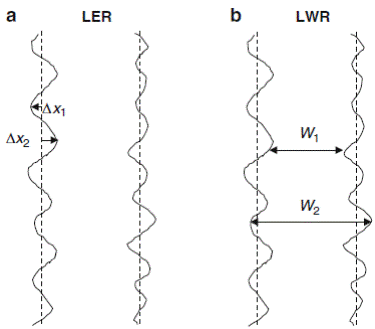
Рис. 8. Определение LER и LWR на линиях рисунка. (а) LER – это отклонение положения реального края (сплошная линия) от среднего или идеального положения края линии. (в) LWR – это отклонение ширины рисунка вдоль его длины. Заметим, что может быть ненулевая LER и нулевая LWR одновременно.
Предполагая равные величины LER по обе стороны линии рисунка, величины LER и LWR будут связаны соотношением

 ,
,
где  − корреляционный коэффициент в диапазоне между 0 (полностью некоррелированные) и 1 (полностью коррелирует). Таким образом, если
− корреляционный коэффициент в диапазоне между 0 (полностью некоррелированные) и 1 (полностью коррелирует). Таким образом, если  , тогда σLWR= 0, даже если
, тогда σLWR= 0, даже если  .
.
Когда размеры прибора уменьшаются, величину LER необходимо пропорционально уменьшить, чтобы гарантировать, что результирующая величина непостоянства прибора сохраняется под контролем. Однако, это не простая задача. В 2011г. ITRS называет для величины  для 32-нм технологии (2012 год), что соответствует величине σLER < 0,6нм, предполагая стандартный рисунок резиста. Сохранение σLER таких достаточно низких значений представляет одну из главных проблем масштабирования существующего уровня front-end процессов.
для 32-нм технологии (2012 год), что соответствует величине σLER < 0,6нм, предполагая стандартный рисунок резиста. Сохранение σLER таких достаточно низких значений представляет одну из главных проблем масштабирования существующего уровня front-end процессов.
Флуктуации толщины оксида
Флуктуация толщины оксидного слоя, или OTF (Oxide Тhickness Fluctuation) представляет еще один источник вариабильности прибора в высоко масштабируемой MOПТ технологии и становится особенно проблематичной, когда номинальная толщина оксида масштабируется до менее чем двух нанометров. Когда толщина оксида эквивалентна всего нескольким атомным слоям кремния, ступенька в один атомный слой шероховатости границы раздела приведет к значительному OTF внутри области затвора отдельного МОП-транзистора. Уникальный случайный узор толщины подзатворного окисла и картина границы раздела делает каждый нанометровый МОП-транзистор отличным от своего аналога и ведет к вариациям шероховатости поверхности, ограничивающей подвижность, вариациям туннельного тока затвора и порогового напряжения прибора. Аналогично LER, OTF привлекает все больше внимание в связи с тем, что шероховатость поверхности не масштабируется соответственно с толщиной диэлектрика. Флуктуации величины шероховатости поверхности оксида, как правило, составляет высоту одного слоя атомов кремния, который равен 2,71Å (рис. 9). Вплоть до технологической нормы 65нм, где по-прежнему в основном используется оксид кремния (или оксинитрид) как материал для подзатворного окисла,  была сокращена до менее, чем 1,2нм = 12 Å, что меньше толщины пяти атомных слоев.
была сокращена до менее, чем 1,2нм = 12 Å, что меньше толщины пяти атомных слоев.

Рис. 9.Демонстрация OTF.
Для такого процесса флуктуации только одного атомного слоя уже представляют изменение более чем на 20% в  ! Это может привести к значительным вариациям характеристик прибора, подобно эффектам LER и RDF. Легко представить, как дальнейшее масштабирование на основе оксидов кремния до 1нм или тоньше, становится проблематичным не только с точки зрения утечки затвора, но и от OTF.
! Это может привести к значительным вариациям характеристик прибора, подобно эффектам LER и RDF. Легко представить, как дальнейшее масштабирование на основе оксидов кремния до 1нм или тоньше, становится проблематичным не только с точки зрения утечки затвора, но и от OTF.
Моделирование OTF может быть выполнено на основе тех же метрологических подходов, которые используются для LER.
Начиная с технологической нормы 45 нм, однако, промышленность начала заменять SiO2 high-K диэлектриками (например, HfO2 с  ), которые могут быть сделаны толще, и в то время все еще обеспечивая ту же эквивалентную толщину оксида (EOT) как и SiO2 (
), которые могут быть сделаны толще, и в то время все еще обеспечивая ту же эквивалентную толщину оксида (EOT) как и SiO2 ( ). В этом случае, не только номинальная
). В этом случае, не только номинальная  становятся толще, но и одно- или даже многослойные флуктуации создают меньшее относительное изменение в
становятся толще, но и одно- или даже многослойные флуктуации создают меньшее относительное изменение в  . В результате перехода технологии к
. В результате перехода технологии к
high-K диэлектрикам, озабоченность по поводу OTF значительно ослабла, особенно по сравнению к потенциальным воздействиям от LER и RDF.
Флуктуации работы выхода
Материал затвора МОП-транзистора, является ли он поликристаллическим кремнием или создается на металлической основе, как правило, состоит из множества хаотически ориентированных зерен с различной конфигурацией зерна, что приводит к изменению работы выхода затвора между различными транзисторами. Эта вариация называется флуктуацией работы выхода (Work Function Variation − WFV), и представляет другой возможный источник вариабильности прибора. Как LER и RDF, значение WFV как ожидается, станет важнее для более тонких технологий. Для транзисторов с достаточно большой площадью затвора по сравнению со средним размером зерна, затвор будет состоять из множества хаотически ориентированных зерен, отдельные вклады будут усредняться по всему прибору, предполагая, что распределение зерен является независимым. Тем не менее, когда размер затвора приближается к среднему размеру зерна, работа выхода становится весьма зависимой от формы зерна, и эффекты усреднения не будут происходить в каждом транзисторе, в результате чего WFV оказывает большее влияние. Например, в типичном FinFET, использующим TiN в качестве материала затвора, наиболее вероятны две возможных ориентации зерна: <200> (работа выхода ψ<200> = 4,6эВ) или <111> (ψ<111> = 4,4эВ), с вероятностью 60-40%, соответственно. Когда средний размер зерна (~ 20нм) становится сравним с размерами области затвора, результирующая вариация порогового напряжение достигает максимума и более или менее насыщается, когда размер затвора снижается далее.
Многочисленные исследования WFV, которые проведены в последнее десятилетие, предсказывают, что эффекты WFV могут стать столь же значительным, как LER и RDF для затворов длиной ~ 30нм или ниже. Поскольку транзисторы продолжают сокращаться в нанометровом масштабе, WFV может стать доминирующим источником вариабильности, и может стать стимулом для разработки альтернативных систем на основе аморфных материалов затвора (например, TiN, легируемый углеродом), которые также совместимы с существующими в настоящее время диэлектриками на основе гафния. Совсем недавно, использование аморфного металла затворов TaSiN в DG FinFETs показало до 2-х кратного снижение вариации V T по сравнению с поликристаллическими TiN металлическими затворами. Для полностью обедненных КНИ (FD-SOI) и/или FinFET технологий, которые опираются на металлические затворы с перестраиваемой работой выхода для регулировки порогового напряжения, вопросы WFV будут, несомненно, важной темой.
6. Случайный телеграфный шум
Случайный телеграфный шум (Random Telegraph Noise − RTN) объясняется захватом и эмиссией заряженных носителей с одиночной ловушки в оксиде. RTN привлекает большое внимание в последние годы. Причина в том, что разбросы прибора из-за RTN резко увеличиваются, когда прибор масштабируется. Последние исследования показывают, что изменение RTN растет быстрее, чем разбросы, вызванные RDF. Уровень разброса при 3σ может доминировать в разбросе прибора при 22нм технологических нормах. Захваченный заряд влияет на электростатические и транспортные свойства в канале, вызывая дополнительный сдвиг VT. Величина сдвига V T вследствие RTN зависит от емкости оксида, и так уже страдающей от RDF. Поэтому, когда рисунок топологии масштабируется, значение влияния RTN на вариацию V T возрастает. Однако в связи с небольшой вероятностью появления большой амплитуды RTN, на величину разброса параметров КМОП это существенно не влияет. Основное воздействие RTN на КМОП в худшем случае заключается в сдвиге V T и параметров во временной области. В отличии от предыдуших источников разброса, RTN – эффект, зависящий от времени.
Величина сдвига VТ, индуцированного RTN от одной ловушки, обратно пропорциональна площади канала. Из-за этой зависимости величина RTN от одной ловушки резко идет вверх, когда размер прибора уменьшается. В недавних исследованиях для 22нм технологического процесса, индуцированное RTN изменение порогового напряжения на уровне  может достигать 50-100мВ, что приводит к сильному влиянию на проектирование, в частности, при проектировании приборов с низким потреблением мощности.
может достигать 50-100мВ, что приводит к сильному влиянию на проектирование, в частности, при проектировании приборов с низким потреблением мощности.



 = 10нм и номинальной концентрацией примеси
= 10нм и номинальной концентрацией примеси  = 5нм, и N = 1,33∙1018 см-3 имеет в среднем всего десять атомов примеси и добавление или вычитание одного примесного иона дает уже в результате 10% изменение общего числа атомов легирующей примеси.
= 5нм, и N = 1,33∙1018 см-3 имеет в среднем всего десять атомов примеси и добавление или вычитание одного примесного иона дает уже в результате 10% изменение общего числа атомов легирующей примеси.
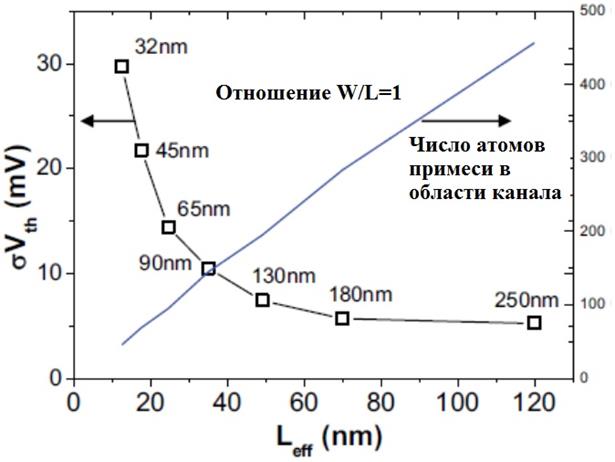
 , то есть RDF является наиболее значимой причиной разброса.
, то есть RDF является наиболее значимой причиной разброса.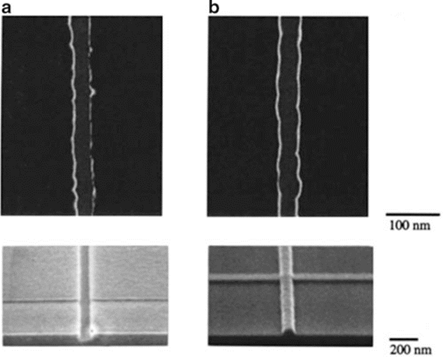

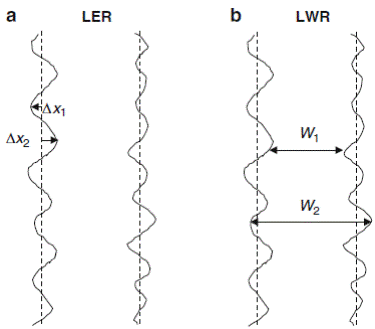

 ,
,  − корреляционный коэффициент в диапазоне между 0 (полностью некоррелированные) и 1 (полностью коррелирует). Таким образом, если
− корреляционный коэффициент в диапазоне между 0 (полностью некоррелированные) и 1 (полностью коррелирует). Таким образом, если  , тогда σLWR= 0, даже если
, тогда σLWR= 0, даже если  .
. для 32-нм технологии (2012 год), что соответствует величине σLER < 0,6нм, предполагая стандартный рисунок резиста. Сохранение σLER таких достаточно низких значений представляет одну из главных проблем масштабирования существующего уровня front-end процессов.
для 32-нм технологии (2012 год), что соответствует величине σLER < 0,6нм, предполагая стандартный рисунок резиста. Сохранение σLER таких достаточно низких значений представляет одну из главных проблем масштабирования существующего уровня front-end процессов. была сокращена до менее, чем 1,2нм = 12 Å, что меньше толщины пяти атомных слоев.
была сокращена до менее, чем 1,2нм = 12 Å, что меньше толщины пяти атомных слоев.
 ! Это может привести к значительным вариациям характеристик прибора, подобно эффектам LER и RDF. Легко представить, как дальнейшее масштабирование на основе оксидов кремния до 1нм или тоньше, становится проблематичным не только с точки зрения утечки затвора, но и от OTF.
! Это может привести к значительным вариациям характеристик прибора, подобно эффектам LER и RDF. Легко представить, как дальнейшее масштабирование на основе оксидов кремния до 1нм или тоньше, становится проблематичным не только с точки зрения утечки затвора, но и от OTF. ), которые могут быть сделаны толще, и в то время все еще обеспечивая ту же эквивалентную толщину оксида (EOT) как и SiO2 (
), которые могут быть сделаны толще, и в то время все еще обеспечивая ту же эквивалентную толщину оксида (EOT) как и SiO2 ( ). В этом случае, не только номинальная
). В этом случае, не только номинальная  становятся толще, но и одно- или даже многослойные флуктуации создают меньшее относительное изменение в
становятся толще, но и одно- или даже многослойные флуктуации создают меньшее относительное изменение в  . В результате перехода технологии к
. В результате перехода технологии к  может достигать 50-100мВ, что приводит к сильному влиянию на проектирование, в частности, при проектировании приборов с низким потреблением мощности.
может достигать 50-100мВ, что приводит к сильному влиянию на проектирование, в частности, при проектировании приборов с низким потреблением мощности.

