

Кормораздатчик мобильный электрифицированный: схема и процесс работы устройства...

История создания датчика движения: Первый прибор для обнаружения движения был изобретен немецким физиком Генрихом Герцем...

Кормораздатчик мобильный электрифицированный: схема и процесс работы устройства...

История создания датчика движения: Первый прибор для обнаружения движения был изобретен немецким физиком Генрихом Герцем...
Топ:
Эволюция кровеносной системы позвоночных животных: Биологическая эволюция – необратимый процесс исторического развития живой природы...
Интересное:
Принципы управления денежными потоками: одним из методов контроля за состоянием денежной наличности является...
Влияние предпринимательской среды на эффективное функционирование предприятия: Предпринимательская среда – это совокупность внешних и внутренних факторов, оказывающих влияние на функционирование фирмы...
Национальное богатство страны и его составляющие: для оценки элементов национального богатства используются...
Дисциплины:
|
из
5.00
|
Заказать работу |
|
|
|
|
В процессе технологического цикла производства твердотельных интегральных микросхем используются различные операции, содержание которых кратко можно описать следующим образом.
Первоначально выращивается полупроводниковый кристалл кремния. Специальными методами достигается идеальность его кристаллической решетки и необходимое содержание примесей. В исходном состоянии диаметр кристалла кремния может достигать десятки сантиметров.
Цилиндрический кристалл кремния разрезается на тонкие пластины толщиной до 50-80 мкм, которые в дальнейшем выступают как подложка. На каждой подложке в процессе дальнейшего технологического процесса одновременно будет формироваться сотни одинаковых микросхем.
Фотолитография (рентгеновская литография, электронолитография) как процесс переноса рисунков с фотошаблонов на поверхность пластины кремния (подложки), включает в себя следующие неоднократные процедуры (итерации):
– выращивание на поверхности кремния слоя окиси SiO 2;
– нанесение на поверхность пластины слоя фоторезиста – полимера, ″твердеющего″ под действием света;
– первичная сушка;
– установка фотошаблонов (фотомаски) на поверхность подложки;
– экспозиция (облучение) кристалла через маску в ультрафиолетовом свете;
– проявление (обработка облученного фоторезиста);
– вторичная сушка фоторезиста;
– химическое травление и удаление остатков фоторезиста;
– формирование металлических электродов на поверхности подложки;
– "раскрытие" новых окон в пленке окисла, в которые путем диффузии направляются примеси для создания областей эмиттеров и коллекторов, истоков и стоков и т. п. Это достигается использование новых фотошаблонов.
|
|
Свет обладает дифракционными свойствами, поэтому при облучении маски граница между темными и светлыми участками схемы не резкая, а размытая. Этот эффект приводит к ограничению минимального размера окна, через которое идет формирование структуры (облучение, легирование и т.п.) до 1 мкм. Этот размер сравним с применяемой длиной волны ультрафиолета (УФ).
Таким образом, дифракционные свойства света накладывают дальнейшие ограничения на увеличение степени интеграции схемы.
В то же время размеры некоторых элементов в современных микросхемах составляют десятые доли микрон (субмикронные размеры). Для получения таких схем необходимо уменьшать длину волны света, используемого для облучения фотомаски. Поэтому вместо УФ перспективным является использование рентгеновского излучения или электронных пучков. В частности, при использовании рентгеновского излучения и электронных пучков с энергией 104 эВ можно получить минимальные размеры элемента на схеме менее 10 -100 нм.
Как правило, перечисленный выше процесс повторяется неоднократно (5 – 6 итераций) в зависимости от сложности схемы.
Диффузия – процесс, при котором формируются области р - и n - переходов, области стока (С), истока (И), базы (Б), эмиттера (Э), коллектора (К). В качестве акцептора используется обычно бор, в качестве донора – мышьяк.
Эпитаксиальный процесс – ориентированное выращивание одного монокристалла на поверхности другого. В частности, выращивается второй или третий кремниевый слой на поверхности окисла кремния из газовой фазы и создается объемная многослойная конструкция микросхемы.
Термическое оксидирование – создание на поверхности кремния пленки окисла во влажной среде. Пленка SiO 2 служит не только защитой структуры от окисления, но и выполняет диэлектрическую (электроизоляционную) функцию, например в МОП-конденсаторах, полевых транзисторах и т. п.
Ионная имплантация – внедрение в объем пластины примесей (бора, фосфора, мышьяка) в виде ионов с высокой энергией как для устранения неоднократных высокотемпературных нагревов для диффузии, так и для удобства процесса, поскольку при ионной имплантации ионы не проникают через тонкие слои окисла, которые можно использовать для защиты отдельных структур.
|
|
Металлизация – процесс осаждения металла (золото, алюминий, никель) на электрические соединения, контакты, выводы.
После проведения многочисленных технологических операций наступает завершающая фаза – скрайбирование, которая представляет собой механическое разрезание описанной выше плоской кремниевой пластины с сотнями одинаковых микросхем на отдельные кристаллы. Каждый из данных кристаллов является готовой микросхемой, помещаемой в отдельный корпус. После того, как к каждой твердотельной микросхеме привариваются (обычно, лазерная сварка) золотые проволочки в качестве электрических контактов, происходит ″заваривание″ микросхемы в пластмассовый корпус.
6.1.3. Производство планарного биполярного транзистора
Упрощенное представление этапов процесса производства кремниевого планарного биполярного p - n - p -транзистора, формируемого на поверхности кристаллической подложки кремния, показана на рис. 6.1, 6.2.
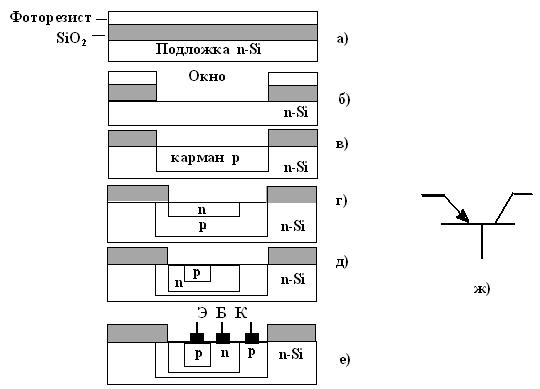
Рис. 6.1. Структура поперечного сечения пластины (а-е) и УГО транзистора (ж)
Из слитков кремния (рис. 6.1, а) изготавливают тонкие пластины (подложки), одна их поверхностей которых полируется, а затем окисляется во влажной среде. Вследствие этого на подложке образуется изоляционный слой двуокиси кремния (SiO 2). Поверх окисла наносится слой светочувствительного полимерного материала – фоторезиста, который под действием облучения светом изменяет свои химические свойства. Например, негативный фоторезист под действием ультрафиолета так полимеризуется, что не растворяется и не удаляется специальными растворителями с засвеченных участков подложки. Напротив, позитивный фоторезист – растворяется и удаляется после облучения, а на необлученных участках не удаляется химикатами, для этой цели используют другие травители (ультразвук и т. п.).
К покрытой фоторезистом подложке прижимается контактным способом стеклянный фотошаблон (фотомаска), на котором имеются прозрачные и непрозрачные участки в зависимости от топологии микросхемы и свойств выбранного фоторезиста.
|
|
При фотолитографии фоторезист облучается ультрафиолетом, при ретнгенолучевой литографии – рентгеновским излучением, при электронографии – потоком электронов, что, как отмечено выше, позволяет уменьшить минимальные размеры элементов структуры и, соответственно, увеличить степень интеграции K.
Следует отметить, что с помощью стеклянного фотошаблона на поверхности плоской подложки одновременно формируются сотни одинаковых структур будущих транзисторов, количество которых ограничивается диаметром подложки кремния (диаметром исходного слитка) и размерами одной микросхемы.
Пластина (рис. 6.1, б) с засвеченным, например, позитивным фоторезистом погружается в травитель, который растворяет участки фоторезиста, на которые попадали кванты света, а также слои окисла под засвеченными участками. В результате травления (проявления фоторезиста) на подложке образуются участки чистой поверхности кремния - окна. Затем в другом травителе, растворяющем незасвеченный фоторезист, но не растворяющим пленку SiO 2, удаляется оставшийся фоторезист. В результате этой операции на подложке имеются многочисленные открытые окна, разделенные слоями окисла.
Через маску (специальную пластину с необходимыми отверстиями) в подложку через окна вводят ионы, например, бора (диффузией, облучением ионными пучками и т. п.), вследствие чего под окном образуется карман – р -область (рис. 6.1, в).
Путем последующих итераций технологического процесса (рис. 6.1, г, д) на пластине формируется n -область в р -кармане (например, диффузией донорной примеси в объем) и, наконец, р -область, выступающая в качестве будущего эмиттера биполярного транзистора p-n-p -типа.
После формирования базы, эмиттера и коллектора транзистора (рис. 6.1, е) на поверхности создаются металлические контакты (например, из алюминия). Для устранения дополнительных p-n -переходов, непосредственно примыкающих к металлическим контактам, на соответствующих контактах создаются так называемые сильно легированные области n +– и p + –типа.
При современных технологиях размеры микротранзистора (интегральный транзистор), включая эмиттер, базу, коллектор, составляют не более 5–10 мкм.
|
|
Топология микросхем – определенная конфигурация и расположение элементов на поверхности кристалла (рис. 6.2, 6.3). Первоначально топология создается специальной программой ЭВМ, на основе которой конструируются специальные фотошаблоны. Впоследствии методами фотолитографии разработанная топология воплощается в кристалле.

Рис. 6.2. Топология планарного биполярного транзистора: а – вид сбоку; б – вид сверху
Минимальные поверхностные размеры отдельного эмиттера, базы, коллектора, очевидно, ограничивает суммарное количество транзисторов (степени интеграции) в конструкции с подобной топологией.
На одной пластине (подложка кремния толщиной до 100 мкм) формируется одновременно несколько сотен микросхем. На рис. 6.3, б пунктиром обозначена область, занимаемая одним биполярным транзистором. Например, если площадь, занимаемая одним транзистором равна примерно 50х30 мкм2, то на пластине размером 1х1 мм2 можно разместить не более 1 мм2/1500·10–6 мм2 = 666 элементов. Таким образом, микросхема, изготовленная на основе устаревшей технологии, имеет степень интеграции не более К = 3.
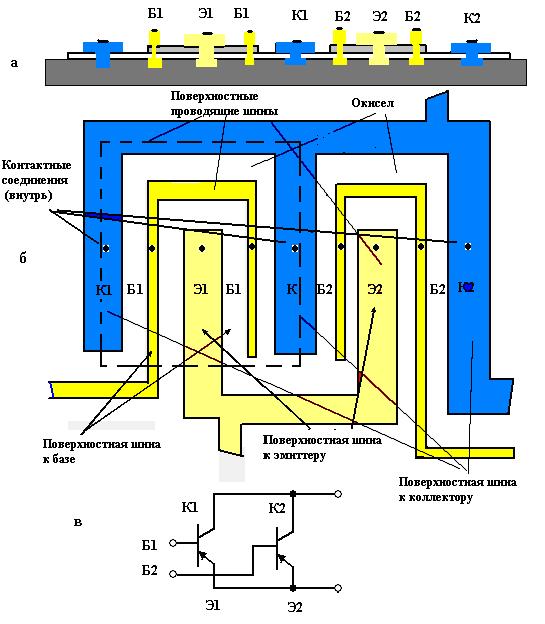
Рис. 6.3. Топология планарных биполярных транзисторов в микросхеме:
а – вид сбоку; б – вид сверху (пунктиром ограничена область одного транзистора);
в – электрическая схема двух планарных транзисторов
Как правило, в состав микросхемы входят многочисленные транзисторы, которые, в частности, могут соединяться по схемам ОБ, ОЭ, ОК, объединяться параллельно с целью увеличения тока (мощности) и т. п.
Топология нескольких биполярных транзисторов в твердотельной микросхеме представлена на рис. 6.3, где приведены два планарных биполярных p-n-p -транзистора, имеющих объединенные (общие) коллекторы, эмиттеры, но индивидуальные входы баз. Минимальные линейные размеры элементов, подобных ИС, не превышают 2,5 мкм.
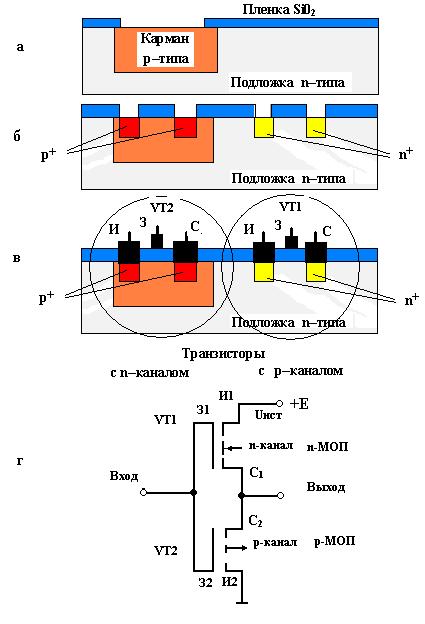
Рис. 6.4. Процесс формирования планарного (а-в) и применение (г) КМОП-транзистора
6.1.4. Производство планарного полевого транзистора
При создании микросхем на МОП-транзисторах широко используется так называемая комплементарная МОП-пара ( рис. 6.4) - два МОП-транзистора (ПТИЗ) с индуцированными каналами разного типа проводимости, которые как бы дополняют (комплементарны) друг друга. Подобные транзисторы называют КМОП-транзисторы.
Последовательность отдельных операций при изготовлении КМОП-структуры на поверхности кремниевой подложки показана на рис. 6.4, а, б, в. Первоначально путем ионной имплантации на подложке n -типа создают VT 1 транзистор p -МОП, а рядом с ним – VT 2-транзистор n -МОП. При этом обеспечивается изоляция истока n +-типа и стока n + от кремниевой подложки.
|
|
Для примера, на рис. 6.4, г изображена распространенная схема на базе КМОП-структуры прибора – инвертора, изменяющего полярность входного сигнала (сдвиг фаз между входным и выходным сигналами составляет 180о).
Транзисторы подобной пары на КМОП-транзисторах соединены последовательно по цепям "сток – исток" и подключены к источнику питания (рис. 6.4, г). Входом схемы инвертора являются соединенные затворы полевых транзисторов. В таком инверторе в статическом режиме один из транзисторов закрыт, поэтому ток потребления пренебрежительно мал, и им можно пренебречь. Следовательно, подобный инвертор обладает высокой энергоэффективностью.
|
|
|

Индивидуальные и групповые автопоилки: для животных. Схемы и конструкции...

Своеобразие русской архитектуры: Основной материал – дерево – быстрота постройки, но недолговечность и необходимость деления...

История создания датчика движения: Первый прибор для обнаружения движения был изобретен немецким физиком Генрихом Герцем...

Автоматическое растормаживание колес: Тормозные устройства колес предназначены для уменьшения длины пробега и улучшения маневрирования ВС при...
© cyberpedia.su 2017-2024 - Не является автором материалов. Исключительное право сохранено за автором текста.
Если вы не хотите, чтобы данный материал был у нас на сайте, перейдите по ссылке: Нарушение авторских прав. Мы поможем в написании вашей работы!