ПУЧКОВЫЕ МЕТОДЫ ИССЛЕДОВАНИЯ
Содержание
Классификация пучковых методов исследования
Просвечивающая электронная микроскопия (ПЭМ)
Взаимодействие электронного излучения с веществом
Дифракция электронов на кристаллической решетки
Устройство и работа просвечивающего электронного микроскопа
Достоинства и недостатки просвечивающей электронной микроскопии
Формирование изображения в просвечивающем электронном микроскопе
Разрешающая способность ПЭМ
Компьютерное моделирование дифракционного контраста
Высоковольтная электронная микроскопия
Получение изображения, соответствующего периодической структуре кристаллической решетки
Методика слабого пучка
Просвечивающая растровая электронная микроскопия
Приготовление образцов для электронно-микроскопического исследования
Растровая электронная микроскопия.
Физические основы формирования изображения в растровом электронном микроскопе (РЭМ).
Устройство и принцип работы растрового (сканирующего) электронного микроскопа
Основные технические характеристики и технические возможности РЭМ.
Сканирование. Увеличение. Глубина фокуса.
Особенности увеличения в РЭМ
Основные типы контраста
Детекторы электронов
Дополнительные возможности РЭМ (поглощенный ток электронов, катодная люминесценция)
Возможности применения энергодисперсионного рентгеновского спектрометра при исследовании объектов в РЭМ
Ограничения метода РЭМ
Методики исследования в РЭМ.
Стандартные тест-объекты
Основные технические характеристики и технические возможности РЭМ
Технические возможности современных РЭМ
Различия и особенности методик РЭМ, применяемых в материаловедении, геологии, биологии
Диапазон и характер исследований РЭМ. Оценка и сравнение возможностей методик РЭМ, ПЭМ и СЗМ
Примеры задач материаловедения, решаемых с помощью растровой электронной микроскопии
Пример исследования с использованием РЭМ нанопорошков
Синхротронное излучение
Условия и оборудование для получения СИ
Применение СИ в нанотехнологиях.
Рентгеновская дифракция
Условия и оборудование реализации метода рентгеновской дифракции.
Параметры наноматериалов, исследуемые рентгеновским методом
Параметры наноматериалов, определяемые в ходе комплексного исследования с использованием ПМИ.
Приборы комплексного исследования и модификации нанообъектов.
Классификация пучковых методов исследования
Пособие посвящено современным пучковым методам исследования материалов, в частности, методам электронной микроскопии, рентгеновской дифракции, синхротронного излучения и другим, являющихся эффективными методами исследования реального строения материалов, в том числе и наноструктурированных.
Пучковые методы исследования основаны на использовании пучков частиц и излучений различной природы для зондирования вещества с целью изучения и модификации состава, структуры, геометрических параметров и свойств вещества.
Классификация пучковых методов возможна по физической природе пучков, по цели применения, по проникающей способности, по длине волны излучения.
Классификация по физической природе частиц и излучений: электромагнитное излучение, электронное излучение, ионные пучки, молекулярные пучки, позитронные пучки, нейтронные пучки.
Классификация по цели применения частиц и излучений: элементный анализ, фазовый анализ, структурный анализ, анализ электрофизических, магнитных и оптических и других свойств.
Классификация по проникающей способности: излучения и частицы с малой проникающей способностью, со значительной проникающей способностью, с почти абсолютной проникающей способностью.
Классификация по длине волны: g-излучение (до 0,01нм) рентгеновское излучение (0,01 – 10нм), ультрафиолетовое излучение (10 – 380 нм), видимое излучение (380 – 700 нм), инфракрасное излучение (760 – 106 нм), радиоволны (больше 106 нм
В первом разделе кратко рассмотрены принципы действия электронных микроскопов, формировании электронно-микроскопического изображения. Содержатся сведения о некоторых основных электронно-микроскопических методиках и получаемой с их помощью информации.
Разрешающая способность ПЭМ
Разрешающая способность ПЭМ как минимальное расстояние между двумя точками объекта, которое еще можно различить на изображении, зависит от следующих основных факторов:
-длины волны электронов;
-величины сферической аберрации;
-величины хроматической аберрации; -астигматизма,
-механической стабильности и состояния прибора (вакуум, чистота и т.д.).
Длина волны электронов, ускоренных высоким напряжением, является, как известно, основным условием уникальной разрешающей способности электронного микроскопа, так как чем меньше длина волны, тем меньше элементы структуры объекта, на которых может происходить дифракция волн, т.е. тем ниже оптическая однородность среды для волн данной длины.
Длина волны электрона l определяется, исходя из известных соотношений:
U*e = m*v/2
где e - заряд электрона; m. - масса движущегося электрона; U - ускоряющее напряжение; v - скорость электрона.
С другой стороны, по формуле Де-Бройля.
h = m*v *l
Отсюда можно получить
l = h/(2m*U*e)-2
Подставляя численные значения, получим простое выражение:
l =1226/(U) -2, нм
Изменение массы электрона при изменении скорости учитывается введением в формулу релятивистской поправки (рис.13).
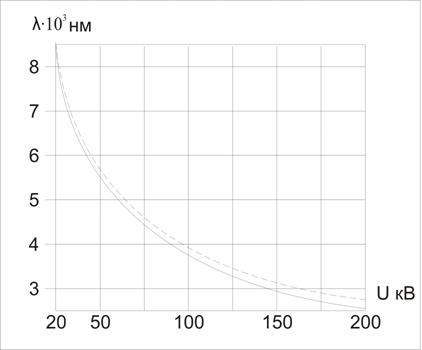
Рис. 13. Зависимость длины волны электронов от ускоряющего напряжения (без релятивистской поправки сплошная кривая, с релятивистской поправкой пунктирная кривая)
Величина сферической аберрации оптической системы определяется сферической аберрацией объективной линзы. Неизбежная неоднородность радиальной составляющей магнитном поля в линзе (см.рис.7) (на периферии напряженность больше, чем у оси). Это приводит к неравенству фокусных расстояний линзы для приосевых и периферийных электронов (рис.14).

Рис. 14. Схема сферической аберрации
Поэтому для построения изображения используются, как правило, только приосевые электроны, остальные отсекаются апертурной диафрагмой. Однако величину диафрагмы нельзя сколь угодно сделать малой, так как при уменьшении отверстия диафрагмы уменьшается доля информации, которая переносится ЭП на экран. В частности, если пройдет только один неотклоненный или только дифрагированный пучок, то пропадет информация о самых малых объектах, которые может различить микроскоп - атомах. Таким образом, с одной стороны, разрешение ограничено самим прибором и нужно уменьшать отверстие апертурной диафрагмы, с другой стороны, разрешение ограничено необходимостью для различения самых малых объектов пропустит через диафрагму не менее двух пучков. Значит, для демонстрации предельного разрешения существует оптимальный размер диафрагмы. Здесь следует отметить, что ПЭМ часто используется именно для получения изображения только в одном пучке, когда контраст создается расчет удаления части интенсивности электронных волн в местах, где несовершенства структуры объекта меняют дифракционные условия. Такой контраст называется амплитудным. При этом не требуется, как правило, наивысшей разрешающей способности.
Может иметь значение также, так называемая дифракционная ошибка, заключающаяся в том, что пучок, падающий на объект, не может быть строго параллелен, а расходящийся пучок при дифракции даст также расходящийся дифрагированный ЭП. При этом точка на объекте превратится в пятно на экране, а два близко расположенных пятна сольются в одно, т.е. будут неразрешимы отдельно друг от друга.
Изображении в двух и более пучках возникает в условиях так называемого фазового контраста, когда в плоскости изображения интерферируют пучки, прошедшие в отверстие апертурной диафрагмы (рис.8).
Но тогда отверстие диафрагмы должно быть достаточно большим и появляется проблема сферической аберрации объективной линзы.
Большое, влияние на качество изображения оказывает также хроматическая аберрация, обусловленная тем, что электроны в ЭП имеют некоторый разброс по скоростям. Вследствие этого они по-разному преломляются в объективной линзе и дают размытость на изображении. Борьба с этим видом искажений заключается в повышении стабильности ускоряющего напряжения и тока в линзах микроскопа, но некоторой влияние на скорость электронов может оказать и сам образец, с чем, естественно, бороться невозможно.
Астигматизм изображения выражается в том, что такой объект, как круглое отверстие в образце, на экране будет выглядеть эллипсом. Это особенно проявляется при не осевом освещении объекта; возникновение этого дефекта связано в неоднородностью магнитного поля линз из-за несовершенства геометрической формы наконечников, с неоднородность магнитных свойств материала наконечников, а также с возможным загрязнением. Астигматизм в некоторой степени устраняется стигматорами - специальными устройствами, накладывающими на основное поле линз слабое эллиптическое поле, амплитуда и направление которого регулируются, компенсируя астигматизм.
Механическая нестабильность прибора - весьма коварный фактор, так как даже небольшие малозаметные колебания могут привести к размытости изображения, что особенно сказывается при регистрации на фотоматериал. Поэтому прибор лучше всего размещать на отдельном фундаменте, а особенно ответственные работы, связанные с высоким разрешением проводить в ночное время.
Методика слабого пучка
Так называется способ получения темнопольных электронно-микроскопических изображений при действии отражения, значительно отклоненного от точного Вульф-Брэгговского отражающего положения и, следовательно, обладающего малой интенсивностью. Основное достоинство методики состоит в том, что при таких дифракционных условиях формирования изображения существенно снижается ширина контраста от дислокаций и других очагов локальных искажений кристаллической решетки. Кроме того, удается приблизить изображение дефектов на электронно-микроскопическом снимке к их истинному положению в кристалле, а также существенно упростить контраст от наблюдаемого дефекта» вследствие уменьшения динамических эффектов рассеивания. Эти обстоятельства делает методику слабого пучка одним из наиболее эффективных для электронно-микроскопического анализа реальной структуры металлов и сплавов, особенно о высокой плотностью всевозможных дефектов.
Однако применение методики слабого пучка сопряжено с целым рядом трудностей. Темнопольное изображение в режиме слабого пучка обладает низкой интенсивностью. Иногда она оказывается столь незначительной, что на экране электронного микроскопа трудно различить элементы дифракционного контраста, и только последующее изучение микрофотографий позволяет судить об эффективности проведенного эксперимента. Все это предъявляет повышенные требования, во-первых, к качеству объекта исследования, поскольку диффузный фон на микроэлектроннограмме (из-за плохой поверхности фольги) исключает получение высококачественных изображений в слабом пучка, и, во-вторых, к механической и электрической стабильности электронного микроскопа.
Отметим три наиболее важных аспекта применения методики слабого пучка при структурных исследованиях.
1. В первую очередь методика эффективна при разрешении отдельных близко расположенных дефектов. Такая ситуация может сложиться, когда в нанообъектах возникает высокая плотность дефектов, в частности, в результате мартенситного превращения, пластической деформации значительных степеней или, когда линейные дефекты соединены другим высокоэнергетическим пленарным дефектом, например, частичные дислокации, соединенные, дефектом упаковки, или сверхструктурные дислокации, в которых единичные дислокации соединены полоской антифазной границей. С помощью методики слабого пучка удается разрешить частичные дислокации различных типов, детально проанализировать структуру дислокационных ячеек сложных субграниц, сверхструктурных дислокаций.
2. При отклонении от точного отражающего положения дифракционный контраст в темном поле возникает лишь в узкой области дефекта, где кристаллическая решетка в достаточной степени искажена и где тем самым обеспечивается локальный доворот тех же отражающих плоскостей до точного отражающего положения. В том случае, когда удается зафиксировать дифракционные условия, при которых наиболее искаженные области дефекта выходят из отраженного положения и, следовательно, наблюдается резкое исчезновение контраста от дефектов, можно получить количественную информацию о величине максимального искажения решетки в области дефектов.
3. Возможность "сортировки" очагов локальной деформации кристаллической решетки. По мере отклонения от точных условий дифракции на темнопольных изображениях постепенно исчезают дефекты с относительно малой величиной локальных смещений и сохраняются лишь те дефекты, у которых смещения достаточно велики. Поэтому, переходя во все большей степени к режиму слабого пучка, можно устранить контраст от лишних дефектов, затрудняющие выявление изучаемых особенностей структуры.
Основные типы контраста
Контраст С оказывает прямое влияние на разрешающую способность.
С = (Smax – Smin)/Smax,
где Smax и Smin - сигналы в любых двух точках растра сканирования. Таким образом, формирование контраста С в РЭМ определяется разностью детектируемых сигналов от соседних участков образца, чем она больше, тем выше контраст изображения. При рассмотрении понятия контраста важно рассматривать его как замкнутую систему: образец – детектор.
Контраст зависит от нескольких факторов: топографии поверхности, химического состава объекта, поверхностных локальных магнитных и электрических полей, кристаллографической ориентации элементов структуры.
Важнейшими из них являются топографический, зависящий от неровностей поверхности образца, а также композиционный, зависящий от химического состава. Уровень контраста определяется также и эффективностью преобразования падающего на детектор излучения, которое создает сигнал на его выходе. Если получаемый в итоге контраст недостаточен, то его можно повысить, увеличив ток зонда. Однако большой поток электронов в силу особенностей электронной оптики не может быть хорошо сфокусирован, то есть диаметр зонда возрастает и, соответственно, снижается разрешающая способность. Контраст обусловлен рассеянием электронов при взаимодействии электронного пучка с образцом. Если область взаимодействия достаточно мала (рис. 19), то доля рассеянных электронов невелика. При взаимодействии первичных электронов с образцом одни из них рассеиваются из-за столкновений с ядрами атомов образца, другие – из-за столкновений с электронами атомов, а третьи проходят, не претерпевая рассеяния. Степень рассеяния в какой-либо области образца зависит от топографических особенностей поверхности этой области, плотности образца и средней атомной массы (числа протонов) в данной точке.
Размеры области генерации сигнала в образце также могут ограничивать разрешение, если поглощенные электроны генерируются в большом объеме (рис.19). Разрешающая способность при получении изображений в этом случае невелика и имеет такой же порядок, как и для отраженных электронов. Высокая разрешающая способность достигается при изображении во вторичных электронов, зона выхода которых ограничена малой областью вокруг места падения зонда
Детекторы электронов
Назначение детектора в РЭМ: преобразование излучения, выходящего с образца, в электрический сигнал, который после прохождения усилителя модулирует интенсивность на экранах для наблюдения и фотографирования.
Любую детекторную систему характеризуют три основных параметра:
1) угол приема (или выхода) сигнала – угол по отношению к поверхности образца, под которым детектор принимает сигнал;
2) телесный угол, в котором детектор принимает сигнал
Ω = A/r 2;
где А – площадь детектора, а r – расстояние от точки падения пучка на образец до детектора;
3) эффективность преобразования, или процент попадающего на детектор излучения, которое создает сигнал на его выходе.
Как известно, существуют различные сигналы: вторичные электроны, отраженные электроны, рентгеновское излучение, катодолюминесценция, ток на образец (поглощенный ток), и в ряде типов полупроводниковых образцов наведенный ток.
Основные режимы работы в РЭМ получение изображения во вторичных и отраженных электронах. Вторичные электроны эмитируются со средней энергией 3 – 5эВ. Энергия отраженных электронов находится в диапазоне 0 < E < E0, где E0 – энергия падающего пучка. Для материалов со средним и высоким атомным номером распределение отраженных электронов по энергиям имеет максимум при 0,8 – 0,9 E 0. Наиболее широко используемым детектором в РЭМ является система сцинциллятор-фотоумножитель, современная форма которой разработана Эверхартом и Торнли.
Детектор Эверхарта-Торнли (рис. 21) (сцинциллятор-фотоумножитель) используется в качестве детектора вторичных и отраженных электронов, создающего ток вторичной эмиссии в диапазоне 10-9-10-13А, усиление 105 -106, обладает малым уровнем шума и широкой полосой пропускания.
Схема детектора представлена на рис. 20. Коллектор 1 имеет положительный потенциал, приблизительно +250 В, благодаря чему траектории вторичных электронов искривляются и они попадают в коллектор. На первичные и отраженные электроны, имеющие высокие значения энергии, этот потенциал существенного влияния не оказывает.

Рис. 21. Схема детектора эмитированных электронов Эверхарта-Торнли.
1 – коллектор, 2 – световод, 3 – сцинтиллятор, 4 – фотоумножитель.
Внутри коллектора электроны ускоряются. Для этого на сцинтиллятор 3 подается высокое напряжение порядка 12 кВ. Его влияние на электронный зонд экранируется корпусом коллектора. Вследствие ускорения вторичные электроны получают достаточную энергию, чтобы вызвать световое излучение материала сцинтиллятора, которое по световоду 2 попадает на фотоумножитель 4, где преобразуется в электрический сигнал. Мощность этого сигнала и, следовательно, яркость соответствующей точки на экране при использовании вторичных электронов определяется топографическим контрастом. Характерная особенность топографического контраста в РЭМ - повышенная яркость изображения острых вершин и выступов рельефа поверхности образца, вызывается увеличением выхода электронов с этих участков. При формировании изображения в режиме детектирования вторичных электронов возможно появление незначительного композиционного контраста.
Для регистрации отраженных электронов могут использоваться различные типы детекторов, в том числе и детектор Эверхарта-Торнли, но с некоторым изменением. Это вызвано тем, что отраженные электроны имеют высокую энергию, движутся прямолинейно, не отклоняясь электрическим полем в отличие от вторичных электронов. Поэтому нет необходимости использовать в детекторе высокие напряжения и, следовательно, коллектор. Эффективность сбора отраженных электронов зависит от угла наклона детектора к поверхности генерации электронов и расстояния между ними. Получение изображения в отраженных электронах вызвано тем, что эмиссия этих электронов зависит от порядкового номера химического элемента. На плоской поверхности образца участок материала с более высоким средним порядковым номером атомов отражает большее количество электронов и выглядит на экране более светлым относительно других участков образца. Полученный контраст называют композиционным.
Изображение в отраженных электронах позволяет определить количество фаз в материале, наблюдать микроструктуру материала без предварительного травления шлифа и др. Выявление структуры материала становится возможным, поскольку химический состав зерен в многокомпонентных системах отличается от химического состава их границ. В том случае, когда поверхность образца имеет ярко выраженные неровности, то дополнительно к композиционному возникает топографический контраст. Для разделения композиционного и топографического контрастов применяют два детектора отраженных электронов Эверхарта-Торнли. На рис.22 приведен пример разделения контрастов. В случае сложения сигналов детекторов Д1 и Д2 усиливается композиционный и устраняется топографический контраст.
При вычитании сигналов аннулируется контраст композиционный и усиливается топографический.
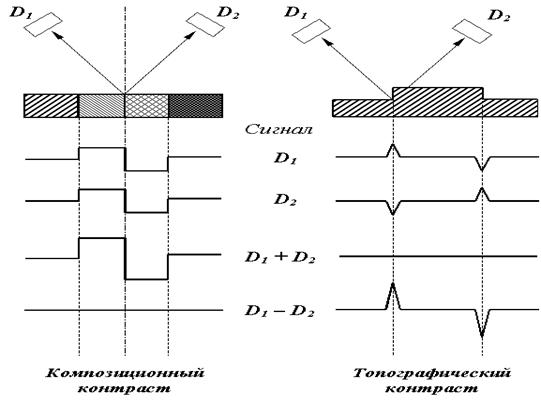
Рис. 22.Использование парного детектора (Д1, Д2) для разделения композиционного (I) и топографического контрастов (II).
При получении изображения в поглощенных электронах сигналом служит ток поглощенных электронов, который равен току первичных электронов за вычетом тока отраженных и вторичных электронов. В итоге он зависит от количества эмитированных отраженных и вторичных электронов. Соответственно в сигнале присутствуют как композиционная, так и топографическая составляющая, причем они не разделяются.
При сканировании зонда по поверхности образца, имеющего химическую неоднородность и сильно выраженный рельеф, интенсивность сигнала будет меняться. Для улавливания сигнала не требуется специальный детектор. Его роль выполняет образец, в котором образуются поглощенные электроны. Поток поглощенных электронов только усиливается, а затем передается в блок изображения.
Ограничения метода РЭМ
По разрешающей способности РЭМ занимает промежуточное положение между оптическим и просвечивающим электронным микроскопами.
Предельное разрешение, получаемое на изображении в РЭМ, может ограничиваться любым из следующих факторов:
1) работой электронно-оптической системы,
2) контрастом, создаваемым образцом и детекторной системой,
3) областью генерации сигнала в образце.
Ограничения, накладываемые электронной оптикой связаны с аберрациями линз, приводящими к существенному расширению зонда. Также как и в ПЭМ к ним относятся хроматическая, сферическая аберрации и астигматизм.
Хроматическая аберрация возникает из-за различной скорости (т.е. длины волны) электронов и изменении ее по времени, что приводит к непостоянству фокусных расстояний линз. Хроматическую аберрацию уменьшают путем стабилизации ускоряющего электроны напряжения и электрического тока в линзах.
Сферическая аберрация возникает вследствие того, что электроны проходят на различных угловых расстояниях от оптической оси линзы и поэтому по разному фокусируются. Сферическую аберрацию уменьшают наложением строгих ограничений на геометрию полюсных наконечников линз, увеличением ускоряющего напряжения и уменьшением диафрагмы. В этом случае поток формируется электронами, в меньшей степени отклоненными от оптической оси линзы.
Возникновение астигматизма связано с нарушением магнитной или геометрической симметрии линзы. Устранение асимметрии достигается обеспечением высокой геометрической точности изготовления полюсного наконечника линзы и введением специальной системы, называемой стигматором, который корректирует магнитное поле линзы, восстанавливая его симметрию.
Ограничения, обусловленные областью зондирования. Ситуация 1: ток пучка минимальный, а наблюдаемое на образце пространственное разрешение существенно выше размера пучка. Это происходит в случае, когда область взаимодействия пучка с образцом (формирование вторичных и отраженных электронов) существенно больше размера зонда. Пример: межфазная граница между материалами с большой разницей по Z.
Другое ограничение разрешения, может возникнуть в результате уширения электронного пучка. При изучении изображений, полученных при больших увеличениях во вторичных электронах детектором Э-Т часто можно наблюдать мелкомасштабные детали только на краю образца. Контраст мелких деталей внутри массивного объекта на общем фоне сильно уменьшается за счет больших областей взаимодействия и выхода сигнала. Образуется ситуация, схематически представленная на рис. (Рис.24)

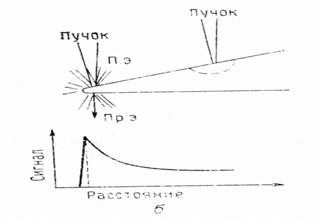
Рис. 24. а) Изображение копировальной бумаги при большом увеличении.
Видны резкие края, но отсутствует внутренняя структура. Энергия пучка 25кэВ; б) Схематическая иллюстрация генерации сигнала при получении изображения.
Электронная микроскопия – единственный прямой метод определения размера непосредственно наблюдаемых частиц. Все другие методы (как-то: дифракционный, магнитный, седиментационный, фотонно-корреляционный, газово-адсорбционный) являются косвенными, т.к. информацию о среднем размере извлекают из данных об изменении какого-либо свойства вещества или параметра процесса.
- При всех достоинствах электронной микроскопии как метода определения размеров частиц не стоит забывать, что это локальный метод, дающий представление о размерах объекта только в поле наблюдения.
- Точность определения параметров решетки, атомных смещений и микронапряжений ниже, чем в рентгеноструктурном анализе.
Методики исследования в РЭМ
Подготовка объектов для исследований. Одно из больших преимуществ растровой электронной микроскопии заключается в том, что многие образцы могут исследоваться практически без предварительной подготовки. РЭМ позволяет исследовать массивные образцы, размер которых ограничен только размером столика образца.
Методические требования к объектам. Образцы должны быть электропроводящими. Для обеспечения их хорошего электрического контакта с предметным столиком и для фиксации образцов при наклоне стола используют специальные токопроводящие клеи.
При исследовании непроводящих ток материалов - диэлектриков на их поверхность наносится напылением тонкая пленка электропроводников - золото, графит и т.д.
Перед испытанием образцы должны быть тщательно очищены, чтобы не загрязнять электронно-оптическую систему и не ухудшать состояние вакуума.
Методы очистки поверхности: промывка растворителями, обезжиривание при ультразвуковой очистке, механическая чистка, снятие реплик, химическое или электрохимическое травление. С целью нанесения наименьших повреждений поверхности образца надо проводить минимально возможную очистку. Обычно на первом этапе используется промывка растворителем, например ацетоном, толуолом или спиртом в ультразвуковом очистителе.
Артефакты: загрязнение поверхности углеродом и другими продуктами разрушения углеводородной пленки под воздействием электронного пучка. Пример: образование так называемого «квадрата растра» загрязнений, наблюдаемого при переходе от больших увеличений к малым. Темный квадрат на изображении появляется при растрескивании слоя углеводородов, созданного при сканировании при более высоком увеличении.
Наличие слоя углеводородов приводит к изменению характеристик вторичной электронной эмиссии.
Методики нанесения проводящих покрытий. Нанесение проводящих покрытий необходимо для увеличения электрической проводимости объектов. Материалы, обладающие сопротивлением выше 1010 Ом·м, будут быстро заряжаться под пучком, что в свою очередь приводит к изменению поверхностного потенциала и к артефактам на изображении. Существует несколько способов нанесения тонкопленочных покрытий.
Термическое напыление основано на испарении моноатомных слоев металлов и некоторых органических диэлектриков при нагреве в вакууме.
Высокие температуры могут быть достигнуты методом резистивного нагрева -нагрев электрическим током. В методе электрической дуги дуга зажигается между двумя электродами, разделенными промежутком в несколько мм, в результате происходит быстрое испарение электрода.
Способ обычно используется для испарения некоторых тугоплавких металлов. Наиболее эффективный метод нагрева для большинства тугоплавких металлов (W, Ta, Mo) – использование электронного пучка.
В этом случае испаряемый металл является анодной мишенью, нагреваемой потоком электронов с катода при 2-3 кВ. Преимущество метода заключается в получении минимальной по размеру зерна структуры. Метод используется также для напыления более легкоплавких материалов, например Cr и Pt.
Методы испарения делятся также на высоковакуумные (10-7 – 10-3 Торр) и низковакуумные.
Образование тонкой пленки начинается с поступления первых атомов на поверхность образца, после миграции и повторного испарения в результате столкновений происходит объединение атомов и начинается образование зародышей критического размера, с последующим их ростом и коалесценцией вплоть до образования сплошной пленки. Чем сильнее связь между адсорбированными атомами, тем выше вероятность образования зародышей и меньше их критический размер. Скорость образования сплошной пленки зависит от материала испарителя и подложки, от температуры, скорости осаждения и топографии поверхности.
При низком вакууме углерод испаряется в атмосфере аргона при давлении около 1 Па. Атомы углерода претерпевают многократные соударения и рассеиваются во всех направлениях. Получаются прочные пленки, используемые в режимах микроанализа, катодной люминесценции и отраженных электронов. Для режима вторичных электронов они не очень пригодны, в частности потому, что коэффициент вторичной эмиссии углерода очень мал.
Катодное распыление. Принцип действия: в процессе распыления высокоэнергетический ион или нейтральный атом бомбардирует поверхность мишени и передает импульс поверхностным атомам мишени, которые затем осаждаются на образце, образуя тонкое покрытие.
Способы катодного распыления: плазменное распыление, радиочастотное распыление, триодное, диодное (при постоянном токе и с охлаждением).
В РЭМ чаще всего используются распыление ионным пучком и диодное распыление. При распылении ионным пучком ионы разгоняются в ионной пушке до энергии 1-30кэВ и бомбардируют мишень, поверхностные атомы вылетают из мишени с энергиями 0-100эВ и затем осаждаются на поверхности образца. При диодном распылении мишень подсоединяется к источнику постоянного тока. Этот способ распыления наиболее простой и экономичный. Установка для распыления при постоянном токе состоит из стеклянного колпака, в котором находится мишень-катод и охлаждаемый водой держатель образца - анод. Последний помещается на контрольном блоке, включающем в себя измеритель вакуума, высоковольтный источник питания, клапан напуска воздуха и небольшое реле времени.
Диодное распыление с охлаждением представляет собой усовершенствованное устройство диодного распыления, в котором в центр мишени помещен постоянный магнит, а вокруг мишени полюсный наконечник, а держатель образца охлаждается специальным модулем, использующим эффект Пельтье. Эти усовершенствования позволяют значительно уменьшить термическое повреждение образца. Этот способ напыления применяется при нанесении покрытия на пластики, на кристаллические углеводородные парафины (Тпл.=3050К).
Материалы мишени в РЭМ – лучше всего Pt, Au, возможно применение Ni, Cr, Cu.
Наиболее удобным является измерение толщины с помощью кварцевого кристалла, смонтированного внутри вакуумной камеры.
Стандартные тест-объекты
Существуют специальные тест-объекты для получения паспортных характеристик прибора. Для РЭМ в качестве тест-объектов чаще всего используются:
Al на углеродной подложке – тест-объект на разрешение;
Cu на углеродной подложке – медная сеточка l=459,2нм - тест объект только на 5кV;
Au на углеродной подложке – тест-объект на разрешение;
Sn на углеродной подложке– тест-объект на разрешение.
При изготовлении эталонов для рентгеноспектрального анализа возможны три подхода:
1) приготовление полной серии эталонов – чаще всего применяется в металловедении и геологии;
2) получение одного эталона для характеристики определенного соединения;
3) получение отдельных эталонов для контроля работы прибора или использования в качестве реперных точек для введения поправок.
Эталоны для РМА должны быть:
- гомогенными на микронном уровне для пространственного разрешения;
- наименее повреждаемые под электронным пучком, например окислы с ковалентными химическими связями.
Основные технические характеристики и технические возможности РЭМ.
При выборе типа микроскопа инженеру-исследователю для оценки эффективности его использования необходимо знание основных технических характеристик прибора.
К основным техническим характеристикам растрового электронного микроскопа относятся:
разрешающая способность,
диапазон увеличений,
ускоряющее напряжение,
диаметр зонда,
глубина фокуса.
Немаловажными также являются:
- размер камеры образца, определяющий возможность одновременного исследования большого количества образцов, или крупных деталей;
- выбор детекторов частиц и дополнительных приставок (например – катодолюминесценции) зависит от конкретных областей применения приобретаемого оборудования;
- наличие хорошего программного обеспечения;
- характеристики вакуумной системы.
Важнейшей характеристикой любого микроскопа является его разрешающая способность. Паспортная разрешающая способность приборов определяется на стандартных тест-объектах. Поскольку уровень контраста объекта влияет на разрешение, тест-объекты представляют собой высококонтрастные образцы, а разрешающая способность, как правило, определяется по расстоянию между краями частиц в тонком слое напыленного металла, чаще всего золота.
Если при высокой контрастности используется тонкий зонд с малым током, то при низкой контрастности объекта приходится увеличивать ток зонда (для увеличения отношения сигнал/шум), а это приводит к увеличению размера зонда, и, соответственно, к ухудшению разрешения. Таким образом, исследователь должен быть готов к тому, что паспортная разрешающая способность реализуется в идеальном случае, а реальное разрешение при работе с конкретным объектом может измеряться в десятках, а иногда и в сотнях нанометров.
Увеличение в РЭМ понимается как отношение размера изображения на экране к размеру области, обегаемой пучком на образце. Это увеличение в современных микроскопах составляет от 10х до 200000х.
Ускоряющее напряжение может меняться в пределах от 0 до 30кВ. Наличие широкого диапазона изменения ускоряющего напряжения необходимо для исследований в различных реж<