ФИЗИЧЕСКИЕ ОСНОВЫ МИКРОЭЛЕКТРОНИКИ
Глава 1. СТРУКТУРА И ФИЗИКО-МЕХАНИЧЕСКИЕ СВОЙСТВА ТВЕРДЫХ ТЕЛ
КРИСТАЛЛИЗАЦИЯ
Величина τ, выражает среднее время, которое частица проводит около положения равновесия:

Рис. 1.1. Зависимость сипы взаимодействия (а) и потенциальной энергии взаимодействия атомов (б)от расстояния между ними:
1— сила притяжения; 2— сила отталкивания; 3— результирующая сила взаимодействия; Ucв — энергия связи

Рис. 1.2. Расположение частиц в жидкостях (а)и твердых кристаллических телах (б); штриховой линией очерчены ячейки, заключающие частицы
Активационный процесс протекает с энергией активации U. Обычно эту энергию записывают так:
 (1.2)
(1.2)
где Ua — энергия активации;
R — универсальная газовая постоянная.
Cтруктура (рис. 1.2, б) является более плотной.
Твердое кристаллическое состоянию описывается заданием кристаллической решетки.
Процесс установления в системе равновесия называется релаксацией, а время, в течение которого равновесие устанавливается, называется временем релаксации τ.
СТРУКТУРА ИДЕАЛЬНЫХ КРИСТАЛЛОВ
Правильное периодически повторяющееся размещение частиц в кристалле можно описать с помощью операции параллельного перемещения, или трансляции. На рис. 1.6, апоказана решетка, полученная трансляцией частицы вдоль трех осей: оси х, оси у, оси z. Векторы а, b, с называются векторами трансляции, абсолютная величина их — периодами трансляции. Параллелепипед, построенный на векторах а, b, с называется элементарной ячейкой кристалла (рис.1.6,б). Вершины называют узлами решетки.
За единицу измерения длины в решетках принимаются отрезки а, b, с;их называют осевыми единицами.

Рис. 1.6 Простая решетка (а)и элементарная ячейка этой решетки (б)

Рис.1.7. Объемно-центрированная (а), гранецентрированная (б) и базоцентрированная (в) ячейки
Наиболее распространенными из них являются объемно-центрированная (ОЦ), гранецентрированная (ГЦ) и базоцентрированная (БЦ) ячейки (рис.1.7).

Рис. 1.9. Обозначение узлов и направлений (а) и плоскостей (б) в кристалле
ЖИДКИЕ КРИСТАЛЛЫ
Некоторые вещества при повышении температуры переходят из твердого состояния в жидкое не сразу, а через состояние, в котором их структура является промежуточной между структурой жидкости и кристалла. В таком состоянии они называются жидкими кристаллами.
Жидкие кристаллы могут образовывать только вещества с сильно вытянутыми негибкими молекулами. Диапазон температур, в пределах которого существует жидкокристаллическая фаза, составляет обычно несколько десятков градусов. Различие во взаимном расположении молекул в кристаллической, жидкокристаллической и жидкой фазах иллюстрируется рис. 1.4. Имеется определенный порядок в направлении молекул, что приводит к анизотропии свойств таких кристаллов (оптических). Замечательным свойством жидких кристаллов, обусловившим их широкое применение в современной электронике для отображения информации, является то, что благодаря низкой вязкости жидких кристаллических тел ориентацию молекул в них можно изменять сравнительно небольшими электрическими полями. Изменение же ориентации молекул приводит к изменению оптических свойств жидкого кристалла. Как видно из рис. 1.4,б, молекулы в кристаллической фазе ориентированы вдоль одного направления не строго, имеются флуктуации в их ориентации. Это приводит к большой оптической микронеоднородности среды и сильному рассеянию света в ней. Достаточно сказать, что рассеяние света типичными жидкими кристаллами примерно в 106 раз больше, чем обычными изотропными жидкостями. Во внешнем электрическом поле все молекулы стремятся выстроиться вдоль или поперек направления поля в зависимости от того, в каком направлении их поляризуемость выше, и пропускание света резко возрастает.
Если молекулы представляют собой не ровные, а слегка закрученные стержни, то они укладываются в спиральные структуры, схематически показанные на рис. 1.11,а. Такая жидкокристаллическая фаза наблюдается в чистом эфире холестерина и поэтому называется холестерической (в отличие от нематической, представленной на рис. 1.12,б).

Рис. 1.11. Схематическое изображение расположения
молекул в кристаллической (а), жидкокристаллической
(нематической) (б) и жидкой (в) фазах


Рис. 1.12. Схема расположения молекул в холестерической (а)
и смектической (б) фазах
Если поместить холестерик между двумя поляроидами, то пропускание света такой системой будет изменяться с приложением к нему разности потенциалов. На этом принципе построены электрические знаковые индикаторы Цвет холестерика резко изменяется с температурой. Это позволяет применять холестерикн для визуального нахождения горячих точек и микросхемах, наблюдения изображения в инфракрасных лучах и т. д.
Очень чувствительными к тепловым и механическим возмущениям оказываются также жидкие кристаллы в так называемой смектической фазе, в которой молекулы распределены слоями с четко определенным периодом (рис. 1.12,б).
Рис. 1.14. Схематическое изображение структуры
кристаллов с ковалентной связью: а — элементы группы IV B;
б —элементы группы V B;
Алмаз, кремний, германий являются элементами IV группы. Поэтому они имеют тетраэдрическую решетку, в которой каждый атом окружен четырьмя ближайшими соседями, как показано на рис. 1.14, а .
ДЕФЕКТЫ РЕАЛЬНЫХ КРИСТАЛЛОВ
Примеси. Твердые тела всегда содержат примеси. Процесс растворения состоит в том, что примесные атомы внедряются в промежутки между атомами кристалла (рис. 1.15, а)или замещают часть этих атомов, размещаясь в узлах решетки (рис. 1.15, б). В первом случае твердый раствор называется раствором внедрения, во втором — раствором замещения. Присутствие чужеродных атомов вызывает искажение решетки.

Рис.1.15. Искажение кристаллической решетки в твердых растворах
внедрения(а)и замещения (б)
Дефекты по Френкелю и по Шоттки. При любой температуре в кристалле атомы, обладающие достаточно высокой энергией, могут удаляться на значительные расстояния от положений равновесия и преодолевать потенциальный барьер (рис. 1.16, а).Процесс сопровождается возникновением вакантного узла и атома в междоузлии. Такого рода дефекты называются дефектами по Френкелю.
При полном испарении атом покидает поверхность кристалла, при частичном испарении он с поверхности переходит в положение над поверхностью (рис. 1.16, б). В поверхностном слое кристалла образуется вакансия. Путем замещения вакансия перемещается внутрь кристалла. Такого рода вакансии называют дефектами по Шоттки.
ДИФФУЗИЯ В ТВЕРДЫХ ТЕЛАХ
Диффузию чужеродных атомов в решетке данного вещества называют гетеродиффузией, или диффузией.

Рис. 1 17. Потенциальный барьер U, отделяющий
Где
 (1.20)
(1.20)
ПОВЕРХНОСТНАЯ ДИФФУЗИЯ.

Рис. 1.21. Схематическое изображение структуры реальной поверхности кристалла:
1 — одиночный собственный атом на поверхности;
2— одиночный чужеродный атом;
3— собственный атом на плоскости ступеньки;
4— то же на краю ступеньки;
5 — то же в углу ступеньки;
6— чужеродный атом в углу ступеньки;
7 — скопление из двух собственных атомов на выступе ступеньки, 8 — то же на поверхности;
9— вакансия;
10— скопление вакансий
ДЕФОРМАЦИОННЫЕ СВОЙСТВА
КРИСТАЛЛИЧЕСКИХ ТЕЛ
На рис. 1.28 показано возникновение и развитие остаточной деформации в кристалле под действием сдвигающей силы. (рис. 1.28, б). После снятия внешней нагрузки одна часть кристалла остается смещенной относительно другой (рис. 1.28, г) .
В кристалле существуют избранные плоскости и направления, по которым протекает процесс скольжения, рис. 1.29.

Рис. 1.28. Деформация кристалла под действием внешней силы: а) -ненапряженный кристалл; б) — упругая деформация,; в) — пластический сдвиг (скольжение), г) —остаточная деформация

Рис. 1.29. Плоскости и направления скольжения
РЕКРИСТАЛЛИЗАЦИЯ
При рекристаллизации возникают и растут новые кристаллы. Происходит изменение микроструктуры образца и переход его из монокристаллического в поликристаллическое состояние.
Подавляющее большинство реальных твердых тел представляют собой поликристаллические агрегаты, состоящие из огромного числа кристалликов, произвольно ориентированных и прочно сросшихся между собой (рис.1.30).

Рис. 1.30. Структура поликристалла
ДИСЛОКАЦИИ
Основным механизмом пластического течения кристаллов является сдвигообразование.

Рис. 1.36. Расположение атомов в плоскости,
Рис.1.37. Образование винтовой дислокации
К оличественная характеристика числа дислокаций– это плотность дислокаций, равная числу дислокационных линий, пересекающих единичную площадку поверхности кристалла.
В наиболее совершенных кристаллах кремния и германия плотность дислокаций равна 102 см‑2.
ЯВЛЕНИЯ УПРОЧНЕНИЯ
Явления упрочнения при введении примесных атомов, при закалке, старении находят широкое практическое применение, позволяя улучшать физико-механические свойства металлов и сплавов.
АДГЕЗИЯ ПЛЕНОК И ПОКРЫТИЙ
Адгезия широко используется в пленочной электронике при нанесении на твердые подложки тонких пленок — металлических, диэлектрических, маскирующих и защитных, в процессах пайки, получении герметичных соединений стекла и металла, при защите полупроводниковых приборов полимерными компаундами, при получении антикоррозионных покрытий, при склеивании тел.
Рис. 2.11. Адгезия между пленкой и поверхностью
При холодной сварке двух пластичных металлов с помощью пуансонов П 1и П 2(рис. 2.12) между поверхностями возникает металлическая связь, обусловливающая адгезию.

Рис.2.12. Образование металлического соединения (зоны схватывания ЗС)между пластичными металлами 1 и 2при сильном сжатии
Металлическая связь возникает также при пайке, когда на свежепротравленную поверхность металла наносится расплавленный припой, хорошо смачивающий эту поверхность.
Спай стекла с металлом.
Для образования прочного герметичного соединения металла со стеклом при высокой температуре происходит частичное растворение окисла металла и вхождение его в качестве компоненты в приповерхностные слои стекла. Это приводит к образованию прочной связи металла со стеклом.

Рис. 2.13. Структура силикатных стекол: а — кремнийкислородные тетраэдры силикатных стекол; б — трехмерная сетка стекла, построенная из кремнийкислородных тетраэдров.
Рис. 2.15. Смачивание поверхности твердого
Тела жидкостью
Если уровень напряжений в пленке достаточно высокий и сама пленка не очень тонкая, то подложка может испытывать коробление, изгибаясь в сторону пленки, когда в ней действуют напряжения растяжения (рис. 2.22, 6), и в противоположную сторону, когда в пленке действуют напряжения сжатия (рис. 2.22, в).

Рис. 2.22. Изгиб подложек под действием внутренних напряжений: б — изгиб подложки под действием напряжений растяжения в пленке; в— изгиб подложки под действием напряжения сжатия в пленке
ПРИМЕРЫ возникновения внутренних напряжений:
- односторонняя металлизация плат,
- одностороннее нанесение защитных пленок (двуокиси кремния на кремнии, защитных полимерных покрытий),
- несимметричная обработка пластин,
- выращивание эпитаксиальных слоев.
Коробление плат и полупроводниковых пластин больших размеров бывает столь сильным, что не позволяет проводить качественно фотолитографию и другие технологические процессы по периметру пластин.
Рис. 3.14. Заполнение квантовых состояний электронами в металле
В соответствии с принципом Паули на каждом уровне могут разместиться два электрона. Если электронный газ содержит N электронов, то последним будет занят уровень с номером N /2. Этот уровень называется УРОВНЕМ ФЕРМИ и обычно обозначается через µ.

Рис. 3.15. График функции распределения
КОЛЕБАНИЯХ РЕШЕТКИ
ОБРАЗОВАНИЕ ЭНЕРГЕТИЧЕСКИХ ЗОН.
Взаимодействие атомов при образовании кристаллической решетки приводит к превращению энергетических уровней свободных атомов в энергетические зоны кристалла.
В системе, состоящей из N изолированных атомов, каждый уровень повторяется N раз. При сближении атомов возникает сильное взаимодействие, которое приводит к образованию энергетической зоны, содержащей N состояний.
Энергетические зоны отделены областями запрещенных энергий — запрещенными зонами Eg (рис. 5.2, а).

Рис. 5.2. Расщепление энергетических уровней и образование энергетических зон в кристалле (а)
В кристаллах с решеткой типа алмаза нижнюю разрешенную заполненную зону называют валентной, верхнюю пустую зону — зоной проводимости.

Рис. 5 4. Кривые, ограничивающие зону проводимости и валентную зону кристалла арсенида галлия
ЭФФЕКТИВНАЯ МАССА ЭЛЕКТРОНА
Под действием внешней силы F электрон в периодическом поле кристалла движется так, как двигался бы свободный электрон, если бы он обладал эффективной массой m*.
СОБСТВЕННЫЕ ПОЛУПРОВОДНИКИ
Химически чистые полупроводники называются собственными полупроводниками. На рис. 5.6,апоказана упрощенная схема зонной структуры собственного полупроводника.
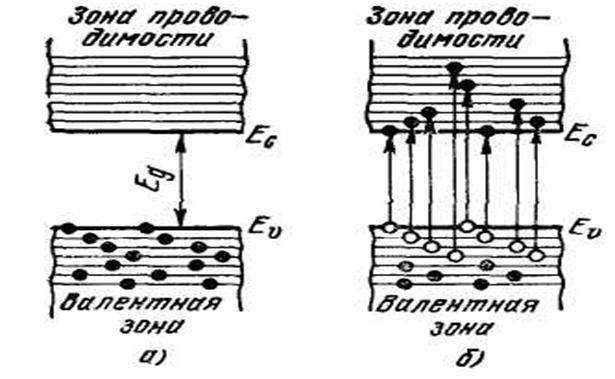
Рис.5.6. Зонная структура собственного полупроводника: Еc — энергия дна зоны проводимости, Ev — энергия потолка валентной зоны.
При абсолютном нуле валентная зона полупроводника заполнена полностью (рис.5.6, а), зона проводимости, расположенная над валентной зоной, является пустой.
При температуре, отличной от абсолютного нуля (рис.5.6, б), часть электронов валентной зоны переходит в зону проводимости. Это приводит к появлению в зоне проводимости носителей заряда электронов; в валентной зоне появляются свободные уровни. Под действием поля электроны валентной зоны имеют возможность переходить на свободные уровни и создавать в кристалле электрический ток. При приложении к кристаллу внешнего поля в нем возникает направленное движение электронов как в зоне проводимости, так и в валентной зоне. Кристалл становится проводящим. Носители заряда в валентной зоне называются дырками.
Рис 5 7 Иллюстрация понятия дырки в валентной зоне
Фиктивным частицам с положительным зарядом + q (называемые дырками), приписывается положительная эффективная масса, численно равная отрицательной эффективной массе электрона.
Рис. 5.8. Возбуждение носителей заряда полупроводниках
а) Т =0 К; б)при Т >0 К ионизация атома пятивалентного элемента приводит к образованию электрона проводимости, в)— энергетические уровни пятых электронов мышьяка, представляющие собой донорные уровни. Эти уровни размещаются непосредственно у дна зоны проводимости на малом расстоянии Ед» 0,01 эВ. При сообщении электронам примесных уровней энергии Ед они переходят в зону проводимости. Неподвижные положительно заряженные ионы в электропроводности не участвуют.
Акцепторные уровни. Если в решетке часть атомов замещена атомами трехвалентного элемента (рис. 5.9, а)., то для образования связи с четырьмя ближайшими соседями не хватает одного электрона. Разорванная связь представляет собой дырку (рис. 5.9, б), так как она соответствует образованию в валентной зоне германия вакантного состояния.
На рис. 5.9, впоказана зонная структура германия, легированного трёхвалентным элементом. У потолка валентной зоны располагаются незаполненные уровни атомов индия. При относительно невысоких температурах электроны из валентной зоны переходят на примесные уровни. Свободными носителями заряда являются «дырки», возникшие в валентной зоне.

Рис. 5 9. Возбуждение носителей заряда в примесных р -полупроводниках: a —Т =0 К; б) — при Т >0 К электроны переходят на неукомплектованные связи примесных атомов, образуя ион индия и незаполненный уровень (дырку) в валентной зоне; в—акцепторные уровни при Т >0 К, дырки в валентной зоне
Глубокие примесные уровни. Некоторые примеси создают в полупроводниках примесные уровни, расположенные далеко от границ энергетических зон. Такие уровни называются глубокими. В кремнии и германии подобные уровни создают атомы золота, меди, марганца, железа и др.
Где
 (6.9)
(6.9)
— эффективное число состояний в валентной зоне.
Собственные полупроводники. В собственных полупроводниках концентрация электронов в зоне проводимости ni равна концентрации дырок в валентной зоне pi,. Приравняем (6.5) И (6.8),

выражение для nвыражение для p
получаем выражение для μ:
 (6.10)
(6.10)
Это соотношение и определяет положение уровня Ферми в собственном полупроводнике, который принято обозначить μ i.
При абсолютном нуле:
 (6.11)
(6.11)
Уровень Ферми в собственном полупроводнике располагается посредине запрещенной зоны (рис. 6.3, кривая 1). С повышением температуры в зависимости от соотношения эффективных масс (6.10) µ смещается вверх (кривая 2, рис.6.3). или вниз (кривая 3,рис. 6.3).

Рис. 6.3. Положение уровня Ферми в собственном полупроводнике и изменение его положения с температурой
В области истощения примеси
n =N д (Ф. 13)
В области низких температур
 (6.20)
(6.20)
 (6.21)
(6.21)
НЕРАВНОВЕСНЫЕ НОСИТЕЛИ
Помимо теплового процесса, возможны и другие способы генерации свободных носителей: под действием света, ионизирующих частиц, инжекции их через контакт. Это приводит к появлению избыточных по сравнению с равновесными носителей.
Концентрация избыточных носителей тогда равна:
 (6.31)
(6.31)
где n 0и р 0— концентрации равновесных носителей.
Скорость генерации и рекомбинации. Каждый неравновесный носитель, возникнув в полупроводнике, «живет» в нем ограниченное время до своей рекомбинации (гибели), поэтому вводят понятие времени жизни неравновесных носителей.
Процесс генерации носителей характеризуют скоростью генерации g, g – число носителей, возникающих в единицу времени в единице объема.
Процесс рекомбинации характеризуют скоростью рекомбинации R, R – число носителей (число пар носителей), рекомбинирующих в единице объема полупроводника в единицу времени.
После выключения света носители будут рекомбинировать и их концентрация будет постепенно уменьшаться. Среднее время жизни избыточных носителей равно времени т, в течение которого их концентрация вследствие рекомбинации уменьшается в е раз.
Свободные носители заряда, диффундируя в объеме полупроводника, за время своей жизни т перемещаются в среднем на расстояние L, которое называют диффузионной длиной носителей. Как показывает расчет, L зависит от т следующим образом:
 (6.40)
(6.40)
Здесь D — коэффициент диффузии носителей, связанный с их подвижностью соотношением Эйнштейна:
 (6.41)
(6.41)
где k — постоянная Больцмана; q — заряд электрона.
На рис. 6 9 показан процесс перехода электрона из зоны проводимости в валентную зону при рекомбинации через всю запрещенную зону Eg, (стрелка 1 на рис. 6.9), или сначала на примесный уровень Ел (стрелка 2), а затем с примесного уровня в валентную зону (стрелка 3). Первый тип рекомбинации называют межзонным, второй - рекомбинацией через примесный уровень.
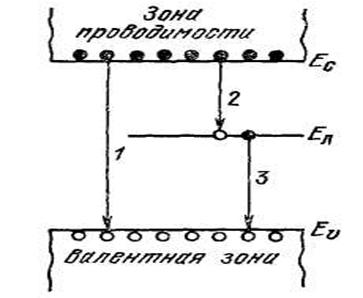
Рис. 6 9. Схема межзонной рекомбинации и рекомбинации через локальный уровень
Для вырожденного газа

 (7.17)
(7.17)
В области высоких температур, когда основное значение имеет рассеяние на тепловых колебаниях решетки, подвижность носителей невырожденного газа обратно пропорциональна Т3/2, подвижность носителей вырожденного газа обратно пропорциональна Т.
В области низких температур основное значение часто имеет рассеяние на ионизированных примесных атомах. Рассеяние состоит в том, что ионы примеси отклоняют электроны, проходящие вблизи них, меняя направление скорости их движения.
Для невырожденного газа
 (7.19)
(7.19)
Для вырожденного газа
 (7.20)
(7.20)
Подвижность носителей заряда в области низких температур, обусловленная рассеянием на ионизированных примесях, пропорциональна Т3/2 для полупроводников с невырожденным газом и не зависит от Т для полупроводников с вырожденным газом.

Рис. 7.5. Температурная зависимость подвижности носителей: с повышением концентрации примеси максимумкривой u(Т) смещается в сторону высоких температур
Рис. 7.6. Зависимость удельного сопротивления чистых металлов от температуры
ЭФФЕКТЫ СИЛЬНОГО ПОЛЯ
Эффекты сильного поля. Пока напряженность электрического поля Е мала среднюю скорость теплового движения электронов <V> можно считать неизменной, подвижность носителей и электропроводность также не зависят от поля, вследствие чего выполняется закон Ома: ток в проводнике пропорционален приложенному напряжению.
Если напряженность электрического поля возрастает настолько сильно, что наступает существенное отклонение от закона Ома, что приводит к уменьшению подвижности с ростом поля, к насыщению дрейфовой скорости свободных носителей заряда

Рис. 7 10 Насыщение дрейфовой скорости электронов и дырок

Рис 7 11. Зонная структура арсенида галлия в направлении [100] (а), и изменение скорости дрейфа электронов с увеличением напряженности электрического поля (б)
В полупроводниках типа AIUBV с ростом поля наблюдается эффект дрейфовой нелинейности. Он был открыт Ганном в арсениде галлия и назван эффектом Ганна.
На ряс. 7.11, а показана энергетическая структура зоны проводимости арсенида галлия с двумя минимумами; второй минимум располагается выше первого на расстоянии 0,36 эВ. В нормальных условиях электроны зоны проводимости размещаются в первом минимуме и обладают подвижностью 0,5 В/м2-с. При приложении к кристаллу внешнего поля электроны приобретают дрейфовую скорость и электроны при энергии (достаточной для перехода в верхний минимум) переходят вверх, где значительно меньшая подвижностью ≈ 0,01 В/м2-с). Такой переход сопровождается резким уменьшением скорости дрейфа .
В импульсном режиме генераторы Ганна работа на частотах свыше 150 ГГц и более, обеспечивая на частотах сантиметрового диапазона мощности до нескольких киловатт в импульсном и нескольких ватт в непрерывном режиме при к. п д. до 30%.
Термоэлектронная ионизация Френкеля. Электрическое поле, созданное в полупроводнике, действуя на электрон, связанный с атомом примеси, понижает потенциальный барьер, удерживающий его около атома. Это приводит к увеличению вероятности перехода электрона в зону проводимости и росту концентрации свободных электронов в полупроводнике в области низких температур. Теория этогф явления, получившего название термоэлектронной ионизации, была развита Я. И. Френкелем.
Ударная ионизация. При разогреве электронного газа в сильном электрическом поле электроны зоны проводимости могут приобрести энергию, достаточную для переброса электронов из валентной зоны в зону проводимости. Концентрация свободных носителей заряда лавинно возрастает. Такой механизм размножения свободных носителей называют ударной ионизацией.
Электростатическая ионизация. В полях высокой напряженности возможен переход электронов из валентной зоны в зону проводимости также путем туннельного просачивания через запрещенную зону называется эффектом Зинера (электростатической ионизацией).
ЯВЛЕНИЕ СВЕРХПРОВОДИМОСТИ
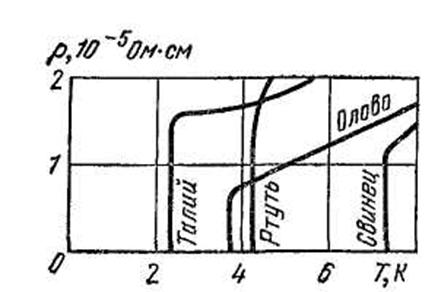
Рис. 7.12. Скачкообразное изменение сопротивления проводников при переходе в сверхпроводящее состояние
Сущность сверхпроводимости состоит в приобретении веществом идеальной проводимости. Из чистых металлов лучшими сверхпроводниками оказались наиболее высокоомные — свинец, ниобий, олово, ртуть и др. Свойства веществ при низких температурах начинают использовать в радиоэлектронике. Возникшая на этой базе новая область называется криоэлектроникой.
РАБОТА ВЫХОДА

ТЕРМОЭЛЕКТРОННАЯ ЭМИССИЯ
При повышении температуры появляются электроны, обладающих кинетической энергией, превышающей высоту потенциального барьера. Такие электроны способны выходить из металла («испаряться»). Поэтому нагретый металл испускает электроны. Это явление получило название термоэлектронной эмиссии. Поместив вблизи нагретого металла проводник и создав между ним и металлом электрическое поле, можно получить термоэлектронный ток.
Плотность тока термоэлектронной эмиссии j равна:
 (8.6)
(8.6)
Соотношение (8.6) называют формулой Ричардсона—Дешмена, а коэффициент А — постоянной Ричардсона. Логарифмируя (8.6), получаем
 (8.8)
(8.8)
График этой функции изображен на рис. 8.6.

Рис. 8.6. Зависимость плотности тока термоэлектронной эмиссии от
Температуры
График представляет собой прямую, по наклону которой можно определить термодинамическую работу выхода Xо. Экстраполируя эту прямую до пересечения с осью ординат, можно найти постоянную Ричардсона А.
Эффект Шоттки. Ускоряющее поле у эмиттирующей поверхности, действуя на электрон, уменьшает потенциальную энергию электрона .
Из рис. 8.8, б видно, что ускоряющее поле понижает потенциальный барьер.


Рис. 8.8. Влияние внешнего поля на высоту и форму
Контактная разность потенциалов может играть большую роль в работе полупроводниковых приборов. Контактные явления лежат также в основе работы многих полупроводниковых и других твердотельных приборов и устройств.
Метод ионного легирования. Сущность метода состоит в том, что поверхностный слой полупроводника данного типа проводимости с помощью ионного пучка легируется примесью, сообщающей этому слою проводимость противоположного знака.
ФИЗИЧЕСКИЕ ОСНОВЫ МИКРОЭЛЕКТРОНИКИ





 (1.2)
(1.2)







 (1.20)
(1.20)










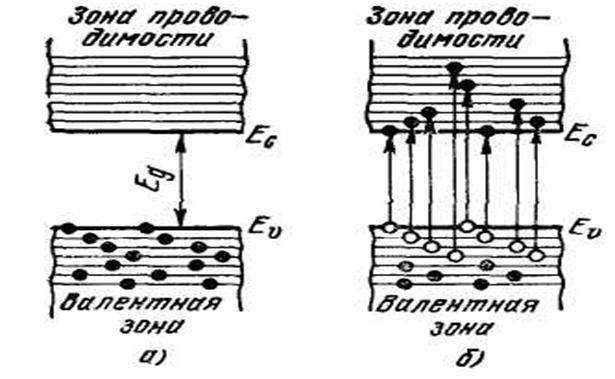

 (6.9)
(6.9)
 (6.10)
(6.10) (6.11)
(6.11)
 (6.20)
(6.20) (6.21)
(6.21) (6.31)
(6.31) (6.40)
(6.40) (6.41)
(6.41)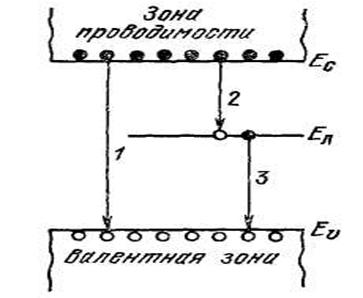

 (7.17)
(7.17) (7.19)
(7.19) (7.20)
(7.20)


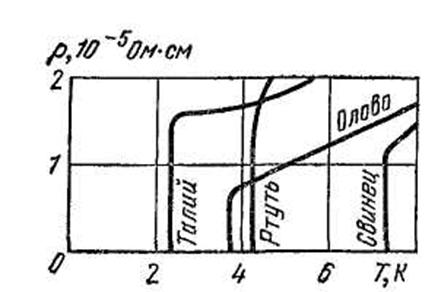

 (8.6)
(8.6) (8.8)
(8.8)




