Электропроводности
Контакт полупроводников с одним типом электропроводности, но с разной удельной проводимостью обозначают как р+-р- или п+-п- переход, причем знаком "+" отмечают область полупроводника с большей концентрацией примесей (рис. 2.43).
Вблизи такого контакта происходят процессы, аналогичные процессам в электронно-дырочном переходе, то есть носители из области с большей концентрацией диффундируют в область с меньшей концентрацией. При диффузии в сильнолегированной области нарушается компенсация заряда ионизированных примесей, а в слаболегированной - создается избыток основных носителей заряда (рис. 2.43, в). Таким образом, на контакте двух полупроводников с одним типом электропроводности, но разной удельной проводимостью также образуется область объемного заряда, диффузионное поле и контактная разность потенциалов. В данном случае в слаболегированной области объемный заряд образован избыточной концентрацией основных носителей заряда.
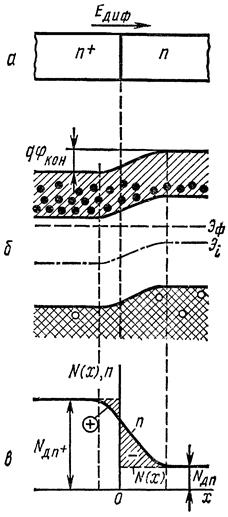
Рис. 2.43. Контакт полупроводников с одним типом
электропроводности: а - структура контакта;
б - энергетическая диаграмма контакта; в - зависимости
концентрации примесей и концентрации носителей заряда
от координаты
Контактная разность потенциалов для таких переходов определяется соотношениями, аналогичными (2.4), то есть для р+-р- перехода
 ; (2.84)
; (2.84)
для п+-п- перехода
 . (2.85)
. (2.85)
Распределение носителей заряда вблизи контакта полупроводников с одним типом электропроводности (рис. 2.43, в) показывает, что в данном случае отсутствует слой с меньшей концентрацией по сравнению с концентрацией носителей в слаболегированной области, то есть отсутствует высокоомный слой. Из-за этого при прохождении тока на таком контакте падает сравнительно небольшое напряжение, высота его потенциального барьера практически не изменяется от величины и направления тока. Следовательно, контакт двух полупроводников с одним типом электропроводности не обладает выпрямляющими свойствами и имеет малое сопротивление по сравнению с сопротивлением слаболегированной области.
Другой особенностью контакта двух полупроводников с одним типом электропроводности является отсутствие инжекции неосновных носителей заряда в слаболегированную высокоомную область. Действительно, если внешнее напряжение приложено плюсом к высокоомной п- области п+-п- перехода, что аналогично прямому включению р-п- перехода, то при этом из п+- области в п- область вводятся электроны, которые являются основными носителями. При противоположной полярности дырочный ток из п+- области в п- область аналогичен обратному току через р-п- переход. Однако из-за ничтожно малой концентрации неосновных носителей заряда в сильнолегированной п+- области инжекция дырок в высокоомную п- область также оказывается ничтожно малой.
Невыпрямляющие и неинжектирующие контакты широко используют в полупроводниковых приборах наряду с выпрямляющими и инжектирующими. Однако из-за существования на контакте полупроводников с одним типом электропроводности потенциального барьера для неосновных носителей заряда, двигающихся из слаболегированной области к контакту, может происходить накопление этих неосновных носителей вблизи контакта при определенной полярности внешнего напряжения (рис. 2.44). При приложении внешнего напряжения оно падает в основном в объеме слаболегированной области. Поэтому только там будет происходить изгиб энергетических уровней и зон, приводящий к образованию потенциальных ям для неосновных носителей заряда. Эффект накопления неосновных носителей заряда и их последующего рассасывания - эффект инерционный. Поэтому он может ухудшать быстродействие полупроводниковых приборов.
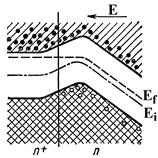
Рис. 2.44. Накопление неосновных носителей заряда (дырок) вблизи контакта двух полупроводников
с электропроводностью п -типа при наличие внешнего
электрического поля
Промежуточное положение между р+-р- или п+-п- и р-п- переходом занимают р- i- или п-i- переходы. Такие переходы образуются между двумя полупроводниками, один из которых имеет электронную или дырочную электропроводность, а другой - собственную.
На рис. 2.45 показаны энергетическая диаграмма и изменение концентраций на границе полупроводников с р- и i- областями. Вследствие разности концентраций носителей заряда в р - и i -областях происходит инжекция дырок из р -области в i- область и электронов из i- области в р -область.
В виду малой величины инжекционной составляющей электронного тока потенциальный барьер на границе перехода создается неподвижными отрицательными ионами акцепторов р -области и избыточными дырками i- области, диффундирующими в нее из р -области. Поскольку ppo >> pi , глубина распространения запирающего слоя в i -области значительно больше, чем в р -области.
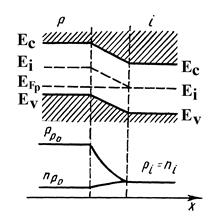
Рис. 2.45. Энергетическая диаграмма р- i -перехода
и изменение концентраций на границе полупроводников
с р -и i -областями
2.3.3. Контакт металл – полупроводник. Барьер Шоттки
В случае контакта металл - полупроводник возможны различные комбинации (p- и n -типы полупроводника) и соотношения термодинамических работ выхода из металла и полупроводника. В зависимости от этих соотношений в области контакта могут реализоваться три состояния. Первое состояние соответствует условию плоских зон в полупроводнике, в этом случае реализуется нейтральный контакт. Второе состояние соответствует условию обогащения приповерхностной области полупроводника (дырками в p ‑типе и электронами в n -типе), в этом случае реализуется омический контакт. И наконец, в третьем состоянии приповерхностная область полупроводника обеднена основными носителями, в этом случае в области контакта со стороны полупроводника формируется область пространственного заряда ионизованных доноров или акцепторов и реализуется блокирующий контакт, или барьер Шоттки.
В полупроводниковых приборах наибольшее применение получили блокирующие контакты металл – полупроводник, или барьеры Шоттки. Рассмотрим условие возникновения барьера Шоттки. Ток термоэлектронной эмиссии с поверхности любого твердого тела определяется уравнением Ричардсона:
 . (2.86)
. (2.86)
где А – постоянная Ричардсона; Ф - термодинамическая работа выхода это энергия Ферми с обратным знаком,  ; Т - температура; k - постоянная Больцмана.
; Т - температура; k - постоянная Больцмана.
Для контакта металл – полупроводник n -типа выберем условие, чтобы термодинамическая работа выхода из полупроводника Ф п/п была меньше, чем термодинамическая работа выхода из металла Ф Ме. В этом случае согласно уравнению (2.86) ток термоэлектронной эмиссии с поверхности полупроводника j п/п будет больше, чем ток термоэлектронной эмиссии с поверхности металла:
 .
.
При контакте таких материалов в начальный момент времени ток из полупроводника в металл будет превышать обратный ток из металла в полупроводник и в приповерхностных областях полупроводника и металла будут накапливаться объемные заряды – отрицательные в металле и положительные в полупроводнике. В области контакта возникнет электрическое поле, в результате чего произойдет изгиб энергетических зон. Вследствие эффекта поля термодинамическая работа выхода на поверхности полупроводника возрастет. Этот процесс будет проходить до тех пор, пока в области контакта не выравняются токи термоэлектронной эмиссии и соответственно значения термодинамических работ выхода на поверхности.
На рис. 2.46 показаны зонные диаграммы различных этапов формирования контакта металл – полупроводник. В условиях равновесия в области контакта токи термоэлектронной эмиссии выравнялись, вследствие эффекта поля возник потенциальный барьер, высота которого равна разности термодинамических работ выхода: j к = Ф Ме – Ф п/п.
Для контакта металл – полупроводник p -типа выберем условие, чтобы термодинамическая работа выхода из полупроводника Ф п/п была больше, чем термодинамическая работа выхода из металла Ф Ме. В этом случае ток термоэлектронной эмиссии с поверхности полупроводника j п/п будет меньше, чем ток термоэлектронной эмиссии с поверхности металла, согласно уравнению (2.86).
При контакте таких материалов в начальный момент времени ток из металла в полупроводник p -типа будет превышать обратный ток из полупроводника в металл и в приповерхностных областях полупроводника и металла будут накапливаться объемные заряды – положительные в металле и отрицательные в полупроводнике.

Рис. 2.46. Зонная диаграмма, иллюстрирующая образование барьера Шоттки
В дальнейшем картина перехода к равновесному состоянию и формирования потенциального барьера для контакта металл – полупроводник p -типа аналогична рассмотренной выше для контакта металл – полупроводник n -типа.
Рассмотрим, как меняется зонная диаграмма контакта металл – полупроводник при приложении внешнего напряжения V G, знак которого соответствует знаку напряжения на металлическом электроде. Величина внешнего напряжения при положительном знаке V G > 0 не должна быть больше контактной разности потенциала D j ms, при отрицательном напряжении V G< 0 она ограничивается только электрическим пробоем структуры. На рис. 2.47 приведены соответствующие зонные диаграммы при положительном и отрицательном напряжениях на металлическом электроде барьеров Шоттки. Из рисунка видно, что роль внешнего напряжения в барьере Шоттки сводится только к регулированию высоты потенциального барьера и величины электрического поля в ОПЗ полупроводника.
Рассмотрим, как меняются электрическое поле и потенциал в области пространственного заряда контакта металл – полупроводник в виде барьера Шоттки. Для определенности будем рассматривать полупроводник n -типа. За знак приложенного напряжения примем знак напряжения, приложенного к металлическому электроду, полупроводниковый электрод считаем заземленным.

Рис. 2.47. Зонная диаграмма барьера Шоттки
при различных напряжениях на затворе:
а - V G = 0; б - V G > 0, прямое смещение; в - V G < 0, обратное смещение
Вне зависимости от полярности напряжения для барьерных структур все внешнее напряжение будет приложено к области пространственного заряда, поскольку в этой области концентрация свободных носителей существенно меньше, чем в других областях барьера Шоттки.
Связь электрического поля и потенциала для любых материалов с пространственно распределенным объемным зарядом описывается уравнением Пуассона. В одномерном приближении это уравнение имеет вид
 , (2.87)
, (2.87)
где y (x)– зависимость потенциала от координаты, r (x) – плотность объемного заряда, e s – диэлектрическая проницаемость полупроводника, e 0 – диэлектрическая постоянная.
Заряд в области пространственного заряда барьера Шоттки для полупроводника n -типа обусловлен зарядом ионизованных доноров с плотностью N D+. Поэтому
 . (2.88)
. (2.88)
При интегрировании уравнения Пуассона учтем, что величина электрического поля  :
:
 , (2.89)
, (2.89)
или
 . (2.90)
. (2.90)
Проведем интегрирование уравнения (2.90). Выберем константу интегрирования из расчета, что при x = W электрическое поле Е равно нулю:
 . (2.91)
. (2.91)
Из соотношения (2.91) следует, что электрическое поле Е максимально на границе металл – полупроводник (x = 0), линейно спадает по области пространственного заряда и равно нулю на границе ОПЗ – квазинейтральный объем полупроводника (x = W).
Для нахождения распределения потенциала (а, следовательно, и зависимости потенциальной энергии от координаты) проинтегрируем еще раз уравнение (2.91) при следующих граничных условиях: x = W, y (W) = 0. Получаем
 . (2.92)
. (2.92)
Максимальное значение потенциала реализуется при x = 0 и составляет
 , при
, при  . (2.93)
. (2.93)
В этом случае можно рассчитать значение ширины обедненной области W, подставляя соотношение (2.93) в (2.92):
 . (2.94)
. (2.94)
Соотношение (2.94) является очень важным для барьерных структур. Это уравнение является универсальным и описывает зависимость ширины обедненной области W от приложенного напряжения V G и концентрации легирующей примеси N D для большинства барьерных структур. На рис. 2.48 приведена диаграмма, иллюстрирующая распределение электрического поля и потенциала в барьере Шоттки при обратном смещении, рассчитанных на основании соотношений (2.91) и (2.92).

Рис. 2.48. Диаграмма, иллюстрирующая распределение электрического поля и потенциала в барьере Шоттки:
а - структура барьера Шоттки при обратном смещении;
б - распределение электрического поля в ОПЗ;
в - распределение потенциала в ОПЗ
Вольт-амперная характеристика барьера Шоттки будет иметь вид
 . (2.95)
. (2.95)
где υ 0 – тепловая скорость электронов,  ; n s – поверхностная концентрация в полупроводнике на границе с металлом
; n s – поверхностная концентрация в полупроводнике на границе с металлом  ; n 0 – равновесная концентрация основных носителей в полупроводнике,
; n 0 – равновесная концентрация основных носителей в полупроводнике,  .
.
На рис. 2.49 приведена вольт-амперная характеристика барьера Шоттки.

Рис. 2.49. Вольт-амперная характеристика барьера Шоттки
Вольт-амперная характеристика барьера Шоттки имеет ярко выраженный несимметричный вид. В области прямых смещений ток экспоненциально сильно растёт с ростом приложенного напряжения. В области обратных смещений ток от напряжения не зависит. В обеих случаях, при прямом и обратном смещении, ток в барьере Шоттки обусловлен основными носителями – электронами. По этой причине диоды на основе барьера Шоттки являются быстродействующими приборами, поскольку в них отсутствуют рекомбинационные и диффузионные процессы. Несимметричность вольт-амперной характеристики барьера Шоттки – типичная для барьерных структур. Зависимость тока от напряжения в таких структурах обусловлена изменением числа носителей, принимающих участие в процессах зарядопереноса. Роль внешнего напряжения заключается в изменении числа электронов, переходящих из одной части барьерной структуры в другую.
Омические контакты
Обязательным элементом каждого прибора является так называемый омический контакт. Он обеспечивает соединение полупроводникового кристалла с внешним выводом. Омический контакт это обычно контакт металл - полупроводник. В случае контакта металла с полупроводником п - типа при условии, что работа выхода металла меньше работы выхода полупроводника (ФМе < Фпп), или же в случае контакта металла с полупроводником р - типа, когда ФМе > Фпп, вблизи границы образуется слой с повышенной концентрацией основных носителей. Такой переход, обладающий повышенной по сравнению с объемом полупроводника удельной проводимостью, называют омическим, так как он не обладает униполярными свойствами. При подключении прямого и обратного напряжения изменяется лишь степень обогащения основными носителями приконтактного слоя.
Для омических контактов характерны следующие особенности:
- близкая к линейной вольт-амперная характеристика. Вольт-амперная характеристика омического контакта должна подчиняться закону Ома I = U/R вне зависимости от полярности приложенного напряжения. Контакт, имеющий линейную вольт-амперную характеристику, не выпрямляет протекающий через него переменный ток, то есть является невыпрямляющим. Таким образом, омический контакт должен иметь линейную и симметричную вольт-амперную характеристику;
- омический контакт должен быть неинжектирующим, то есть через омический контакт должна отсутствовать инжекция неосновных носителей заряда в прилегающую область полупроводника, накопление неосновных носителей в омическом переходе или вблизи него;
- омические контакты должны иметь минимальное электрическое сопротивление, не зависящее от направления и значения тока в рабочем диапазоне токов;
- металл перехода должен обладать высокой электро- и теплопроводностью и температурным коэффициентом расширения (ТКР), близким к ТКР полупроводника;
- омические контакты должны иметь стабильные электрические и механические свойства.
Обычно для создания омического контакта используют следующие металлы: свинец, олово и их сплавы, золото, алюминий.
Создание омических контактов представляет собой довольно сложную задачу. Одним из способов улучшения свойств омического контакта является применение в качестве полупроводника п+-п или р+-р -структуры, то есть в качестве омического контакта необходимо использовать структуру т-п+-п или т-р+-р,где через т обозначен слой металла. Типичная структура омического контакта приведена на рис. 2.50.
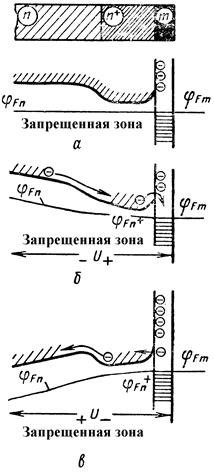
Рис. 2.50. Зонные диаграммы омического контакта:
а - равновесное состояние; б - обратное напряжение;
в - прямое напряжение
Эта структура состоит из двух переходов: т-п+ и п+-п, п+ -слой сильно легирован (порядка 1019 см-3). Поскольку степень легирования п+ -слоя велика и полупроводник вырожден, то толщина ОПЗ между металлом и п+ -полупроводником чрезвычайно мала (2 - 3 нм) и носители заряда беспрепятственно преодолевают барьер за счет туннельного эффекта. п+ -слой имеет удельное сопротивление во много раз меньше, чем удельное сопротивление объема полупроводника. Так как приконтактная область будет характеризоваться высокой концентрацией примесей, инжекция неосновных носителей в ней будет ослаблена.
Оба перехода т-п+ и п+-п не являются инжектирующими и не обладают вентильными свойствами. В целом структура т-п+-п ведет себя как омическое сопротивление при любой полярности напряжения. Рассмотрим механизм протекания токов. Пусть напряжение приложено минусом к п -области, плюсом к металлу. Тогда потенциалы слоев п+ и п повысятся, высота барьера п+-п увеличится, а высота барьера т-п+ уменьшится (рис. 2.50, б). Электроны из слоя п будут свободно переходить в слой п+ независимо от высоты барьера п+-п, а понижение барьера т-п+ обеспечит переход электронов из п+ -слоя в т- слой. Пусть теперь напряжение приложено плюсом к п - области. При этом потенциалы п+ и п слоев понизятся и высота барьера п+-п сделается меньше; соответственно электроны п+ -слоя смогут переходить в п- слой. Барьер т-п+ повысится, но так как он очень тонкий, то электроны слоя т будут проходить его за счет туннельного эффекта, как показано на рис. 2.50, в.
Таким образом, важнейшим свойством омического контакта является его двухсторонняя проводимость.
Другое важное свойство связано с ничтожным временем жизни носителей в п+ -слое, поскольку он сильно легирован и имеет малое удельное сопротивление. Интенсивная рекомбинация в п+ -слое и отсутствие инжекции делают повышение концентрации в области омического контакта редким явлением. Поэтому считают, что концентрация электронов и дырок на омическом контакте имеют равновесные значения.



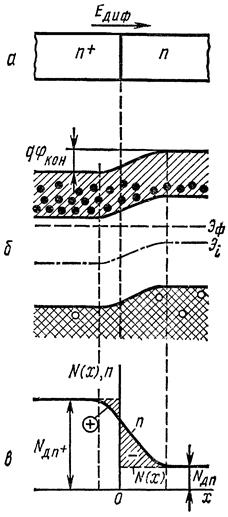
 ; (2.84)
; (2.84) . (2.85)
. (2.85)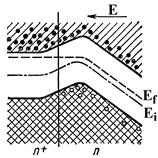
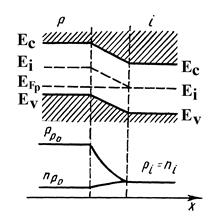
 . (2.86)
. (2.86) ; Т - температура; k - постоянная Больцмана.
; Т - температура; k - постоянная Больцмана. .
.

 , (2.87)
, (2.87) . (2.88)
. (2.88) :
: , (2.89)
, (2.89) . (2.90)
. (2.90) . (2.91)
. (2.91) . (2.92)
. (2.92) , при
, при  . (2.93)
. (2.93) . (2.94)
. (2.94)
 . (2.95)
. (2.95) ; n s – поверхностная концентрация в полупроводнике на границе с металлом
; n s – поверхностная концентрация в полупроводнике на границе с металлом  ; n 0 – равновесная концентрация основных носителей в полупроводнике,
; n 0 – равновесная концентрация основных носителей в полупроводнике,  .
.