

Кормораздатчик мобильный электрифицированный: схема и процесс работы устройства...

Историки об Елизавете Петровне: Елизавета попала между двумя встречными культурными течениями, воспитывалась среди новых европейских веяний и преданий...

Кормораздатчик мобильный электрифицированный: схема и процесс работы устройства...

Историки об Елизавете Петровне: Елизавета попала между двумя встречными культурными течениями, воспитывалась среди новых европейских веяний и преданий...
Топ:
Оснащения врачебно-сестринской бригады.
Проблема типологии научных революций: Глобальные научные революции и типы научной рациональности...
Характеристика АТП и сварочно-жестяницкого участка: Транспорт в настоящее время является одной из важнейших отраслей народного...
Интересное:
Лечение прогрессирующих форм рака: Одним из наиболее важных достижений экспериментальной химиотерапии опухолей, начатой в 60-х и реализованной в 70-х годах, является...
Уполаживание и террасирование склонов: Если глубина оврага более 5 м необходимо устройство берм. Варианты использования оврагов для градостроительных целей...
Мероприятия для защиты от морозного пучения грунтов: Инженерная защита от морозного (криогенного) пучения грунтов необходима для легких малоэтажных зданий и других сооружений...
Дисциплины:
|
из
5.00
|
Заказать работу |
|
|
|
|
3.1. Идеальная структура
металл – диэлектрик – полупроводник
Структуры металл – диэлектрик – полупроводник, или сокращенно МДП-структуры, широким интересом к изучению их физических свойств обязаны появлению планарной технологии и развитию нового класса полупроводниковых приборов, работающих на основе эффекта поля, таких как приборы с зарядовой связью, полевые транзисторы с изолированным затвором, репрограммируемые элементы памяти с плавающим затвором и т.п. МДП-структуры позволяют анализировать основные процессы, протекающие в такого рода приборах, и являются чрезвычайно удобными объектами исследования. Устройство МДП-структуры следует из ее названия.
МДП-структура представляет собой монокристаллическую пластину полупроводника, называемую подложкой, закрытую с планарной стороны диэлектриком. Металлический электрод, нанесенный на диэлектрик, носит название затвора, а сам диэлектрик называется подзатворным. На обратную непланарную сторону полупроводниковой пластины наносится металлический электрод, называющийся омическим контактом. Довольно часто в качестве диэлектрика в МДП-структурах используют окислы, поэтому вместо МДП употребляется название МОП-структура.
Итак, МДП-структура, приведенная на рис. 3.1, состоит из затвора, подзатворного диэлектрика, полупроводниковой подложки и омического контакта.
Рассмотрим зонную энергетическую диаграмму МДП‑структуры при равновесных условиях. Согласно правилу построения зонных диаграмм необходимо, чтобы в системе при отсутствии приложенного напряжения:

Рис. 3.1. Устройство МДП‑структуры:
1 – затвор, 2 – подзатворный диэлектрик;
|
|
3 – полупроводниковая подложка;
4 – омический контакт
а) уровень вакуума был непрерывен;
б) электронное сродство диэлектрика и полупроводника в каждой точке было постоянно;
в) уровень Ферми был одинаков.
На рис. 3.2 приведена построенная таким образом зонная диаграмма для идеальной МДП-структуры. Под идеальной МДП-структурой будем понимать такую систему металл – диэлектрик – полупроводник, когда:
- отсутствуют поверхностные состояния на границе раздела полупроводник – диэлектрик;
- термодинамические работы выхода металла затвора и полупроводника подложки равны между собой;
- отсутствуют заряженные центры в объеме подзатворного диэлектрика;
- сопротивление подзатворного диэлектрика бесконечно велико, так что сквозной ток через него отсутствует при любых напряжениях на затворе.


а б
Рис. 3.2. Зонные диаграммы идеальных МДП-структур при напряжении на затворе V = 0: а – полупроводник п -типа;
б - полупроводник р -типа
МДП-структуры, близкие к идеальным, получают, используя «хлорную» технологию термического выращивания диокида кремния на кремнии, причем для n -Si в качестве материала затвора используется алюминий, а для p -Si - золото.
МДП-структуры, в которых нарушается одно из вышеперечисленных требований, получили название реальных МДП-структур.
Когда к идеальной МДП-структуре приложено напряжение того или другого знака, на полупроводниковой поверхности могут возникнуть три основные ситуации (рис. 3.3). Рассмотрим их сначала для МДП-структуры с полупроводником р -типа. Если к металлическому электроду структуры приложено отрицательное напряжение (V < 0), край валентной зоны у границы с диэлектриком изгибается вверх и приближается к уровню Ферми (рис. 3.3, а). Поскольку в идеальной МДП-структуре сквозной ток равен нулю, уровень Ферми в полупроводнике остается постоянным. Так как концентрация дырок экспоненциально зависит от разности энергий (Е F- Е V),такой изгиб зон приводит к увеличению числа основных носителей (дырок) у поверхности полупроводника. Этот режим называется режимом обогащения(аккумуляции).
|
|
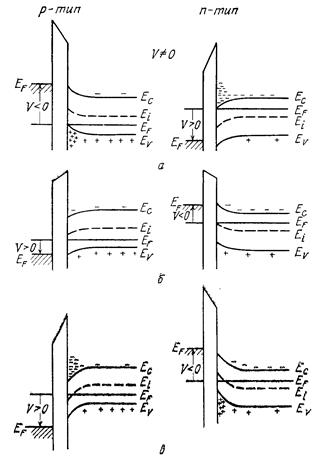
Рис. 3.3. Зонные диаграммы идеальных МДП-структур при напряжении на затворе V ¹ 0: а – режим аккумуляции;
б – режим обеднения; в – режим инверсии
Если к МДП-структуре приложено не слишком большое положительное напряжение (V > 0), зоны изгибаются в обратном направлении и приповерхностная область полупроводника обедняется основными носителями (рис. 3.3, б). Этот режим называют режимом обеднение или истощения поверхности. При больших положительных напряжениях зоны изгибаются вниз настолько сильно, что вблизи поверхности происходит пересечение уровня Ферми Е Fс собственным уровнем Е i. В этом случае (рис. 3.3, в)концентрация неосновных носителей (электронов) у поверхности превосходит концентрацию основных носителей (дырок). Эта ситуация называется режимом инверсии. Аналогичное рассмотрение можно провести и для МДП-структуры с полупроводником п -типа. Указанные режимы осуществляются при напряжении противоположной полярности.
3.2. Область пространственного заряда
в равновесных условиях
Рассмотрим изменение энергетического спектра свободных носителей заряда в приповерхностной области полупроводника под действием внешнего электрического поля. При этом будем считать, что на поверхности полупроводника энергетический спектр при отсутствии внешнего поля точно такой же, как и в объеме, то есть поверхность полупроводника является идеальной, без поверхностных состояний.
Из-за малой концентрации свободных носителей заряда в объеме полупроводника возможно проникновение электрического поля вглубь полупроводника на большие, по сравнению с межатомными, расстояния. Проникшее электрическое поле перераспределяет свободные носители заряда. Это явление получило название эффекта поля. Таким образом, эффект поля – это изменение концентрации свободных носителей в приповерхностной области полупроводника под действием внешнего электрического поля.
Поскольку заряд свободных носителей или ионизованных доноров пространственно распределен в приповерхностной области полупроводника и эта область не является электронейтральной, она получила название область пространственного заряда.
|
|
Отметим, что в случае реализации эффекта поля источником внешнего электрического поля могут быть заряды на металлических пластинах вблизи поверхности полупроводника, заряды на границе и в объеме диэлектрического покрытия и т.д.
Наличие электрического поля E (z) в ОПЗ меняет величину потенциальной энергии электрона в этой области. Если электрическое поле направлено от поверхности вглубь полупроводника, то электроны будут иметь минимальную энергию в этом поле вблизи поверхности, где для них энергетическое положение соответствует наличию потенциальной ямы. Поскольку на дне зоны проводимости кинетическая энергия электронов равна нулю, изменение потенциальной энергии по координате должно изменить точно так же ход дна зоны проводимости, а соответственно и вершины валентной зоны. Этот эффект изображен на зонных диаграммах, приведенных на рис. 3.3, 3.4, и получил название изгиба энергетических зон. Величина разности потенциалов между квазинейтральным объемом и произвольной точкой ОПЗ получила название электростатического потенциала
 . (3.1)
. (3.1)
Значение электростатического потенциала на поверхности полупроводника называется поверхностным потенциалом и обозначается ψ s. На зонной диаграмме (рис. 3.4) величина ψ s отрицательна.
Выразим концентрацию электронов n и дырок p в ОПЗ через электростатический потенциал ψ. В квазинейтральном объеме в невырожденном случае концентрация электронов и дырок имеет вид
 (3.2)
(3.2)
где  ; φ 0 – расстояние от уровня Ферми до середины запрещенной зоны в квазинейтральном объеме. Величины n и p в ОПЗ вычисляются по формулам
; φ 0 – расстояние от уровня Ферми до середины запрещенной зоны в квазинейтральном объеме. Величины n и p в ОПЗ вычисляются по формулам
 (3.3)
(3.3)

Рис. 3.4. Зонная диаграмма приповерхностной области полупроводника n -типа
Величины концентраций электронов n s и дырок p s на поверхности носят название поверхностной концентрации и имеют значения
 (3.4)
(3.4)
В зависимости от направления и величины внешнего электрического поля, типа полупроводниковой подложки различают 4 различных состояния поверхности полупроводника: обогащение, обеднение, слабая инверсия и сильная инверсия. Все эти ситуации отражены на рис. 3.5 для полупроводника n -типа.
|
|
Обогащение – состояние поверхности полупроводника, когда поверхностная концентрация основных носителей больше, чем концентрация основных носителей в нейтральном объеме (см. рис. 3.5, а). В режиме обогащения для полупроводника n -типа: n s > n 0, зоны изогнуты вниз, ψ s > 0; для полупроводника p -типа: p s > p 0, зоны изогнуты вверх, ψ s < 0.
Обеднение – состояние поверхности полупроводника, когда поверхностная концентрация основных носителей меньше, чем концентрация основных носителей в квазинейтральном объеме, но больше, чем поверхностная концентрация неосновных носителей (см. рис. 3.5, б). В режиме обеднения для полупроводника n -типа: p s < n s < n 0, зоны изогнуты вверх, ψ s < 0,  ; для полупроводника p -типа: n s < p s < p 0, зоны изогнуты вниз, ψ s > 0,
; для полупроводника p -типа: n s < p s < p 0, зоны изогнуты вниз, ψ s > 0,  .
.
Переход от состояния обогащения к состоянию обеднения происходит при значении поверхностного потенциала ψ s = 0, получившем название потенциала «плоских» зон. При этом концентрации основных и неосновных носителей на поверхности и в объеме совпадают.

Рис. 3.5. Зонная диаграмма приповерхностной области полупроводника n -типа при различных состояниях поверхности: а - обогащение; б - обеднение; в - слабая инверсия; г - сильная инверсия
Слабая инверсия – состояние поверхности полупроводника, когда поверхностная концентрация неосновных носителей больше, чем поверхностная концентрация основных, но меньше, чем концентрация основных носителей в квазинейтральном объеме (см. рис. 3.5, в). В режиме слабой инверсии для полупроводника n -типа: n s < p s < n 0, зоны изогнуты вверх, ψ s < 0,  ; для полупроводника p -типа: p s < n s < p 0, зоны изогнуты вниз, ψ s > 0,
; для полупроводника p -типа: p s < n s < p 0, зоны изогнуты вниз, ψ s > 0,  .
.
Переход от области обеднения к области слабой инверсии происходит при значении поверхностного потенциала  , соответствующем состоянию поверхности с собственной проводимостью
, соответствующем состоянию поверхности с собственной проводимостью
 .
.
Сильная инверсия – состояние поверхности полупроводника, когда поверхностная концентрация неосновных носителей больше, чем концентрация основных носителей в квазинейтральном объеме (см. рис. 3.5, г). В режиме сильной инверсии для полупроводника n -типа: p s > n 0, зоны изогнуты вверх, ψ s < 0,  ; для полупроводника p -типа: n s > p 0, зоны изогнуты вниз, ψ s > 0,
; для полупроводника p -типа: n s > p 0, зоны изогнуты вниз, ψ s > 0,  .
.
Переход от области слабой инверсии к области сильной инверсии происходит при значении поверхностного потенциала  , получившем название «порогового» потенциала. При этом концентрация неосновных носителей на поверхности равна концентрации основных носителей в объеме полупроводника.
, получившем название «порогового» потенциала. При этом концентрация неосновных носителей на поверхности равна концентрации основных носителей в объеме полупроводника.
|
|
Та область в ОПЗ, где суммарная концентрация свободных носителей электронов и дырок меньше, чем концентрация ионизованной примеси, называется областью обеднения. Область в ОПЗ, где концентрация свободных неосновных носителей больше, чем основных, получила название инверсионного канала.
3.3. Приповерхностная область пространственного заряда
Одной из основных задач при анализе области пространственного заряда полупроводника является нахождение связи между электростатическим потенциалом ψ (z), с одной стороны, и величинами заряда в области пространственного заряда Q s, емкости ОПЗ C s – с другой. Нахождение этой связи основано на решении уравнения Пуассона для ОПЗ.
Уравнение Пуассона для полупроводника p -типа
 . (3.5)
. (3.5)
Величина ρ (z) в общем случае, когда отсутствует ограничение на малость возмущения, принимает значение
 . (3.6)
. (3.6)
В квазинейтральном объеме, где условие электронейтральности выполняется, ρ (z) = 0.
Тогда
 . (3.7)
. (3.7)
Поскольку, как было показано в (3.2 – 3.4),
 ,
,
 ,
,
для ρ (z) в ОПЗ имеем
 . (3.8)
. (3.8)
Подставляя (3.8) в (3.5), имеем для нахождения ψ (z) дифференциальное уравнение
 . (3.9)
. (3.9)
Домножим выражение для дебаевской длины экранирования, которое представлено в главе 2 формулой (2.98), слева и справа на величину  . Тогда левая часть выражения принимает вид
. Тогда левая часть выражения принимает вид
 . (3.10)
. (3.10)
Следовательно,
 . (3.11)
. (3.11)
Проинтегрировав (3.11) от бесконечности до некоторой точки ОПЗ, получаем
 . (3.12)
. (3.12)
Воспользовавшись определением дебаевской длины экранирования L D (2.98), а также соотношением  , получаем
, получаем
 . (3.13)
. (3.13)
Обозначим
 . (3.14)
. (3.14)
Из (3.13) и (3.14) имеем
 . (3.15)
. (3.15)
Соотношение (3.15) называется первым интегралом уравнения Пуассона.
Знак электрического поля выбирается в зависимости от знака поверхностного потенциала. Если ψ s > 0 (обеднение основными носителями или инверсия), поле направлено вглубь полупроводника по оси z и положительно. При ψ s < 0 поле E направлено против оси z и отрицательно.
Величина электрического поля на поверхности
 . (3.16)
. (3.16)
Поскольку согласно теореме Гаусса величина электрического поля на поверхности E s связана определенным образом с плотностью пространственного заряда на единицу площади Q sc, имеем
 . (3.17)
. (3.17)
Выражение (3.17) для заряда в ОПЗ справедливо для любых значений поверхностного потенциала. Однако использование его для конкретных случаев довольно затруднено в силу громоздкости функции F (ψ, φ 0) в виде (3.14). На рис. 3.6 приведено значение заряда в ОПЗ Q sc как функции поверхностного потенциала y s, рассчитанное для конкретного случая.

Рис. 3.6. Зависимость заряда в ОПЗ от поверхностного потенциала y s, рассчитанная для кремния p ‑типа
3.4. Распределение плотности пространственного заряда, электрического поля и потенциала в идеальной
МДП-структуре в режиме сильной инверсии
При смещениях, соответствующих режимам обеднения и инверсии, приложенное напряжение отталкивает дырки от поверхности, образуя обедненный слой, и индуцирует электроны, образующие инверсный слой. Зонная диаграмма идеальной МДП-структуры, с полупроводником р -типа в режиме сильной инверсии имеет вид, приведенный на рис. 3.7, а. На рис. 3.7, б приведено распределение заряда в структуре. Для обеспечения электронейтральности структуры заряд на ее металлическом электроде Q M должен быть равен сумме электронного заряда в инверсном слое Q inv = Q n и заряда ионизированных акцепторов в области обеднения полупроводника:
Q M = Q inv + qN a W = Q inv + Q B = Q S. (3.18)
Все заряды отнесены к единице площади границы раздела, W – толщина обедненного слоя, Q S – полная поверхностная плотность заряда в полупроводнике.
Распределение электрического поля (рис. 3.7, б) потенциала (рис. 3.7, г) соответствуют первому и второму интегралу уравнения Пуассона. Поле на границе между диэлектриком и полупроводником имеет разрыв, вследствие различных значений диэлектрической проницаемости граничащих материалов оно уменьшается от Е i = Q S/ e i до Е S. Напряженность поля в инверсном слое резко уменьшается по мере удаления от поверхности
 (3.19)
(3.19)
В области обеднения электрическое поле межде подложкой и затвором однородное и описывается уравнением Пуассона
 (3.20)
(3.20)
При режиме обеднения в полупроводнике возникает



г
Рис. 3.7. Зонная диаграмма идеальной МДП-структуры (а), и распределение зарядов (в условиях инверсии) (б),
электрического поля (в) и потенциала (г)
ОПЗ, образованная отрицательными ионами акцепторной примеси, толщиной W. Плотность заряда в ОПЗ, отнесенная к единице объема r = - qN a, уравнение Пуассона принимает вид
 (3.21)
(3.21)
Интегрируя (3.21) с граничными условиями j = 0 и d j /d х = 0, при х = W, получаем
 (3.22)
(3.22)
В отсутствии разности работ выхода приложенное напряжение делится между полупроводником и диэлектриком, то есть V = V i + j (х), где V i – падение напряжения на слое диэлектрика; j (х) – падение напряжения в ОПЗ полупроводника. Решение уравнения Пуассона дает
 (3.23)
(3.23)
где j s – поверхностный потенциал на границе раздела полупроводник - диэлектрик.
Падение напряжения на слое диэлектрика
V i = Е i× d =  , (3.24)
, (3.24)
Но с другой стороны сумма зарядов взятых на единицу площади на управляющем электроде (металле) Q M и индуцированного пространственного заряда Q S равна нулю Q M + Q S = 0. Удельная емкость диэлектрика Сi = e i e 0/ d, тогда
V i =  (3.25)
(3.25)
Таким образом, напряжение на металлическом электроде (затворе)
V i =  . (3.26)
. (3.26)
Определим пороговое напряжение считая, что в инверсном слое отсутствуют подвижные носители заряда
 . (3.27)
. (3.27)
Пороговое напряжение – это напряжение на затворе при котором начинается режим сильной инверсии.
3.5. Вольт-фарадные характеристики идеальной
МДП-структуры
3.5.1. Емкость области пространственного заряда
Поскольку полный заряд в ОПЗ Q sc зависит от величины поверхностного потенциала ψ s, то область пространственного заряда обладает определенной емкостью C sc.
Величина C sc, как следует из соотношения (3.17), будет равна
 . (3.28)
. (3.28)
Для того чтобы получить выражения для емкости ОПЗ в различных случаях (обеднение, обогащение, инверсия), можно либо непосредственно воспользоваться (3.28). Напомним, что рассматривается полупроводник p -типа.
Область обогащения (ψ s < 0). Емкость ОПЗ C sc обусловлена емкостью свободных дырок C p:
 . (3.29)
. (3.29)
Область обеднения и слабой инверсии (2 φ 0 > ψ s > 0). Емкость ОПЗ C sc обусловлена емкостью области ионизованных акцепторов C B:
 . (3.30)
. (3.30)
Из соотношения (3.30) следует, что емкость C sc в области обеднения слабо зависит от поверхностного потенциала ψ s, убывая с ростом последнего. Минимальное значение емкости C sc достигается вблизи порогового значения поверхностного потенциала.
Емкость ОПЗ в области обеднения и слабой инверсии эквивалентна емкости плоского конденсатора, заполненного диэлектриком с относительной диэлектрической проницаемостью ε s, пластины которого находятся друг от друга на расстоянии W равном ширине ОПЗ.
Плоские зоны (ψ s = 0). Соотношения (3.29) и (3.30) несправедливы при ψ s → 0, то есть в области плоских зон у поверхности полупроводника. Непосредственная подстановка ψ s = 0 в выражение (3.29) приводит к неопределенности типа «ноль делить на ноль».
Для расчета емкости плоских зон C FB необходимо провести разложение экспоненты в (3.29) в ряд и после предельных переходов имеем
 . (3.31)
. (3.31)
Емкость ОПЗ в плоских зонах эквивалентна емкости плоского конденсатора с обкладками, удаленными на дебаевскую длину экранирования.
Область сильной инверсии (ψ s > 2 φ 0). Емкость ОПЗ C sc обусловлена емкостью свободных электронов C n в инверсионном слое и при достаточно больших значениях поверхностного потенциала  будет равна
будет равна
 . (3.32)
. (3.32)
Из анализа (3.29) и (3.32) следует, что емкости свободных носителей в обогащении и сильной инверсии экспоненциально зависят от поверхностного потенциала ψ s и имеют одинаковые значения, если величину поверхностного потенциала отсчитывать для инверсии от порогового значения ψ s = 2 φ 0.
На рис. 3.8 приведен график зависимости емкости ОПЗ C sc от величины поверхностного потенциала ψ s, рассчитанной по соотношениям (3.29 – 3.32).

Рис. 3.8. Зависимость емкости области
пространственного заряда C sc от поверхностного потенциала, рассчитанная в классическом (сплошная линия) и вырожденном (пунктирная линия) случае
3.5.2. Емкость МДП-структур
Одним из наиболее распространенных методов изучения свойств структур металл – диэлектрик – полупроводник является метод, основанный на анализе зависимости емкости МДП-структуры C МДП от напряжения на затворе V G, так называемый метод вольт-фарадных характеристик (ВФХ) или C - V метод. Для использования этого метода рассмотрим подробно теорию емкости МДП-структур.
Емкость МДП-структуры представляет собой последовательное соединение емкости диэлектрика С i и приповерхностной емкости полупроводника C s

 . (3.33)
. (3.33)
График зависимости емкости МДП-структуры от напряжения на затворе, так называемая вольт-фарадная характеристика МДП-структуры, приведен на рис. 3.9.

Рис. 3.9. Вольт-фарадные характеристики идеальной
МДП-структуры: а – в области низких частот; б – в области высоких частот; в – в режиме глубокого обеднения
Если V < 0 и полупроводниковая подложка имеет p -тип проводимости, то около поверхности полупроводника накапливаются дырки (режим аккумуляции, обогащения). В этом режиме дифференциальная емкость полупроводника существенно больше емкости диэлектрика, поэтому полная емкость структуры близка к величине емкости диэлектрика:
 . (3.34)
. (3.34)
Когда напряжение на затворе меняется в направлении напряжения плоских зон, поверхностное обогащение исчезает и вследствие роста длины Дебая у поверхности емкость начинает уменьшаться.
При переходе МДП-структуры в режим обеднения (V > 0) дырки удаляются от поверхности, образуется ОПЗ и начинает сказываться влияние приповерхностной емкости C s, значение которой зависит от напряжения на затворе. Обедненная область действует как добавочный слой диэлектрика. В этом режиме полная емкость МДП-структуры состоит из последовательно соединенных емкостей диэлектрика и приповерхностной обедненной области полупроводника
 (3.35)
(3.35)
где W – ширина приповерхностного обедненного слоя, которая зависит как от напряжения на затворе, так и концентрации примеси.
Из выражения (3.35) следует, что с увеличением ширины обедненной области полная емкость МДП-структуры уменьшается.
При превышении V значения порогового напряжения в МДП-структуре происходит инверсия проводимости приповерхностного слоя: поверхностная концентрация электронов в инверсионном слое растет экспоненциально с напряжением, а поверхностный потенциал увеличивается пропорционально квадрату толщины обедненной области. После того как значение W достигнет максимальной величины, дальнейшее приращение положительного заряда на затворе будет компенсироваться возрастанием концентрации электронов в канале Появление избыточных электронов обеспечивается достаточно медленной генерацией электронно-дырочных пар в ОПЗ. Поэтому, если к постоянному напряжению на затворе V добавляется малое переменное напряжение dV с высокой частотой, то концентрация носителей в инверсном слое (электронов) не успевает изменяться с частотой переменного напряжения и емкость МДП-структуры остается постоянной (рис. 3.9, кривая б).
Если же частота изменений V низкая, то изменение концентрации носителей в инверсном слое (электронов) успевает следовать за изменением напряжения. Дифференциальная емкость инверсного слоя значительно превышает емкость диэлектрика, поэтому полная емкость МДП-структуры в режиме инверсии резко возрастает, снова приближаясь к емкости диэлектрика (рис. 3.9, кривая а).
Рассмотрим теперь, как меняется емкость МДП-структуры при подаче на затвор импульса напряжения. Пусть в исходном состоянии напряжение на затворе равнялось нулю Если теперь к затвору «скачком» прикладывается положительное напряжение превышающее пороговое, то дырки удаляются от поверхности полупроводника и образуется ОПЗ. Однако инверсии проводимости не происходит, так как инерционный процесс генерации электронов не успевает за изменением напряжения. Вследствие того, что инверсионный слой отсутствует, положительный заряд на металлическом затворе может быть скомпенсирован только ионами акцепторов в ОПЗ. Поэтому толщина ОПЗ увеличивается. Удельная емкость структуры в этом режиме по аналогии с (3 35) равна:
 (3.36)
(3.36)
Фактически в выражении (3.36) отражено сохранение режима обеднения и при напряжениях на затворе, больших порогового. Толщина обедненной области под увеличивается на D W, а значение емкости С s и общей емкости МДП-структуры уменьшается (рис. 3.9, кривая в), при этом зависимость емкости затвора от напряжения на затворе аналогична зависимости барьерной емкости обратно-смещенного р-п- перехода от обратного напряжения.
|
|
|

История создания датчика движения: Первый прибор для обнаружения движения был изобретен немецким физиком Генрихом Герцем...
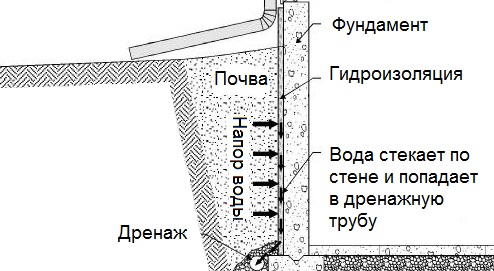
Общие условия выбора системы дренажа: Система дренажа выбирается в зависимости от характера защищаемого...

Своеобразие русской архитектуры: Основной материал – дерево – быстрота постройки, но недолговечность и необходимость деления...

Типы оградительных сооружений в морском порту: По расположению оградительных сооружений в плане различают волноломы, обе оконечности...
© cyberpedia.su 2017-2024 - Не является автором материалов. Исключительное право сохранено за автором текста.
Если вы не хотите, чтобы данный материал был у нас на сайте, перейдите по ссылке: Нарушение авторских прав. Мы поможем в написании вашей работы!