На рис. 3.12 приведена зонная диаграмма и распределение заряда электрического поля и потенциала в МОП-структуре, содержащей как фиксированный заряд, так и заряд, захваченный в окисле. Из сравнения рис. 3.12 и 3.7 следует, что в первом случае те же значения поверхностного потенциала достигаются при меньших напряжениях смещения.

Рис. 3.12. МДП-структура с фиксированным и захваченным в окисле зарядами: а – зонная диаграмма; б – распределение заряда; в – электрическое поле; г - потенциала
Рассмотрим более подробно связь между напряжением на затворе V G МДП-структуры и поверхностным потенциалом ψ s. Все приложенное напряжение V G к МДП-структуре делится между диэлектриком и полупроводником, причем очевидно, что падение напряжения в полупроводнике равняется поверхностному потенциалу ψ s.
Таким образом,
 . (3.38)
. (3.38)
Из (3.38) и анализа зонных энергетических диаграмм на рис. 3.3 следует, что знак поверхностного потенциала ψ s в действительности соответствует знаку напряжения на затворе V G. Действительно, положительное напряжение на затворе идеальной МДП-структуры вызывает изгиб зон вниз у полупроводников n‑ и p ‑типа, что соответствует положительным значениям поверхностного потенциала. Отрицательное напряжение V G вызывает изгиб зон вверх у поверхности полупроводника, что соответствует отрицательному значению поверхностного потенциала ψ s.
Из условия электронейтральности следует, что заряд на металлическом электроде Q M должен быть равен суммарному заряду в ОПЗ Q sc, заряду поверхностных состояний на границе раздела полупроводник-диэлектрик Q ss и встроенному заряду в диэлектрик вблизи границы раздела Q ox. Тогда
 . (3.39)
. (3.39)
Согласно определению геометрической емкости диэлектрика C ox,
 , (3.40)
, (3.40)
отсюда
 . (3.41)
. (3.41)
Учитывая, что между металлом и полупроводником существует разность термодинамических работ выхода Δ φ ms, получаем
 . (3.42)
. (3.42)
Из соотношения (3.42) следует, что если V G > 0, то ψ s > 0, величины Q sc < 0, Q ss < 0, то есть падение напряжения на диэлектрик V ox > 0. Аналогично будет соотношение знаков и при V G < 0. Поскольку
 , (3.43)
, (3.43)
То подставив (3.43) в (3.42), имеем
 . (3.44)
. (3.44)
Введем понятие напряжения плоских зон V FB (Flat Band) для реальной МДП-структуры. Напряжением плоских зон V FB называется напряжение на затворе реальной МДП-структуры, соответствующее значению поверхностного потенциала в полупроводнике, равному нулю:
 . (3.45)
. (3.45)
С учетом определения (3.45) из (3.44) следует
 . (3.46)
. (3.46)
Таким образом, связь между напряжением на затворе V G и поверхностным потенциалом ψ s с учетом (3.46) задается в виде
 . (3.47)
. (3.47)
Введем пороговое напряжение V T как напряжение на затворе V G, когда в равновесных условиях поверхностный потенциал ψ s равен пороговому значению 2 φ 0:
 . (3.48)
. (3.48)
Из (3.46) - (3.48) следует, что
 , (3.49)
, (3.49)
или с учетом определения V FB:
 . (3.50)
. (3.50)
Из (3.50) следует, что если отсчитывать пороговое напряжение V T от напряжения плоских зон V FB, то оно будет состоять из падения напряжения в полупроводнике 2 φ 0 и падения напряжения на подзатворном диэлектрике за счет заряда ионизованных акцепторов и заряда в поверхностных состояниях.
3.8. Определение параметров МДП-структур
на основе анализа C - V характеристик
Анализ вольт-фарадных характеристик позволяет получить обширную информацию об основных параметрах МДП-структур: типе проводимости полупроводниковой подложки (n- или p- тип); концентрации легирующей примеси в подложке и законе ее распределения в приповерхностной области полупроводника; величине и знаке встроенного в диэлектрик МДП‑структуры заряда; толщине подзатворного окисла; плотности поверхностных состояний на границе раздела полупроводник – диэлектрик. Рассмотрим более подробно эти вопросы.
Определение типа проводимости полупроводниковой подложки. Для определения типа проводимости подложки воспользуемся высокочастотной вольт-фарадной характеристикой. Как следует из вида высокочастотной C - V кривой при обогащении основными носителями, емкость МДП-структуры максимальна и определяется емкостью диэлектрика. В инверсии же емкость МДП-структуры минимальна. Таким образом, если максимум емкости C - V кривой лежит в более положительных напряжениях, чем минимум, то подложка изготовлена из полупроводника n ‑типа, если же максимум C - V кривой находится в более отрицательных напряжениях, то подложка изготовлена из полупроводника p -типа. На рис. 3.13 приведены для примера высокочастотные ВФХ на n- и p -типах подложки.
Определение толщины подзатворного диэлектрика. Поскольку, как было показано ранее, в обогащении емкость МДП‑структуры определяется только геометрической емкостью диэлектрика C ox, то
 , (3.51)
, (3.51)

Рис. 3.13. Высокочастотные ВАХ МДП-структур, изготовленных на полупроводниковых подложках n - и p -типа
где ε ox – относительная диэлектрическая проницаемость окисла.
Отсюда следует, что
 , (3.52)
, (3.52)
где C ox – удельная емкость подзатворного диэлектрика, то есть емкость на единицу площади.
Для подстановки в (3.52) экспериментальных значений необходимо сначала пронормировать емкость, то есть разделить экспериментальное значение емкости на площадь S МДП-структуры. При напряжениях на затворе V G – V FB» (2 -3) В практически для всех МДП-структур полная емкость C только на 2 - 3 % отличается от емкости диэлектрика. Исключение составляют структуры со сверхтонким окислом d ox < 100 Å, у которых в этой области V G становится существенным квантование в ОПЗ, и это отличие может достигать 10 %.
Определение величины и профиля концентрации легирующей примеси. Для определения величины концентрации легирующей примеси воспользуемся следующим свойством высокочастотных C - V характеристик МДП-структур: их емкость в области инверсии достигает минимальной величины C min и определяется только емкостью области ионизованных доноров C B и емкостью диэлектрика C ox. При этом
 . (3.53)
. (3.53)
Используя для емкости окисла C ox выражение (3.51) и для емкости области ионизованных акцепторов из (3.30), получаем
 . (3.54)
. (3.54)
Выражение (3.54) совместно с (3.30) для емкости ОПЗ ионизованных акцепторов приводит к выражению для концентрации легирующей примеси:
 . (3.55)
. (3.55)
На рис. 3.14 приведена номограмма зависимости нормированной величины емкости  от толщины d ox для систем Si - SiO2 с концентрацией легирующей примеси N A в качестве параметра.
от толщины d ox для систем Si - SiO2 с концентрацией легирующей примеси N A в качестве параметра.

Рис. 3.14. Зависимость нормированной величины емкости  в минимуме высокочастотной ВАХ от толщины подзатворного диэлектрика d ox при различных величинах концентрации легирующей примеси для кремниевых
в минимуме высокочастотной ВАХ от толщины подзатворного диэлектрика d ox при различных величинах концентрации легирующей примеси для кремниевых
МДП-структур
Из рис. 3.14 видно, что чем меньше толщина диэлектрика и ниже концентрация легирующей примеси, тем больше перепад емкости от минимального до максимального значений наблюдается на ВФХ. Для определения профиля концентрации N A от расстояния вглубь полупроводника z воспользуемся высокочастотной C - V кривой, снятой в области неравновесного обеднения. Неравновесное обеднение возможно реализовать в том случае, когда период напряжения развертки меньше постоянной τ генерационного времени неосновных носителей в ОПЗ. В этом случае величина поверхностного потенциала может быть больше ψ s > 2 φ 0, а ширина ОПЗ соответственно больше, чем ширина ОПЗ в равновесном случае. Возьмем также МДП-структуру с достаточно тонким окислом, таким, чтобы падением напряжения на окисле V ox можно было бы пренебречь по сравнению с величиной поверхностного потенциала, т.е. V ox << ψ s; V G ≈ ψ s. В этом случае тангенс угла наклона зависимости C-2 = f(VG) определит величину концентрации N A:
 (3.56)
(3.56)
Значение координаты z, которой соответствует рассчитанная величина N A, определяется при подстановке значения ψ s= V G в выражение для ширины ОПЗ:
 . (3.57)
. (3.57)
В предельном случае, когда толщина окисла  , эту величину используют, измеряя неравновесную емкость как емкость барьеров Шоттки при обратном смещении.
, эту величину используют, измеряя неравновесную емкость как емкость барьеров Шоттки при обратном смещении.
Определение величины и знака встроенного заряда. Для определения величины и знака встроенного в диэлектрик МДП‑структуры заряда обычно пользуются высокочастотным методом ВФХ. Для этого, зная толщину подзатворного диэлектрика d ox, концентрацию легирующей примеси N A и работу выхода материала затвора, рассчитывают согласно (3.33) и (3.37) теоретическое значение емкости плоских зон C FB МДП-структуры и напряжения плоских зон V FB = Δ φ ms. Поскольку экспериментальная C - V кривая высокочастотная, т.е.  , то, проводя сечение C = const = C FB (теор.), мы получаем при пересечении этой кривой с экспериментальной ВФХ напряжение, соответствующее ψ s = 0, т.е. экспериментальное напряжение плоских зон V FB (эксп.). При этом, согласно (3.46),
, то, проводя сечение C = const = C FB (теор.), мы получаем при пересечении этой кривой с экспериментальной ВФХ напряжение, соответствующее ψ s = 0, т.е. экспериментальное напряжение плоских зон V FB (эксп.). При этом, согласно (3.46),
 . (3.58)
. (3.58)
Если Q ox, Q ss > 0, то V FB (эксп.) > V FB (теор.), и наоборот, если Q ox, Q ss < 0, то V FB (эксп.) < V FB (теор.).
Таким образом, знак и величина суммарного заряда в плоских зонах определяются соотношением (3.58) однозначно. Для вычленения заряда в поверхностных состояниях воспользуемся тем, что он обусловлен основными носителями (p ‑тип, Q ss(ψ s = 0) > 0 и n ‑тип, Q ss(ψ s = 0) < 0), захваченными на поверхностные состояния. Зная величину N ss, можно рассчитать величину заряда в поверностных состояниях Q ss и таким образом из (3.46) определить величину и знак встроенного в диэлектрик заряда Q ox.
4. Полупроводниковые диоды
Полупроводниковым диодом называют нелинейный электронный прибор с двумя выводами. В зависимости от внутренней структуры, типа, количества и уровня легирования внутренних элементов диода и вольт-амперной характеристики свойства полупроводниковых диодов бывают различными.
Полупроводниковые диоды могут отличаться друг от друга, например, по следующим признакам:
а) по применяемым исходным материалам (германиевые, кремниевые, на арсениде галлия и др.);
б) по структуре перехода (точечные и плоскостные);
в) по технологии изготовления (сплавные, диффузионные, эпитаксиальные и др.);
г) по функциональному назначению (выпрямительные, детекторные, импульсные и т. д.);
д) по частотному диапазону (низкочастотные, высокочастотные и сверхвысокочастотные);
е) по мощности рассеяния (маломощные, средней мощности и мощные);
ж) по конструктивному оформлению (стеклянные, металлические, металлокерамические, пластмассовые).
Методы изготовления
Полупроводниковых диодов
В точечных диодах p-n- переходы образуются точечно-контактным способом. Например, к пластине германия, напаянной с помощью олова на кристаллодержатель, подводят и прижимают заостренную иглу из бериллиевой бронзы (рис. 4.1). Диаметр острия порядка 20 – 50 мкм. В месте соприкосновения иглы с полупроводником образуется выпрямляющий переход. Для улучшения его свойств через контакт иглы с германием пропускают мощные короткие импульсы тока, при этом конец иглы сплавляется с полупроводником, обеспечивая стабильность и механическую прочность контакта. Одновременно при повышенной температуре медь диффундирует внутрь германия, образуя под контактной иглой полусферическую область p- типа, так как медь в германии является акцепторной примесью. Для увеличения концентрации акцепторной примеси в p- области зачастую на конец иглы перед прижатием наносят индий или алюминий.
Таким образом, p-n- переход образуется в результате диффузии примеси из иглы и возникновения под иглой p- области в германии n- типа. Точечные диоды имеют очень маленькую емкость, так как площадь p-n- перехода небольшая, поэтому их используют главным образом при изготовлении диодов высокой и сверхвысокой частоты.
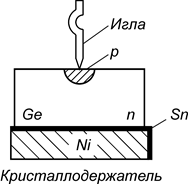
Рис. 4.1. Структура точечного диода
В плоскостных диодах, у которых линейные размеры перехода, определяющие его площадь, значительно больше толщины, p-n- переходы получают методами сплавления, диффузии, эпитаксии, ионной имплантации.
Сплавные переходы (отсюда и название сплавные диоды) получают вплавлением примеси в монокристалл полупроводника. Например, небольшая таблетка алюминия помещается на поверхность пластины кремния п- типа, имеющего ориентацию <111>. Затем пластину с таблеткой нагревают до температуры несколько ниже температуры плавления алюминия, но достаточной для образования эвтектики Al–Si (приблизительно 580 oС), в результате чего образуется небольшая область расплава Al–Si. При остывании на границе расплава кристаллизуется тонкий слой кремния, сильно легированный алюминием, т.е. слой с проводимостью p- типа (р +) на кристалле n- типа (рис. 4.2).

Рис. 4.2. Схема изготовления сплавного перехода
Верхняя часть алюминиевой таблетки используется в качестве омического контакта к области p- типа. На обратную поверхность кристалла напыляют сплав золото-сурьма, содержащий около 0,1 % сурьмы, и вплавляют его при температуре около 400 °С для создания невыпрямляющего омического контакта с кремнием n- типа.
Сплавные p-n- переходы получаются несимметричными, т.е. рр >> nn, поэтому у такого диода дырочная составляющая тока диффузии значительно больше электронной составляющей:
 . (4.1)
. (4.1)
Область p-n- перехода с большой концентрацией основных носителей заряда называют эмиттером, а область с меньшей концентрацией основных носителей, в которую инжектируются неосновные носители для этой области носителей заряда, – базой.
Сплавные резкие переходы имеют значительно большую площадь, чем точечные, соответственно их емкость много больше.
При изготовлении плоскостного диффузионного перехода применяют различные методы, в основе каждого из них – диффузия примесного вещества (донорного или акцепторного) в исходную полупроводниковую пластину p- или n- типа (соответственно) при больших температурах (более 1000 oС). При этом концентрация введенной в поверхностный слой примеси уменьшается с глубиной, поэтому p-n- переход получается плавным.
Глубина диффузии примеси в кристалле зависит от температуры и времени проведения диффузии, поэтому ее легко контролировать.
С целью получения меньшего разброса параметров при изготовлении диодов в едином технологическом цикле методом дополнительного травления уменьшают площадь диффузионной области, т. е. создают так называемый меза-переход (в переводе с испанского выступ, столик) (рис. 4.3, а).
Планарные переходы получили свое название потому, что p-n- переходы диодных структур (также это относится и к транзисторным структурам) и контакты ко всем областям расположены на одной плоскости полупроводникового кристалла. Схематично последовательность операций при получении планарных переходов показана на рис. 4.3, б. Нагревая пластину кремния в потоке кислорода, получают на ее поверхности слой диоксида кремния необходимой толщины (обычно в пределах 0,5 – 1,2 мкм).
Затем методом фотолитографии селективно удаляют оксидный слой и в свободные от SiO2 «окна» проводят диффузию примеси (например, атомов бора), получают p-n- переход. Применяя вновь метод фотолитографии, травлением удаляют SiO2 с участков кремния n- и p- типов для создания омических контактов к этим областям методом напыления алюминия.

Рис. 4.3. Основные диффузионные методы изготовления
p-n- переходов: а - диффузионный меза-переход;
б - диффузионный планарный переход;
в - диффузионный планарный переход
на эпитаксиальной подложке
Эпитаксиальные структуры обычно используется в планарной технологии для уменьшения последовательного сопротивления. На поверхности сильно легированного низкоомного кремния выращивается слабо легированный высокоомный эпитаксиальный слой. И далее технология получения диффузионного перехода (рис. 4.3, в) аналогична предыдущему методу.
Методом эпитаксии можно получить плоскостный диод непосредственно без использования процесса диффузии. На полупроводниковую пластину кремния p- типа наращивают кристаллический слой, называемый эпитаксиальным с донорной примесью, в результате чего получают резкий p-n- переход. Наращивание эпитаксиального слоя проводится из паровой фазы на поверхность монокристаллического полупроводника, при этом кристаллографическая решетка эпитаксиальной пленки продолжает ориентацию решетки исходной пластины – подложки.
Эпитаксиальные диоды обычно имеют малое падение напряжения в открытом состоянии и высокое пробивное напряжение.
Выпрямительные диоды
Выпрямительными называют диоды, предназначенные для выпрямления переменного тока. Основу выпрямительного диода составляет обычный электронно-дырочный переход. Вольт-амперная характеристика такого диода, приведенная на рис. 4.4, а, имеет ярко выраженную нелинейность и описывается уравнением
 . (4.2)
. (4.2)
В прямом смещении ток диода инжекционный, большой по величине и представляет собой диффузионную компоненту тока основных носителей. При обратном смещении ток диода маленький по величине и представляет собой дрейфовую компоненту тока неосновных носителей. В состоянии равновесия суммарный ток, обусловленный диффузионными и дрейфовыми токами электронов и дырок, равен нулю:
 . (4.3)
. (4.3)

Рис. 4.4. Выпрямительный диод:
а – вольт-амперная характеристика;
б - конструкция корпуса
В качестве полупроводниковых материалов для выпрямительных диодов используют германий и кремний. В выпрямительных диодах используются плоскостные несимметричные p-n- переходы, причем для германиевых диодов они создаются главным образом сплавным способом, а для кремниевых – сплавным и диффузионным. Для выпрямительных диодов характерно, что они имеют малые сопротивления в проводящем состоянии, поэтому позволяют пропускать большие токи. Так как площадь p-n- перехода большая, то барьерная емкость этих диодов будет большой, достигая значений десятков пикофарад.
Вольт-амперные характеристики германиевых и кремниевых диодов одинаковой конструкции различаются между собой. На рис. 4.5 для сравнения показаны характеристики германиевого (рис. 4.5, а) и кремниевого (рис. 4.5, б) диодов, имеющих одинаковую конструкцию и предназначенных для работы в одном и том же диапазоне токов и напряжений. Поскольку ширина запрещенной зоны у кремния больше, чем у германия, то обратный ток кремниевых диодов значительно меньше. Кроме того, обратная ветвь характеристики кремниевых диодов не имеет явно выраженного участка насыщения, что обусловлено генерацией носителей зарядов в р - п -переходе и токами утечки по поверхности кристалла.

Рис. 4.5. Вольт-амперные характеристики выпрямительных диодов
Вследствие большого обратного тока у германиевых диодов наступает тепловой пробой, приводящий к разрушению кристалла. У кремниевых диодов из-за малого обратного тока вероятность теплового пробоя мала, и у них возникает электрический пробой.
Поскольку прямой ток диода определяется из уравнения I пр = Is [exp(U пр / j Т) – 1], вследствие меньшего значения обратного тока кремниевого диода его прямой ток, равный току германиевого диода, достигается при большем значении прямого напряжения. Поэтому мощность, рассеиваемая при одинаковых токах, в германиевых диодах меньше, чем в кремниевых.
На характеристики диодов существенное влияние оказывает температура окружающей среды. С ростом температуры становится интенсивнее генерация носителей зарядов и увеличиваются обратный и прямой токи диода.
Для приближенной оценки можно считать, что с увеличением температуры на 10 °С обратный ток германиевых диодов возрастает в два, а кремниевых – в два с половиной раза. Однако вследствие того, что при комнатной температуре обратный ток у германиевого диода значительно больше, чем у кремниевого, абсолютное значение приращения обратного тока у германиевого диода с ростом температуры оказывается в несколько раз больше, чем у кремниевого. Это приводит к увеличению потребляемой диодом мощности, его разогреву и уменьшению напряжения теплового пробоя. У кремниевых диодов из-за малого обратного тока вероятность теплового пробоя мала, и у них вначале возникает электрический пробой.
Пробой кремниевых диодов определяется процессами лавинного умножения носителей зарядов при ионизации атомов кристаллической решетки. С повышением температуры увеличивается тепловое рассеивание подвижных носителей зарядов и уменьшается длина их свободного пробега. Для того, чтобы электрон на меньшем пути приобрел энергию, достаточную для ионизации, необходимо увеличение ускоряющего поля, что достигается при большем обратном напряжении. Это объясняет увеличение пробивного напряжения кремниевых диодов с ростом температуры.
Полупроводниковые выпрямительные диоды обычно характеризуются следующими основными параметрами:
- постоянный обратный ток Iобр (мкА; мА) при некоторой величине постоянного обратного напряжения Uобр;
- постоянное прямое напряжение при постоянном прямом токе Iпр (мА; А).
При серийном выпуске выпрямительных диодов в технических условиях на них указываются средние значения параметров: Iобр. ср. при Uобр. ампл. макс. и Uпр. ср. при Iпр. ср. макс..
В технических условиях на выпрямительные диоды приводятся предельно допустимые электрические режимы эксплуатации: максимально-допустимое амплитудное значение обратного напряжения Uобр. макс. (В), средний прямой ток Iпр. ср. (А).
Для анализа приборных характеристик выпрямительного диода важными также являются такие дифференциальные параметры, как коэффициент выпрямления, характеристические сопротивления и емкости диода в зависимости от выбора рабочей точки.
Различают два вида характеристического сопротивления диодов: дифференциальное сопротивление r D и сопротивление по постоянному току R D.
Дифференциальное сопротивление определяется как
 . (4.4)
. (4.4)
На прямом участке вольт-амперной характеристики диода дифференциальное сопротивление r D невелико и составляет значение несколько Ом. Действительно, при значении прямого тока диода I = 25 мА и значении теплового потенциала kT/ q = 25 мВ величина дифференциального сопротивления r D будет равна r D = 1 Ом. На обратном участке вольт-амперной характеристики диода дифференциальное сопротивление r D стремится к бесконечности, поскольку в идеальных диодах при обратном смещении ток не зависит от напряжения.
Сопротивление по постоянному току R D определяется как отношение приложенного напряжения V G к протекающему току I через диод:
 . (4.5)
. (4.5)
На прямом участке вольт-амперной характеристики сопротивление по постоянному току больше, чем дифференциальное сопротивление R D > r D, а на обратном участке – меньше R D < r D.
В точке вблизи нулевого значения напряжения V G << kT / q значения сопротивления по постоянному току и дифференциального сопротивления совпадают. Действительно, разложив экспоненту в ряд в соотношении (4.5), получаем
 . (4.6)
. (4.6)
Используя характерное значение для обратного тока диода I 0 = 25 мкА, получаем величину сопротивления диода в нулевой точке R D0 = r D0 = 1 кОм. На рис. 4.6, а приведена зависимость дифференциального сопротивления диода ГД402 от величины тока при прямом смещении.
С учетом полученных дифференциальных параметров можно построить эквивалентную малосигнальную схему диода для низких частот (рис. 4.6, в). В этом случае наряду с уже описанными элементами – дифференциальным сопротивлением (рис. 4.6, а) и емкостями диода (рис. 4.6, б) ‑ необходимо учесть омическое сопротивление квазинейтрального объема базы (r об) диода. Сопротивление квазинейтрального объема эмиттера можно не учитывать, поскольку в диодах эмиттер обычно легирован существенно более сильно, чем база.

Рис. 4.6. Приборные характеристики и эквивалентная малосигнальная схема для выпрямительных диодов:
а - зависимость дифференциального сопротивления
диода от величины тока при прямом смещении;
б - зависимость емкости диода от обратного напряжения;
в - эквивалентная малосигнальная схема диода
для низких частот
На рис. 4.7 приведена схема, иллюстрирующая выпрямление переменного тока в диоде.

Рис. 4.7. Схема, иллюстрирующая выпрямление
переменного тока с помощью диода
Рассмотрим, каков будет коэффициент выпрямления идеального диода на основе p- n -перехода. Для этого рассчитаем по уравнению (4.2) коэффициент выпрямления К как отношение прямого тока к обратному току диода. Получаем
 . (4.7)
. (4.7)
Как следует из соотношения (4.7), при значениях переменного напряжения, модуль которого V G меньше, чем тепловой потенциал kT/ q, полупроводниковый диод не выпрямляет переменный ток. Коэффициент выпрямления достигает приемлемых величин при значениях V G по крайней мере в 4 раза больших, чем тепловой потенциал kT / q, что при комнатной температуре Т = 300 К соответствует значению напряжения V G = ± 0,1 В.
4.3. Варикапы
Ранее указывалось, что ширина p-n- перехода и его емкость зависят от приложенного к нему напряжения.
Варикап – это полупроводниковый диод, который используется в качестве электрически управляемой емкости.
В варикапах используется свойство барьерной емкости обратно-смещенного p-n- перехода изменять свою величину в зависимости от приложенного к нему напряжения.
Барьерная емкость p-n- перехода равна емкости плоского конденсатора:
 , (4.8)
, (4.8)
где S – площадь p-n- перехода; Xn – ширина области объемных зарядов.
С увеличением величины обратного напряжения Uобр на p-n- переходе его барьерная емкость Сб уменьшается. Характер изменения Сб в зависимости от приложенного к p-n- переходу напряжения Uобр показан на рис. 4.8. Функциональная зависимость емкости варикапа от напряжения определяется профилем легирования базы варикапа. В случае однородного легирования емкость обратно пропорциональна корню из приложенного напряжения. Задавая профиль легированияв базе варикапа N D(x), можно получить различные зависимости емкости варикапа от напряжения C (U) – линейно убывающие, экспоненциально убывающие. Емкость варикапа меняется в широких пределах и его значение при обратном приложенном напряжении U определяют из выражения
 , (4.9)
, (4.9)
где Св (0) – емкость при U = 0; jк – значение контактной разности потенциалов равное
 , (4.10)
, (4.10)
n = 2 для резких переходов и n = 3 для плавных переходов.
Варикапы изготовляют на основе германия, кремния, арсенида галлия.

Рис. 4.8. Зависимость емкости варикапа
от напряжения смещения
Основные параметры варикапа: номинальная (начальная) емкость Сном; добротность Qв, коэффициент перекрытия по емкости Кс и температурный коэффициент емкости (ТКЕ) aСв.
Номинальная емкость варикапа Сном – барьерная емкость p-n- перехода при заданном напряжении смещения и составляет от долей пФ до сотен пФ.
Коэффициент перекрытия по емкости Кс – отношение емкости варикапа при двух заданных значениях обратных напряжений:
 . (4.11)
. (4.11)
Смакс ограничивается емкостью при U = 0, т.е. С (0). Смин ограничивается обратным допустимым напряжением. Кс позволяет определить величину изменения емкости в диапазоне рабочих напряжений от Uмин до Uмакс (Uмакс по абсолютной величине может достигать 200 В). Характерные значения Кс составляют 2 – 20, причем если плавные и резкие p-n- переходы имеют обычно Кс £ 4, то в случае сверхрезких p-n- переходов Кс имеют большие значения.
Добротность Qв – отношение реактивного сопротивления варикапа на заданной частоте переменного сигнала Хс к сопротивлению потерь при заданном значении емкости или обратного напряжения. Qв измеряют обычно при тех же обратных напряжениях, что и емкость варикапа. Как правило, варикапы работают в диапазоне высоких и сверхвысоких частот (f > 1 МГц), для которых
 , (4.12)
, (4.12)
где r – последовательное (по отношению к С) сопротивление диода, включающее сопротивление потерь в объеме кристалла полупроводника, сопротивление контакта и элементов конструкции. В настоящее время достигнуты значения Qв > 500 на
f = 50 МГц при С = 70 пФ.
Температурный коэффициент емкости (ТКЕ) aСв – отношение относительного изменения емкости к вызывающему его абсолютному изменению температуры окружающей среды, т.е., другими словами относительное изменение емкости при изменении температуры окружающей среды на 1 градус:
 . (4.13)
. (4.13)
Для кремниевых варикапов с резким p-n- переходом ТКЕ имеет значение порядка 5·10–4 град–1 при | U | = 4 В. С усилением зависимости емкости варикапа от напряжения, а также при понижении Uмин ТКЕ возрастает и при U = 1 В может достигать 5·10–3 град–1.
В радиоэлектронных устройствах свойство нелинейного изменения емкости варикапа используют для получения параметрического усиления, умножения частоты и т.д., а возможность электрического управления емкостью – для дистанционной и безынерционной перестройки резонансной частоты колебательного контура.
4.4. Стабилитроны
Стабилитроном называется полупроводниковый диод, предназначенный для стабилизации уровня напряжения в схеме. Для этого используются приборы, у которых на вольт-амперной характеристике имеется участок со слабой зависимостью напряжения от проходящего тока. Такой участок обусловливается электрическим пробоем p-n- перехода при включении диода в обратном направлении. ВАХ стабилитрона имеет вид, представленный на рис. 4.9, а. Подобной вольт-амперной характеристикой обладают сплавные диоды с базой, изготовленной из низкоомного полупроводникового материала. При этом напряженность электрического поля в p-n- переходе стабилитрона значительно выше, чем у обычных диодов. При относительно небольших обратных напряжениях в p-n- переходе возникает сильное электрическое поле, вызывающее его электрический пробой. Напряжение, при котором происходит лавинный пробой, зависит от удельного сопротивления полупроводникового материала. С ростом удельного сопротивления напряжение лавинного пробоя увеличивается.
Так как кремниевые диоды имеют меньшее значение обратного тока, обладают большей устойчивостью к тепловому пробою, чем германиевые диоды, поэтому в качестве стабилитронов применяют только кремниевые диоды.

Рис. 4.9. Вольт-амперная характеристика (а)
и конструкция корпуса (б) стабилитрона
Основными электрическими параметрами стабилитрона являются (в скобках даны их типовые значения):
- напря




 . (3.38)
. (3.38) . (3.39)
. (3.39) , (3.40)
, (3.40) . (3.41)
. (3.41) . (3.42)
. (3.42) , (3.43)
, (3.43) . (3.44)
. (3.44) . (3.45)
. (3.45) . (3.46)
. (3.46) . (3.47)
. (3.47) . (3.48)
. (3.48) , (3.49)
, (3.49) . (3.50)
. (3.50) , (3.51)
, (3.51)
 , (3.52)
, (3.52) . (3.53)
. (3.53) . (3.54)
. (3.54) . (3.55)
. (3.55) от толщины d ox для систем Si - SiO2 с концентрацией легирующей примеси N A в качестве параметра.
от толщины d ox для систем Si - SiO2 с концентрацией легирующей примеси N A в качестве параметра.
 в минимуме высокочастотной ВАХ от толщины подзатворного диэлектрика d ox при различных величинах концентрации легирующей примеси для кремниевых
в минимуме высокочастотной ВАХ от толщины подзатворного диэлектрика d ox при различных величинах концентрации легирующей примеси для кремниевых (3.56)
(3.56) . (3.57)
. (3.57) , эту величину используют, измеряя неравновесную емкость как емкость барьеров Шоттки при обратном смещении.
, эту величину используют, измеряя неравновесную емкость как емкость барьеров Шоттки при обратном смещении. , то, проводя сечение C = const = C FB (теор.), мы получаем при пересечении этой кривой с экспериментальной ВФХ напряжение, соответствующее ψ s = 0, т.е. экспериментальное напряжение плоских зон V FB (эксп.). При этом, согласно (3.46),
, то, проводя сечение C = const = C FB (теор.), мы получаем при пересечении этой кривой с экспериментальной ВФХ напряжение, соответствующее ψ s = 0, т.е. экспериментальное напряжение плоских зон V FB (эксп.). При этом, согласно (3.46), . (3.58)
. (3.58)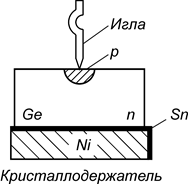

 . (4.1)
. (4.1)
 . (4.2)
. (4.2) . (4.3)
. (4.3)

 . (4.4)
. (4.4) . (4.5)
. (4.5) . (4.6)
. (4.6)

 . (4.7)
. (4.7) , (4.8)
, (4.8) , (4.9)
, (4.9) , (4.10)
, (4.10)
 . (4.11)
. (4.11) , (4.12)
, (4.12) . (4.13)
. (4.13)