Отметим, что при обратносмещенном р-п переходе исток-подложка (  − «минус» на р-подложку, «плюс» на п-исток) даже при нулевом напряжении сток-исток (
− «минус» на р-подложку, «плюс» на п-исток) даже при нулевом напряжении сток-исток (  ) МДПТ не является равновесной системой, так как через переходы исток-подложка, сток-подложка и канал-подложка протекают (хотя и малые) обратные токи. В результате происходит расщепление уровня Ферми на два квазиуровня − электронный
) МДПТ не является равновесной системой, так как через переходы исток-подложка, сток-подложка и канал-подложка протекают (хотя и малые) обратные токи. В результате происходит расщепление уровня Ферми на два квазиуровня − электронный  и дырочный
и дырочный  (рис. 3.2), причем в канале
(рис. 3.2), причем в канале  (как в обратносмещенном р-п-переходе).
(как в обратносмещенном р-п-переходе).
Как и для МДП-структуры, поверхностный потенциал в МДПТ при пороговом напряжении составляет:  , поэтому при
, поэтому при  пороговая ширина ОПЗ под затвором и пороговое напряжение МДПТ определяются теми же соотношениями, что и для МДП-структуры (рис. 3.2а).
пороговая ширина ОПЗ под затвором и пороговое напряжение МДПТ определяются теми же соотношениями, что и для МДП-структуры (рис. 3.2а).

Как видно из рис. 3.2б, при  поверхностный потенциал, при котором достигается граница режима сильной инверсии (
поверхностный потенциал, при котором достигается граница режима сильной инверсии (  , и
, и  ), т.е. при пороговом напряжении, возрастает до значения
), т.е. при пороговом напряжении, возрастает до значения  . Поэтому при
. Поэтому при  в соотношениях, определяющих пороговую ширину ОПЗ и пороговое напряжение, следует сделать замену:
в соотношениях, определяющих пороговую ширину ОПЗ и пороговое напряжение, следует сделать замену:  или
или  . При этом вместо (2.2.8)[3] (при
. При этом вместо (2.2.8)[3] (при  ) для п-канального МДПТ получим пороговое напряжение
) для п-канального МДПТ получим пороговое напряжение  , измеренное относительно подложки (как в МДП-структуре):
, измеренное относительно подложки (как в МДП-структуре):
 . (3.3.1а)
. (3.3.1а)
Поскольку  , при пороговом напряжении на затворе должно выполняться условие
, при пороговом напряжении на затворе должно выполняться условие  , где
, где  − пороговое напряжение, измеренное относительно истока:
− пороговое напряжение, измеренное относительно истока:
 . (3.3.1б)
. (3.3.1б)
Как видно из формулы (3.3.1), обратное смещение на подложке увеличивает эффективный заряд обедненной области и соответственно увеличивает по абсолютной величине пороговое напряжение. В п-канальных транзисторах при увеличении запирающего напряжения  пороговое напряжение возрастает, в р-канальных – снижается (растет по абсолютной величине). Во всех случаях запирающее напряжение снижает ток стока при заданных напряжениях
пороговое напряжение возрастает, в р-канальных – снижается (растет по абсолютной величине). Во всех случаях запирающее напряжение снижает ток стока при заданных напряжениях  и
и  . Сравнение соотношений (2.2.8) и (3.3.1) показывает, что зависимости порогового напряжения от напряжения на подложке для п-канального (знак «+») и р-канального (знак «–») МОПТ имеют вид
. Сравнение соотношений (2.2.8) и (3.3.1) показывает, что зависимости порогового напряжения от напряжения на подложке для п-канального (знак «+») и р-канального (знак «–») МОПТ имеют вид
 (3.3.2)
(3.3.2)
где  − параметр, зависящий от свойств подложки (
− параметр, зависящий от свойств подложки (  ) и свойств диэлектрика (
) и свойств диэлектрика (  ) (в [1] называется коэффициентом влияния подложки
) (в [1] называется коэффициентом влияния подложки  ; в нашем случае ниже будет введен другой параметр с таким названием).
; в нашем случае ниже будет введен другой параметр с таким названием).
Наклон зависимости порогового напряжения от обратного смещения определяется формулой
 . (3.3.3)
. (3.3.3)
Как видно из формулы (3.3.3), влияние подложки возрастает с увеличением толщины подзатворного окисла и увеличением степени легирования подложки (уменьшается толщина ОПЗ).
В идеале, у каждого транзистора на чипе исток должен быть закорочен с подложкой. На практике это условие не всегда реализуется, поскольку оно ведет к усложнению конструкции и удорожанию схемы. При локальном заземлении истоков каждого из n-канальных транзисторов обратное смещение истокового перехода всегда равно нулю, и пороговое напряжение одинаково для всех n-МОПТ. Если это условие не выполняется, то возникает рассогласование пороговых напряжений разных транзисторов, что приводит к уменьшению рабочего тока, замедлению быстродействия и другим нежелательным эффектам.
Приближение плавного канала
На рис.3.3 показано схематическое сечение МОП транзистора, в котором ток течет между истоком (S) и стоком (D) в канале, направленном по оси y.
Для анализа работы МОП транзистора необходимо использовать существенные приближения, главным из которых является приближение плавного канала. Приближение плавного канала состоит в том, что в каждой
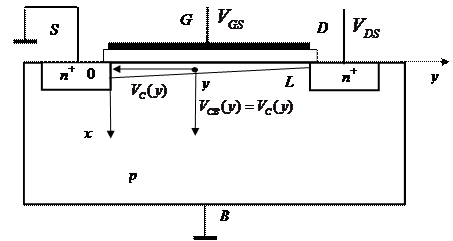
точке канала можно записать одномерное уравнение электронейтральности для локальных значений поверхностных зарядов (концентраций)
 , (3.4.1)
, (3.4.1)
где  − заряд на затворе. Это приближение справедливо при выполнении формального неравенства
− заряд на затворе. Это приближение справедливо при выполнении формального неравенства
 , (3.4.2)
, (3.4.2)
которое, в свою очередь, выполняется, когда электрические поля в направлении оси у существенно меньше, чем в направлении оси х.
В предыдущем разделе 3.3 предполагалось, что исток и сток находятся под одинаковым потенциалом (VS = VD). Теперь рассмотрим случай, когда исток и подложка соединены вместе и заземлены (VSB = 0), а на сток подается напряжение VDS > 0 (для определенности будем рассматривать n-МОПТ с p-подложкой и длиной канала L). Легко видеть, что поскольку исток и подложка соединены, значение потенциала канала  в данной точке y представляет собой локальное значение обратного смещения канала относительно и подложки, и истока в этой точке (см. рис.3.3)
в данной точке y представляет собой локальное значение обратного смещения канала относительно и подложки, и истока в этой точке (см. рис.3.3)
 , (3.4.3)
, (3.4.3)
которое меняется от нуля в истоке до VDS на стоке:
 .
.
Отметим, что потенциал затвора не зависит от VDS и не меняется по всей его длине (в отличие от поверхностной плотности заряда на затворе). В этом случае выражение (2.2.5)[4], связывающее напряжение затвор-подложка и поверхностный потенциал, с учетом локального смещения подложки  можно записать в виде
можно записать в виде
 . (3.4.4)
. (3.4.4)
Анализ (3.4.4) показывает, что по мере увеличения у возрастает локальный потенциал канала V С и соответственно поверхностная плотность заряда обедненного слоя. Поскольку  , это означает, что локальная плотность носителей в канале n S(у) уменьшается по мере приближения к стоку.
, это означает, что локальная плотность носителей в канале n S(у) уменьшается по мере приближения к стоку.
3.5. Плотность электронов вдоль канала при VDS > 0
При  (нет тока), заземленных истоке и подложке (VSB = 0) , потенциал канала
(нет тока), заземленных истоке и подложке (VSB = 0) , потенциал канала  не зависит от у и равен потенциалу истока (стока):
не зависит от у и равен потенциалу истока (стока):  . Следовательно, разность потенциалов затвор-канал,
. Следовательно, разность потенциалов затвор-канал,  , не зависит от у, и в надпороговом режиме
, не зависит от у, и в надпороговом режиме
 ,
,
где  − пороговое напряжение в отсутствие смещения подложки.
− пороговое напряжение в отсутствие смещения подложки.
При  вследствие протекания тока потенциал в канале растет по направлению к стоку, и появляется зависимость
вследствие протекания тока потенциал в канале растет по направлению к стоку, и появляется зависимость  . В результате этого по направлению к стоку, во-первых, изменяется (уменьшается) разность потенциалов затвор-канал
. В результате этого по направлению к стоку, во-первых, изменяется (уменьшается) разность потенциалов затвор-канал  , во-вторых, изменяется (увеличивается) напряжение канал-подложка
, во-вторых, изменяется (увеличивается) напряжение канал-подложка  . Поскольку
. Поскольку  , это эквивалентно подаче локального обратного смещения
, это эквивалентно подаче локального обратного смещения  на подложку (см. рис.3.3), и пороговое напряжение начинает локально зависеть от напряжения
на подложку (см. рис.3.3), и пороговое напряжение начинает локально зависеть от напряжения  .
.
Это позволяет записать плотность электронов в каждой точке канала в виде
 .
.
Поскольку  играет роль локального смещения на подложку, можно воспользоваться формулой (3.3.3)[5] и записать (разложение в ряд Тейлора):
играет роль локального смещения на подложку, можно воспользоваться формулой (3.3.3)[5] и записать (разложение в ряд Тейлора):
 ,
,
где  . Угловые скобки означают, что берется некоторое среднее значение производной на длине канала. Тогда
. Угловые скобки означают, что берется некоторое среднее значение производной на длине канала. Тогда
 (3.5.1)
(3.5.1)
где введен безразмерный параметр

– коэффициент влияния подложки.
Коэффициент влияния подложки демонстрирует насколько пороговое напряжение чувствительно относительно обратного смещения на подложку. Поскольку  , логично в качестве среднего значения выбрать
, логично в качестве среднего значения выбрать  . Тогда (см. (3.3.3)):
. Тогда (см. (3.3.3)):
 , (3.5.2)
, (3.5.2)
где  (см. (3.3.2)).
(см. (3.3.2)).
Отметим, что коэффициент влияния подложки п по смыслу и значению очень близок введенному в п. 3.1 безразмерному коэффициенту т:

Считая коэффициент влияния подложки постоянной величиной (  ), можно приближенно рассчитать распределение плотности носителей вдоль канала
), можно приближенно рассчитать распределение плотности носителей вдоль канала
 . (3.5.3)
. (3.5.3)
Плотность электронов у истока (  ) в этом приближении постоянна:
) в этом приближении постоянна:  , а вблизи стока (
, а вблизи стока (  ):
):
 . (3.5.4)
. (3.5.4)
При некотором значении  , которое называется напряжением насыщения, плотность электронов в канале вблизи стока оказывается формально равной нулю. Это исчезновение инверсного слоя вблизи стока называется перекрытием канала или электростатическим запиранием. Дополнительное напряжение на стоке (превышающее напряжение насыщения)
, которое называется напряжением насыщения, плотность электронов в канале вблизи стока оказывается формально равной нулю. Это исчезновение инверсного слоя вблизи стока называется перекрытием канала или электростатическим запиранием. Дополнительное напряжение на стоке (превышающее напряжение насыщения)  падает на рп-переходе стока и практически перестает влиять на распределение потенциала в канале. Это означает, что зависимость тока в канале от напряжения VDS насыщается, то есть ток практически перестает расти.
падает на рп-переходе стока и практически перестает влиять на распределение потенциала в канале. Это означает, что зависимость тока в канале от напряжения VDS насыщается, то есть ток практически перестает расти.
Простейшая модель ВАХ МОПТ
Пренебрегая диффузионной составляющей тока, полный ток в канале шириной Z можно записать в виде
 (3.6.1)
(3.6.1)
Здесь Z(cм),  (Кл/см2),
(Кл/см2),  (см/с), μ n (см2/В∙с), Е (В/см). Последнюю формулу можно переписать в форме
(см/с), μ n (см2/В∙с), Е (В/см). Последнюю формулу можно переписать в форме
 . (3.6.2)
. (3.6.2)
С учетом (3.5.3)[6], обе стороны уравнения (3.6.2) можно проинтегрировать с граничными условиями
 . (3.6.3)
. (3.6.3)
Формальный интеграл от (3.6.2) дает выражение
 , (3.6.4)
, (3.6.4)
 в котором при
в котором при  ток начинает уменьшаться с ростом VDS (рис. 3.4, штриховые линии). Однако такое поведение физически неприемлемо, поскольку, как следует из (3.5.3), отрицательный заряд в канале существует только при
ток начинает уменьшаться с ростом VDS (рис. 3.4, штриховые линии). Однако такое поведение физически неприемлемо, поскольку, как следует из (3.5.3), отрицательный заряд в канале существует только при  ,то есть только при напряжении
,то есть только при напряжении  меньше напряжения насыщения.
меньше напряжения насыщения.
Рис. 3.4. Схематические выходные ВАХ МОПТ для разных напряжений на затворе
В качестве тока насыщения принято использовать максимальное значение (3.6.4). То есть ток насыщения транзистора IDSAT вводится с помощью процедуры нахождения экстремума функции:
 (3.6.5)
(3.6.5)
при  - напряжение насыщения, после которого ток насыщается
- напряжение насыщения, после которого ток насыщается
Таким образом, в этом простейшем приближении вольтамперная характеристика (ВАХ) МОПТ выражается кусочно-непрерывной функцией
 , (3.6.6)
, (3.6.6)
где  − удельная крутизна МОПТ.
− удельная крутизна МОПТ.
С увеличением  величина
величина  растет: каждому
растет: каждому  соответствует свое напряжение насыщения
соответствует свое напряжение насыщения  . Область ВАХ, в которой
. Область ВАХ, в которой  , называется линейной или омической областью. Область ВАХ, в которой
, называется линейной или омической областью. Область ВАХ, в которой  , называется крутой областью, а область ВАХ с
, называется крутой областью, а область ВАХ с  называется областью насыщения или пологой областью.
называется областью насыщения или пологой областью.
Это базисное уравнение (3.6.6), полученное еще в начале 60-х гг. ХХ в., до сих пор остается основой практически для всех моделей, используемых в модифицированном виде, в том числе и для проектирования наноэлектронных МОПТ с длиной канала < 100 нм. Причина этого состоит в том, что ВАХ транзисторов, в том числе самых современных, имеют довольно простой вид, и для их описания достаточно (особенно при использовании множества подгоночных параметров) использования простых компактных моделей, не требующих громоздких расчетов.



 − «минус» на р-подложку, «плюс» на п-исток) даже при нулевом напряжении сток-исток (
− «минус» на р-подложку, «плюс» на п-исток) даже при нулевом напряжении сток-исток (  ) МДПТ не является равновесной системой, так как через переходы исток-подложка, сток-подложка и канал-подложка протекают (хотя и малые) обратные токи. В результате происходит расщепление уровня Ферми на два квазиуровня − электронный
) МДПТ не является равновесной системой, так как через переходы исток-подложка, сток-подложка и канал-подложка протекают (хотя и малые) обратные токи. В результате происходит расщепление уровня Ферми на два квазиуровня − электронный  и дырочный
и дырочный  (рис. 3.2), причем в канале
(рис. 3.2), причем в канале  (как в обратносмещенном р-п-переходе).
(как в обратносмещенном р-п-переходе). , поэтому при
, поэтому при  пороговая ширина ОПЗ под затвором и пороговое напряжение МДПТ определяются теми же соотношениями, что и для МДП-структуры (рис. 3.2а).
пороговая ширина ОПЗ под затвором и пороговое напряжение МДПТ определяются теми же соотношениями, что и для МДП-структуры (рис. 3.2а).
 поверхностный потенциал, при котором достигается граница режима сильной инверсии (
поверхностный потенциал, при котором достигается граница режима сильной инверсии (  , и
, и  ), т.е. при пороговом напряжении, возрастает до значения
), т.е. при пороговом напряжении, возрастает до значения  . Поэтому при
. Поэтому при  или
или  . При этом вместо (2.2.8)[3] (при
. При этом вместо (2.2.8)[3] (при  ) для п-канального МДПТ получим пороговое напряжение
) для п-канального МДПТ получим пороговое напряжение  , измеренное относительно подложки (как в МДП-структуре):
, измеренное относительно подложки (как в МДП-структуре): . (3.3.1а)
. (3.3.1а) , при пороговом напряжении на затворе должно выполняться условие
, при пороговом напряжении на затворе должно выполняться условие  , где
, где  − пороговое напряжение, измеренное относительно истока:
− пороговое напряжение, измеренное относительно истока: . (3.3.1б)
. (3.3.1б) пороговое напряжение возрастает, в р-канальных – снижается (растет по абсолютной величине). Во всех случаях запирающее напряжение снижает ток стока при заданных напряжениях
пороговое напряжение возрастает, в р-канальных – снижается (растет по абсолютной величине). Во всех случаях запирающее напряжение снижает ток стока при заданных напряжениях  и
и  . Сравнение соотношений (2.2.8) и (3.3.1) показывает, что зависимости порогового напряжения от напряжения на подложке для п-канального (знак «+») и р-канального (знак «–») МОПТ имеют вид
. Сравнение соотношений (2.2.8) и (3.3.1) показывает, что зависимости порогового напряжения от напряжения на подложке для п-канального (знак «+») и р-канального (знак «–») МОПТ имеют вид (3.3.2)
(3.3.2) − параметр, зависящий от свойств подложки (
− параметр, зависящий от свойств подложки (  ) и свойств диэлектрика (
) и свойств диэлектрика (  ) (в [1] называется коэффициентом влияния подложки
) (в [1] называется коэффициентом влияния подложки  ; в нашем случае ниже будет введен другой параметр с таким названием).
; в нашем случае ниже будет введен другой параметр с таким названием). . (3.3.3)
. (3.3.3)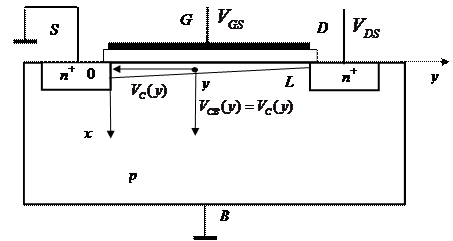
 , (3.4.1)
, (3.4.1) − заряд на затворе. Это приближение справедливо при выполнении формального неравенства
− заряд на затворе. Это приближение справедливо при выполнении формального неравенства , (3.4.2)
, (3.4.2) в данной точке y представляет собой локальное значение обратного смещения канала относительно и подложки, и истока в этой точке (см. рис.3.3)
в данной точке y представляет собой локальное значение обратного смещения канала относительно и подложки, и истока в этой точке (см. рис.3.3) , (3.4.3)
, (3.4.3) .
. можно записать в виде
можно записать в виде . (3.4.4)
. (3.4.4) , это означает, что локальная плотность носителей в канале n S(у) уменьшается по мере приближения к стоку.
, это означает, что локальная плотность носителей в канале n S(у) уменьшается по мере приближения к стоку. (нет тока), заземленных истоке и подложке (VSB = 0) , потенциал канала
(нет тока), заземленных истоке и подложке (VSB = 0) , потенциал канала  . Следовательно, разность потенциалов затвор-канал,
. Следовательно, разность потенциалов затвор-канал,  , не зависит от у, и в надпороговом режиме
, не зависит от у, и в надпороговом режиме ,
, − пороговое напряжение в отсутствие смещения подложки.
− пороговое напряжение в отсутствие смещения подложки. вследствие протекания тока потенциал в канале растет по направлению к стоку, и появляется зависимость
вследствие протекания тока потенциал в канале растет по направлению к стоку, и появляется зависимость  . В результате этого по направлению к стоку, во-первых, изменяется (уменьшается) разность потенциалов затвор-канал
. В результате этого по направлению к стоку, во-первых, изменяется (уменьшается) разность потенциалов затвор-канал  , во-вторых, изменяется (увеличивается) напряжение канал-подложка
, во-вторых, изменяется (увеличивается) напряжение канал-подложка  . Поскольку
. Поскольку  , это эквивалентно подаче локального обратного смещения
, это эквивалентно подаче локального обратного смещения  на подложку (см. рис.3.3), и пороговое напряжение начинает локально зависеть от напряжения
на подложку (см. рис.3.3), и пороговое напряжение начинает локально зависеть от напряжения  .
. .
. играет роль локального смещения на подложку, можно воспользоваться формулой (3.3.3)[5] и записать (разложение в ряд Тейлора):
играет роль локального смещения на подложку, можно воспользоваться формулой (3.3.3)[5] и записать (разложение в ряд Тейлора): ,
, . Угловые скобки означают, что берется некоторое среднее значение производной на длине канала. Тогда
. Угловые скобки означают, что берется некоторое среднее значение производной на длине канала. Тогда (3.5.1)
(3.5.1)
 , логично в качестве среднего значения выбрать
, логично в качестве среднего значения выбрать  . Тогда (см. (3.3.3)):
. Тогда (см. (3.3.3)): , (3.5.2)
, (3.5.2) (см. (3.3.2)).
(см. (3.3.2)).
 ), можно приближенно рассчитать распределение плотности носителей вдоль канала
), можно приближенно рассчитать распределение плотности носителей вдоль канала . (3.5.3)
. (3.5.3) ) в этом приближении постоянна:
) в этом приближении постоянна:  , а вблизи стока (
, а вблизи стока (  ):
): . (3.5.4)
. (3.5.4) , которое называется напряжением насыщения, плотность электронов в канале вблизи стока оказывается формально равной нулю. Это исчезновение инверсного слоя вблизи стока называется перекрытием канала или электростатическим запиранием. Дополнительное напряжение на стоке (превышающее напряжение насыщения)
, которое называется напряжением насыщения, плотность электронов в канале вблизи стока оказывается формально равной нулю. Это исчезновение инверсного слоя вблизи стока называется перекрытием канала или электростатическим запиранием. Дополнительное напряжение на стоке (превышающее напряжение насыщения)  падает на рп-переходе стока и практически перестает влиять на распределение потенциала в канале. Это означает, что зависимость тока в канале от напряжения VDS насыщается, то есть ток практически перестает расти.
падает на рп-переходе стока и практически перестает влиять на распределение потенциала в канале. Это означает, что зависимость тока в канале от напряжения VDS насыщается, то есть ток практически перестает расти. (3.6.1)
(3.6.1) (Кл/см2),
(Кл/см2),  (см/с), μ n (см2/В∙с), Е (В/см). Последнюю формулу можно переписать в форме
(см/с), μ n (см2/В∙с), Е (В/см). Последнюю формулу можно переписать в форме . (3.6.2)
. (3.6.2) . (3.6.3)
. (3.6.3) , (3.6.4)
, (3.6.4) в котором при
в котором при  ток начинает уменьшаться с ростом VDS (рис. 3.4, штриховые линии). Однако такое поведение физически неприемлемо, поскольку, как следует из (3.5.3), отрицательный заряд в канале существует только при
ток начинает уменьшаться с ростом VDS (рис. 3.4, штриховые линии). Однако такое поведение физически неприемлемо, поскольку, как следует из (3.5.3), отрицательный заряд в канале существует только при  ,то есть только при напряжении
,то есть только при напряжении  меньше напряжения насыщения.
меньше напряжения насыщения. (3.6.5)
(3.6.5) , (3.6.6)
, (3.6.6) − удельная крутизна МОПТ.
− удельная крутизна МОПТ. величина
величина  растет: каждому
растет: каждому  соответствует свое напряжение насыщения
соответствует свое напряжение насыщения  . Область ВАХ, в которой
. Область ВАХ, в которой  , называется линейной или омической областью. Область ВАХ, в которой
, называется линейной или омической областью. Область ВАХ, в которой  , называется крутой областью, а область ВАХ с
, называется крутой областью, а область ВАХ с  называется областью насыщения или пологой областью.
называется областью насыщения или пологой областью.


