

Двойное оплодотворение у цветковых растений: Оплодотворение - это процесс слияния мужской и женской половых клеток с образованием зиготы...
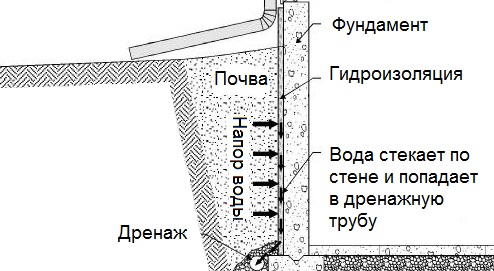
Общие условия выбора системы дренажа: Система дренажа выбирается в зависимости от характера защищаемого...

Двойное оплодотворение у цветковых растений: Оплодотворение - это процесс слияния мужской и женской половых клеток с образованием зиготы...
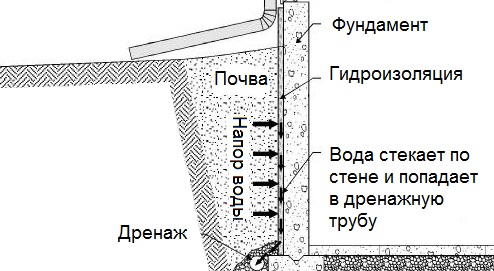
Общие условия выбора системы дренажа: Система дренажа выбирается в зависимости от характера защищаемого...
Топ:
Отражение на счетах бухгалтерского учета процесса приобретения: Процесс заготовления представляет систему экономических событий, включающих приобретение организацией у поставщиков сырья...
Установка замедленного коксования: Чем выше температура и ниже давление, тем место разрыва углеродной цепи всё больше смещается к её концу и значительно возрастает...
Интересное:
Аура как энергетическое поле: многослойную ауру человека можно представить себе подобным...
Уполаживание и террасирование склонов: Если глубина оврага более 5 м необходимо устройство берм. Варианты использования оврагов для градостроительных целей...
Подходы к решению темы фильма: Существует три основных типа исторического фильма, имеющих между собой много общего...
Дисциплины:
|
из
5.00
|
Заказать работу |
|
|
|
|
Чтобы диффузия была локальной, нужна маска – оксид кремния.
Кремний – полупроводник четвертой группы.
Донорные примеси – V группа: фосфор, мышьяк, сурьма. Азот как донорная примесь не используется, так как не растворяется в кремнии.
Акцепторные примеси – III группа: только бор. Индий, галий и алюминий не используются, так как оксид кремния для них не будет маской (коэффициент диффузии для оксида кремния ненамного меньше, чем для самого кремния). Найти другую маску трудно. Алюминий очень сильно диффундирует в кремнии.
p-n переходы получают методом компенсации. Есть п/п pилиn типа и, чтобы получить противоположный тип, нужно легировать до концентрации, которая будет больше концентрации исходного легирования п/п.
Методы легирования
• Междоузельный механизм (диффундирует быстро). Барьер (энергия активации) 0,1-1 эВ. С очень сильной температурной зависимостью.
• Вакансионный механизм (диффундирует медленно). Барьер 3-5 эВ – энергия образования вакансии в кремнии.
Нас интересует вакансионный механизм.
Междоузельный механизм - отрицательный эффект.
При наличии дефектов скорость диффузии возрастает.
Рассматриваем объемную диффузию в идеальном кристалле.
Поверхностная диффузия быстрее.
Либо газы, либо быстро кипящие примеси.
Окисление может быть совмещено с процессом диффузии.
Диффузия резко зависит от температуры.
Алюминий и галий быстро диффундирующие примеси. Поэтому их не используют, так как p-n переходы с ними быстро расплываются при последующих высокотемпературных операциях.
Сурьма и мышьяк медленно диффундирующие примеси.
Рассматривает диффузию в полубесконечную среду.
Первый и второй законыФика.
|
|

Коэффициент диффузии зависит от х (от концентрации, которая зависит от х). Но для небольших концентраций можно считать, что зависимости нет.
• Диффузия из бесконечного (неограниченного) источника: на поверхности концентрация все время одинакова. В газе носителя высокая концентрация примеси, превышающая предельно растворимую концентрацию в кремнии. Решение не элементарная функция. Получаем функцию ошибок (интеграл вероятности). Такой метод легирования используется для вырожденных (высоких) концентраций (исток, сток).


• Диффузия из ограниченного (конечного) источника: в тонкий приповерхностный слой вводится определенное точно рассчитанное количество примеси, которое не меняется во время процесса. Во время всего процесса диффузии количество примеси не меняется. Похоже на простое распределение Гаусса.


• Двухстадийная диффузия – самый дешевый способ. Первая стадия -загонка примеси (диффузия из бесконечного источника). Вторая стадия – разгонка.
Поток диффундирующих атомов через единицу поверхности на стадиизагонки равен

Достоинства и недостатки диффузии как метода легирования:
+ простой и относительно дешевый, групповой процесс;
– высокотемпературный процесс (нельзя делать более 2 процессов подряд);
– изотропность процесса (нельзя создать маленькие области).
Глубина p-n-перехода xj– значение x, при котором концентрациядиффундирующей примеси равна концентрации примеси противоположноготипа проводимости, содержащейся в подложке.
Ионное легирование.
Образование и отжиг радиационных дефектов. Доза аморфизации.
· Физическое внедрение ионов.
· Сложный метод и более дорогой. Менее производительный.
Преимущества метода ионной имплантации:
+ Анизотропия;
+ Низкая температура;
+ Универсальность в выборе примеси (можем вводить все что угодно);
+ Точный независимый подбор дозы и глубины (позволяет измерять точное количество введенных ионов).
Оборудование для ионного легирования
|
|
• высокий вакуум;
• высокие энергии ионов 10-500 кэВ;
• гидриды, галогениды;
Задаем энергию ионов и дозу.
Доза – количество ионов, попавших на мишень.
Обычно используют однозарядные ионы.
Негрупповой процесс. Только для одной пластины. Производительность на 2 порядка меньше, чем у диффузии.
Время зависит от дозы. Путем увеличения тока можно добиться повышения дозы без дополнительного времени. Если увеличивать ток, то нужна более точная фокусировка.
Где возможно, используют диффузию. Если использование диффузии невозможно, то тогда применяют ионную имплантацию.
Теория Линдхарда-Шарфа-Шиотта (ЛШШ).
Симметричная функция Гаусса.

Если подложка легирована примесью противоположногознака с концентрацией Nподл, то p-n-переход возникает на глубине xj, на которой

Эффект каналирования – отрицательный эффект, так как зависит от массы трудноуправляемых (неуправляемых) факторов (температура, угол). Поэтому этот эффект стараются подавить и получить случайное рассеяния.
Самая большая площадь каналов для ориентации 110.
Методы подавления каналирования:
· критический угол;
· высокие температуры (узлы кристаллической решетки колеблются);
· аморфные пленки.
Если подавили эффект каналирования, то получаем гауссову функцию. Q(Ф) – доза.
Бор – самый легкая примесь, в три раза легче кремния.
Чем больше энергия, тем больше отклонение от распределения Гаусса. Также с ростом энергии увеличивается боковое рассеяние.
Требования к маске:
В случае диффузии должна быть высокотемпературной, не реагировать с диффузантами и коэффициент диффузии должен быть маленьким.
В случае ионной имплантации толщина маски должна быть d>>Rp+3ΔRp. Толщины примерно такие же, как и для диффузии.
Недостатки ионной имплантации:
В процессе торможения ион создает большое количество дефектов, на каждый падающий ион с энергией 100 кэВ получаем 10 000 дефектов. Полностью разупорядоченный кремний – аморфизированный кремний. Доза аморфизации зависит от температуры и сорта атомов. Чем тяжелее атом, тем меньше доза аморфизации.
1) После ионной имплантации возникает либо аморфная среда, либо среда с большим количеством дефектов. Чтобы атом играл свою легирующую роль, он должен встать в узел кристаллической решетки. Чтобы поставить атом в узел кристаллической решетки, нужно провести отжиг. Чем больше доза, тем больше нарушений. Отжиг нужно проводить при высокий температурах (900-1000 градусов) около 30 минут.
|
|
2) Во время отжига будет идти диффузия, и мы будем терять преимущества ионной имплантации.
Полностью амофизованную область легче отжечь, чем частично аморфизованную. Для полностью аморфизованного кремния отжиг проводится при более низких температурах – около 600 градусов.

|
|
|

Своеобразие русской архитектуры: Основной материал – дерево – быстрота постройки, но недолговечность и необходимость деления...

Состав сооружений: решетки и песколовки: Решетки – это первое устройство в схеме очистных сооружений. Они представляют...

История развития пистолетов-пулеметов: Предпосылкой для возникновения пистолетов-пулеметов послужила давняя тенденция тяготения винтовок...
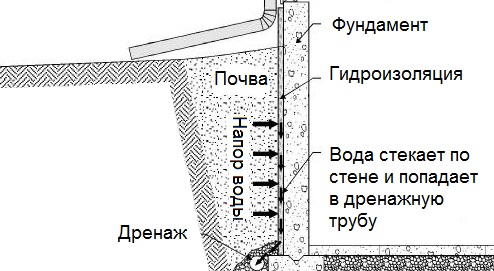
Общие условия выбора системы дренажа: Система дренажа выбирается в зависимости от характера защищаемого...
© cyberpedia.su 2017-2024 - Не является автором материалов. Исключительное право сохранено за автором текста.
Если вы не хотите, чтобы данный материал был у нас на сайте, перейдите по ссылке: Нарушение авторских прав. Мы поможем в написании вашей работы!