

Семя – орган полового размножения и расселения растений: наружи у семян имеется плотный покров – кожура...

Типы оградительных сооружений в морском порту: По расположению оградительных сооружений в плане различают волноломы, обе оконечности...

Семя – орган полового размножения и расселения растений: наружи у семян имеется плотный покров – кожура...

Типы оградительных сооружений в морском порту: По расположению оградительных сооружений в плане различают волноломы, обе оконечности...
Топ:
Генеалогическое древо Султанов Османской империи: Османские правители, вначале, будучи еще бейлербеями Анатолии, женились на дочерях византийских императоров...
История развития методов оптимизации: теорема Куна-Таккера, метод Лагранжа, роль выпуклости в оптимизации...
Основы обеспечения единства измерений: Обеспечение единства измерений - деятельность метрологических служб, направленная на достижение...
Интересное:
Влияние предпринимательской среды на эффективное функционирование предприятия: Предпринимательская среда – это совокупность внешних и внутренних факторов, оказывающих влияние на функционирование фирмы...
Подходы к решению темы фильма: Существует три основных типа исторического фильма, имеющих между собой много общего...
Искусственное повышение поверхности территории: Варианты искусственного повышения поверхности территории необходимо выбирать на основе анализа следующих характеристик защищаемой территории...
Дисциплины:
|
из
5.00
|
Заказать работу |
|
|
|
|
Из выражения для величины фотовольтаического эффекта (4.12) следует, что она тем больше, чем меньше проводимость полупроводника, т.е. чем более высокоомен полупроводник. Наибольшим сопротивлением обладает полупроводник с концентрациями носителей заряда, равными собственной концентра
ции n = p = nj. Однако изготовить такой полупроводниковый образец технологически сложно. Поэтому целесообразно использовать для регистрации оптического излучения образец, в котором имеется отдельная область собственной проводимости. Такую область можно получить, изготовив полупроводниковый p - n -переход. Как известно, он образуется при соединении двух полупроводников, обладающих разными типами проводимости: электронной (n-тип) и дырочной (p-тип). Чтобы избежать неконтролируемого влияния поверхностей на свойства p - n - перехода, его изготавливают из одного монокристалла легированием торцов образца донорной и акцепторной примесями, а затем вжиганием примесей в объем высокотемпературной обработкой. Рис. 30 поясняет сказанное. Здесь в левой части кристалла создана дырочная проводимость с концентрацией основных носителей (дырок) p & Na - Nd, а в правой части - электронная (n & Na - Nd). Между ними образуется переходной слой, в котором концентрация примесей быстро изменяется. В некоторой тонкой области этого слоя доноры и акцепторы компенсируют друг друга (Na & Nd) и потому в ней имеет место собственная проводимость (/-проводимость).

|
| -Xf О Рис. 30 |
Требуемое распределение доноров и акцепторов осуществляется с помощью специиальных технологических приемов. Распределение концентраций электронов и дырок в p - n -переходе показано на рис. 31 сплошными линиями. Причина формирования именно такого хода зависимостей концентраций равновесных носителей кроется в большом различии концентраций подвижных носителей заряда в n - и p -областях. В результате этого электроны из n - области устремляются туда, где их мало, т.е. в p -область, а дырки из p - области будут диффундировать в n -область. Эти два встречных потока будут продолжаться до тех пор, пока оставляемые без подвижного заряда положительные ионы в n-области и отрицательные в p-области не создадут электрическое поле
- Eк (см. рис. 31), которое затормозит процесс диффузии равновесных носителей. Это электрическое поле направлено от n - к p -области.
|
|

|
Одним из важных параметров p-n-перехода является высота его потенциального барьера - щ. Чтобы ее оценить, вспомним, что в равновесном состоянии положение уровня Ферми в п - и р-областях должно быть одинаковым (см. рис. 32). Это позволяет записать следующее равенство
e що + (Fp - Ev) = Fn - Ev.
Уровень Ферми в п - области перехода относительно середины запрещенной зоны Ej определяется концентрацией донорной примеси в ней:
| -x-f 0 x2 Рис. 31 |
Fn - E; = kT • \n(Nd / ni).
Положение уровня Ферми в p-области перехода определяется концентрацией акцепторной примеси:
Fp - Ei = -kT • \n(Na / nj).
Поэтому будем иметь:

|
| Na v ni J |
| e • щ = kT • \ \n |
| + \n |
| или |
ГмЛ Гм Л
Nd
| r NaNd Л v ni2 J |
v ni J
kT, Щ =- \n
e
Такова высота потенциального барьера между n - и р-областью в отсутствие освещения, электрического поля и других факторов, нарушающих состояние термодинамического равновесия в полупроводнике. Она оказывается тем выше, чем выше уровень легирования областей и ниже собственная концентрация полупроводника. Величина барьера p - n -перехода
не превышает ширину запрещенной зоны полупроводника, т.к. в этих условиях уровень Ферми занимает предельные положения в запрещенной зоне: в n - области совпадает с дном зоны проводимости, а в p-области - с потолком валентной зоны.
Важной характеристикой p-n-перехода является его вольт-амперная характеристика (ВАХ). Ее аналитическое выражение таково (без вывода):
|
|

|
Данная характеристика дает экспоненциальный рост тока при приложении положительных напряжений («+» на р-области) и постоянство тока в области отрицательных напряжений: j(V) = -js, где ток js называется обратным током или током насыщения. Его величина определяется технологией изготовления р-n перехода, качеством исходного полупроводникового материала.
Пусть теперь к переходу приложено внешнее напряжение так, что на р- области находится «+» источника (рис. 32). Это приложенное напряжение частично компенсирует поле Eк. В результате равновесие между диффузионным потоком носителей и током проводимости поля Eк будет нарушено в пользу первого. В результате дырки из ^-области устремятся в n-область, где они станут неосновными носителями заряда. Так как pp>>pn, то эти дырки в n -области будут рекомбинировать с электронами. Однако вследствие конечного значения времени жизни дырок тр, рекомбинация произойдет не сразу, и поэтому в некоторой области за пределами перехода концентрация дырок будет больше pn. По этим же причинам увеличится концентрация электронов в n - области, так как дополнительные электроны войдут из электрода для компенсации объемного заряда пришедших дырок: основные носители в n-области - электроны будут переходить в р-область, становясь там неосновными носителями, и постепенно рекомбинировать с основными носителями - дырками. Поэтому, слева от перехода концентрация электронов увеличивается, а также увеличивается концентрация дырок, которые войдут из левого электрода для компенсации объемного
заряда электронов. Это явление получило название инжекции неосновных носителей. Распределение концентраций неосновных носителей при инжекции показано на рис. 31 штриховыми линиями. В результате приложения напряжения V указанной полярности ток через переход будет расти по экспоненте с ростом величины V.
Барьерная фотоэдс
Обратимся к вопросу о влиянии освещения на свойства полупроводников. При освещении р-n - перехода высота барьера понижается на величину, пропорциональную уровню освещения. Изменение высоты барьера на границе раздела двух типов проводимости называют барьерной фотоэдс. Она возникает в том случае, когда свет генерирует носители заряда вблизи р-n -перехода. Следует различать две принципиально различные схемы включения освещаемого перехода. В первой из них р-n - переход замкнут на внешнюю нагрузку без внешнего источника напряжения и является преобразователем световой энергии в электрическую (рис. 33, а). Такое включение называют фотовентильный режим работы.
|
|
Другая схема во внешней цепи содержит источник напряжения, включенный так, чтобы на р-n -переходе было запорное напряжение (рис. 33, б) - это так называемый фотодиодный режим. В схеме б существующий в цепи ток сильно изменяется с освещением. Поэтому изменяется падение напряжения на

|

|
сопротивлении R. При правильном выборе напряжения источника и внешнего сопротивления величина сигнала в фотодиодном режиме может быть сделана больше, чем в фотовентильном. Величина вентильной фо- тоэдс на несколько порядков больше, чем эдс Дембера и объемная фотоэдс. Физиче
ская причина ее появления заключается в том, что электрическое поле р-n - перехода разделяет фотодырки и фотоэлектроны, подошедшие к переходу. Поясним это, предположив, что сильно поглощаемое излучение падает на одну из граней кристалла, параллельную плоскости р-n -перехода. Для определенности будем считать, что освещается n-область, излучение поглощается в ней. Толщина этого слоя выбирается меньше длины диффузии неосновных носителей в нем (дырок). На концах прибора измеряется эдс холостого хода (см. рис. 34).
Фотоэлектроны и фотодырки в n - слое будут диффундировать в глубь слоя, и некоторая их доля, не успев прорекомбинировать, достигнет р-n - перехода. Однако для основных носителей (электронов) в р-n -переходе существует потенциальный барьер, и поэтому они не пройдут в р-область. Для неосновных носителей (дырок) потенциального барьера нет, и потому все достигшие переход дырки перенесутся полем перехода в р-область. При этом они создадут фототок jфт. Если д - скорость световой генерации электронно-
дырочных пар в n-области, ар - их доля, дошедшая до р-n - перехода, то jфт = едР. Вследствие появления фототока jфт р-область будет заряжаться
|
|
положительно, а «-область - отрицательно, и между n- и р - областями появится разность потенциалов - барьерная фотоэдс V*. Снижение высоты барьера между n- и р - областями перехода на величину фотоэдс согласно ВАХ приведет к росту прямого темнового тока, созданного основными носителями - jnp:
С i /* ^ eV
| -1 |
| exp |
| Jnp = Js |
~~kT~
Он направлен обратно току jфт. Его стационарное значение может быть найдено из условия равновесия, при котором полный ток через переход отсутствует: jфт = jnp. Тогда, используя выражение для ВАХ p-n-перехода при его освещении, получим:
| f I /* Л eV |
| -1 |
| exp |
| kT |
Jфт = js
где js - ток насыщения (обратный ток) р-n -перехода. Отсюда можно найти величину вентильной фотоэдс:
| ..* kT. V =------- In e |
| 1 + jФm js |
| (4.18) |
Как следует из данного выражения, вентильная фотоэдс тем больше, чем меньше обратный ток перехода и выше уровень освещенности. Следовательно, для получения высокочувствительного фотодиода необходимо сильное легирование n- и р - областей р-n перехода. Согласно выражению (4.18), при малых уровнях освещения барьерная фотоэдс равна
| * = kT V =------ | In | 1 + jфm | „ kT | f jфm } |
| e | 1 js _ | e | I js) |
т.е. она прямо пропорциональна интенсивности падающего излучения:
\фт = epQ = epcclо(1 - R)/ha.
Однако рост барьерной фотоэдс с увеличением уровня освещения не беспределен. Поскольку V* направлено обратно к ср0 - высоте барьера, то она не может быть больше высоты барьера. Следовательно, величина фотоэдс не может превышать контактную разность потенциалов между n- и р - областями, а ее максимальная величина сопоставима с шириной запрещенной зоны AEg:
V * -^Я.
vmax ~ •
e
Так, для кремния V**ax -1 B, а для германия V**ax - 0.6 B при быстродействии, определяемом временем жизни неравновесных носителей заряда в р-n - переходе. В зависимости от физико-химического состава полупроводникового материала оно колеблется в диапазоне от 10-3 до 10-6 с.
В настоящее время р-n -переход - один из наиболее широко используемых фотодатчиков, т.к. он обладает высокой чувствительностью и приемлемым быстродействием, не требует посторонних источников напряжения (как фоторезистор), технологически совместим со схемой обработки сигналов, т.е. фотопри
емник на основе барьерной фотоэдс можно в одном технологическом цикле изготовить со схемой усиления фотоэдс, детектирования и т.д. на одном полупроводниковом кристалле.
|
|
|

Кормораздатчик мобильный электрифицированный: схема и процесс работы устройства...

Историки об Елизавете Петровне: Елизавета попала между двумя встречными культурными течениями, воспитывалась среди новых европейских веяний и преданий...
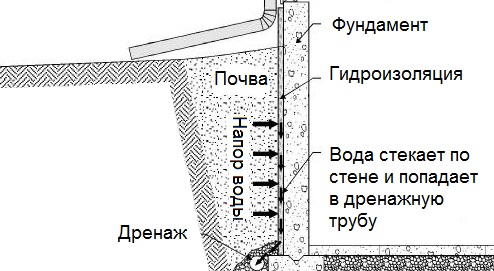
Общие условия выбора системы дренажа: Система дренажа выбирается в зависимости от характера защищаемого...

Индивидуальные и групповые автопоилки: для животных. Схемы и конструкции...
© cyberpedia.su 2017-2024 - Не является автором материалов. Исключительное право сохранено за автором текста.
Если вы не хотите, чтобы данный материал был у нас на сайте, перейдите по ссылке: Нарушение авторских прав. Мы поможем в написании вашей работы!