Основные отличия микроэлектронных приборов от их дискретных аналогов можно свести к двум моментам. Во-первых, формирование слоев структур приборов производится с одной стороны кристалла, поэтому подавляющее большинство транзисторов микросхем дрейфовые. Во-вторых, на одном кристалле располагаются множество приборов, которые должны быть изолированы друг от друга, поэтому возникают паразитные структуры за счет элементов изоляции. Кроме этого, в интегральном исполнении могут быть реализованы принципиально новые приборы, которые невозможны в дискретном исполнении, например, транзисторы с инжекционным питанием.
Одной из основных технологических задач производства интегральных приборов является проблема электрической изоляции отдельных элементов, расположенных на одном кристалле. В настоящее время в основном применяется изоляция p‑n- переходом или диэлектрической пленкой. Первый вид изоляции является наиболее освоенным и широко распространенным, так как обеспечивает более высокий процент выхода годных микросхем при сравнительно низкой стоимости, кроме основной структуры прибора, формируют специальные изолирующие p‑n‑ переходы. В рабочем режиме потенциал подложки выбирается так, чтобы эти специальные p‑n- переходы были смещены в обратном направлении и тем самым изолировали друг от друга отдельные элементы микросхем, т. е. подложка должна быть подключена к самому низкому потенциалу схемы.
На рисунке 1.11 приведена упрощенная схема основных операций технологического процесса изготовления транзисторных структур с изолирующим p‑n- переходом. На рисунке 7 б показаны графики распределения примесей в кристалле на различных этапах технологического процесса.
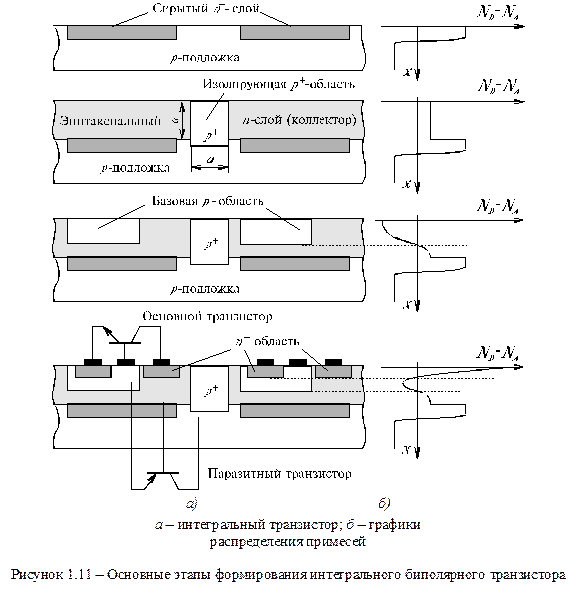
Обычно микроэлектронные транзисторы формируются на полупроводниковой подложке из монокристаллического кремния p‑ типа. После первой операции окисления с помощью фотолитографии вытравливаются окна под диффузию, формирующие скрытые коллекторные слои. Эти слои, представляющие собой сильно легированные участки с n +‑проводимостью, образуют низкоомную область коллекторов, предназначенную для уменьшения сопротивления в поперечном направлении, так как основное тело коллектора создается на основе высокоомного n‑ слоя.
В коллекторном слое транзистора в интегральном исполнении должны быть последовательно сформированы базовый, а затем эмиттерный слои. Для того, чтобы произошла перекомпенсация примесей (чтобы получить противоположную проводимость слоя), необходимо различие в концентрациях примерно на два порядка. В результате получается, что если в эмиттерном слое концентрация примесей должна быть примерно 1020 см‑3 (а это предельное значение для кремния), то базовый слой должен иметь концентрацию примесей 1018 см‑3, а коллекторный – 1016 см-3. Поэтому после формирования скрытого n +‑слоя со всей поверхности пластины удаляется SiO2 и проводится эпитаксиальное выращивание высокоомного кремния n ‑типа. Этот эпитаксиальный слой и дает возможность сформировать базу с большим перепадом концентрации примесей.
Затем пластина вновь окисляется и проводится селективная диффузия акцепторных примесей для формирования изолирующих p‑n- переходов. Для получения качественной изоляции, необходимо обеспечить такую глубину диффузии, чтобы изолирующий p +‑слой проник через эпитаксиальную пленку до самого тела подложки. При этом ширина p +‑слоя должна быть не меньше толщины эпитаксиального слоя.
Последующая диффузия через окна проводится для формирования базовой области. Базовая диффузия выполняется из ограниченного источника, что позволяет осуществить точный контроль поверхностной концентрации примесей и режима диффузии. Благодаря этому удается получить заданную толщину и сопротивление слоя. Затем проводится эмиттерная диффузия через соответствующие окна, расположенные на участках эмиттеров и коллекторных контактов. В качестве примеси обычно используют фосфор, позволяющий получить низкоомный слой n +‑типа.
Таким образом, структура интегрального транзистора содержит больше слоев и p‑n‑ переходов, чем структура дискретного. Наличие дополнительных p‑n- переходов приводит к появлению паразитного p‑n‑p‑ транзистора. Эмиттером этого транзистора является пассивный участок базы основного, базой является коллектор основного, а коллектором – подложка и изолирующий p +‑слой.
Видно, что паразитный транзистор – бездрейфовый, потому что его базой является эпитаксиальный слой с однородным легированием, база получается намного толще, чем у основного. Поэтому коэффициент передачи базового тока паразитного транзистора получается очень небольшим. Поскольку паразитный транзистор получается p‑n‑p‑ типа, то при рабочих полярностях питания основного n‑p‑n‑ транзистора, паразитный находится преимущественно в режиме отсечки. Поэтому наиболее существенно паразитный транзистор сказывается на токах закрытого состояния транзисторного ключа.
Для создания интегрального диода достаточно сформировать только один p‑n‑ переход. Однако при изготовлении микросхем желательно все элементы формировать в едином технологическом процессе. Поэтому наиболее экономично использовать биполярный транзистор в диодном включении. При этом характеристики диода-транзистора можно изменять, используя тот или иной p‑n- переход путем применения одного из шести возможных вариантов включения (рисунок 1.12).
Варианты (а), (б) анализируются наиболее просто. Так как один из переходов замкнут, то напряжение на нем равно нулю, т. е. закороченные p‑n‑ переходы не оказывают никакого влияния на вольт-амперные характеристики рабочих p‑n‑ переходов. В вариантах (в) и (г)второй p‑n‑ переход никуда не подключается и влияет на рабочий переход, снижая ток насыщения получающегося диода [2].

Вариант (е)получается, если в технологическом процессе формирования транзисторной структуры исключить эмиттерную диффузию. Поскольку остается только один p‑n‑ переход, никакого влияния на него не оказывается, и вольт-амперная характеристика точно такая же, как и при закороченных выводах эмиттер-база.
Отмечая особенности рассмотренных вариантов, необходимо сказать, что наибольший ток пропускает диод варианта (д), наибольшим быстродействием обладает диод варианта (а), а наибольшие пробивные напряжения имеют диоды вариантов (б, г, е).
ОПИСАНИЕ РАБОТЫ СТЕНДА