Расчет пленочных резисторов начинается с выбора материала резистивной пленки и проводящей пленки для выводов. Для этого можно воспользоваться таблицей 1 методического указания.
Каждый резистор должен выдержать мощность:
 ,
,
где Р0 - удельная мощность рассеяния (значения Р0 для различных материалов приведены в упомянутой выше таблице).
 - площадь резистора.
- площадь резистора.
RЗ = 2,7 МОм: 
где 10000 - удельное сопротивление (Ом/квадрат) материала кермет.
Резистор займёт много места, предпочтительней использовать навесной резистор: типа Р1-12.

RК2 = RЭ2 - расчётная величина 2000 Ом.
Выберем материал РС-3001. Ri = 1000-2000 Ом/квадрат.
Вычислим КФ:

КФ < 10, реализация полоска (b * l).
Выберем b = bmin = 0,2 мм, тогда:
l = КФ * b;= 2 * 0,2 = 0,4 мм;= 0,2 * 0,4 = 0,08 мм2
Мощность, которая на нём рассеивается равна:
P (Rэ2) = I2р. т. * RЭ = 0,004262 * 2000 ≈ 36,3 мВт.
Мощность, которую выдержит резистор S = 0,08 мм2 равна:

,6 мВт << 36,3 мВт, т.е. необходимо увеличить площадь резистора, одновременно увеличивая длину и ширину.
Выберем b = 5* bmin = 5 * 0,2 = 1,0 мм, тогда:
l = КФ * b;= 2 * 1,0 = 2,0 мм;= 1,0 * 2,0 = 2,0 мм2

мВт > 36,3 мВт, следовательно резистор не перегревается.
RC - расчётная величина 1602 Ом. Выбираем материал РС-3001.
Ri = 1000-2000 Ом/квадрат.
Вычислим КФ:

КФ < 10, реализация полоска (b * l).
Выберем b = 4* bmin = 4 * 0,2 = 0,8 мм, тогда:
l = КФ * b;= 2 * 0,8 = 1,6 мм;= 0,8 * 1,6 = 1,28 мм2
Мощность, которая на нём рассеивается равна:
P (Rс) = I2с р. т. * RС = 0,00272 * 1602 ≈ 12 мВт.
Мощность, которую выдержит резистор S = 1,28 мм2 равна:

,6 мВт > 12 мВт, следовательно резистор не перегревается.
б. Расчёт конденсаторов.
При расчете пленочных конденсаторов сначала выбирают материал диэлектрика (см. табл.2 в методическом указании) в соответствии с заданным методом нанесения пленок.
После выбора материала вычисляют площадь конденсатора
 ,
,
где Сi - емкость рассчитываемого конденсатора;
А и В - длина и ширина площадки, занимаемой перекрывающимися частями нижней и верхней обкладок конденсатора (если конденсатор имеет прямоугольную форму).
СР1 - расчётная величина 11,25 нФ. Пусть реализуется интегрально, выберем материал окись тантала.

СР2= СР3 - расчётная величина 15,2 мкФ - реализация: навесной конденсатор.
Выбираем:

Пусть l = 3мм; b = 4мм;
SСр2 = SСр3 = 3 * 3 = 9 мм2;
СК - расчётная величина 38 нФ. Выберем навесной:

Пусть l = 1,5 мм; b = 2 мм;
SСк = 1,5 * 2 = 3 мм2;
Транзисторы:
VT1 - бескорпусной полевой транзистор 2П202Е-1:
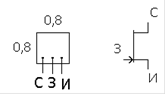
SVT1 = 0,8*0,8 = 0,64 мм2.
VT2 - бескорпусной биполярный транзистор КТ331А-1:

SVT2 = 1,2*1,2 = 1,44 мм2.
в. Площадь занимаемой элементами.
Площадь занимаемая транзисторами:
SТР = SVT1 + SVT2 = 0,64 + 1,44 = 2,08 мм2.
Площадь занимаемая резисторами:
SR = SRз + SRэ + SRк + SRс = (3,1*1,55) + 2*2,0 + 1,28 = 10,085 мм2.
Площадь занимаемая конденсаторами:
SС = SСр1 + SСр2 + SСр3 + SСк= 22,5 + 2*9 + 3 = 43,5 мм2.
Определим общую площадь занимаемую элементами:
S∑ = SТР + SR + SС = 2,08 + 10,085 + 43,5 = 55,665 мм2.
Учитывая площадь соединений, промежутки между элементами и расстояние от края подложки, следует увеличить суммарную площадь в 3-4 раза.
SПОДЛ = 55,665 * 3 = 166,995 мм2.
В соответствии с рекомендуемыми размерами плат для гибридных ИМС (таблица №3 методического указания) выбираем:
Длина - 16 мм, ширина - 10 мм.
S = 16 * 10 = 160 мм2.

Этапы изготовления ГИМС
Изготовление устройств в виде гибридной ИМС происходит в несколько этапов:
Подготовительные операции.
Слитки кремния разрезают на множество тонких пластинок, на которых затем изготовляют интегральные схемы. Пластины многократно шлифуют, а затем полируют. Проводят очистку и обезжиривание в органических растворителях при повышенной температуре. И затем отмывают в воде.
Эпитаксия.
Эпитаксией называют процесс наращивания монокристаллических слоев на подложку, при котором кристаллографическая ориентация наращиваемого слоя повторяет кристаллографическую ориентацию подложки.
Термическое окисление.
Окисление кремния - один из самых характерных процессов в технологии современных ИС. Получаемая при этом пленка двуокиси кремния (SiO2) выполняет несколько важных функций, в том числе:
- функцию защиты - пассивация поверхности и, в частности, защиты вертикальных участков p - n - переходов, выходящих на поверхность;
- функцию маски, через окна которой вводятся необходимые примеси;
- функцию полного диэлектрика под затвором МОП - транзистора.
Такие широкие возможности двуокиси кремния - одна из причин того, что кремний стал основным материалом для изготовления ИС.
Легирование.
Внедрение примесей в исходную пластину (или в эпитаксиальный слой) путем диффузии при высокой температуре является исходным и до сих пор основным способом легирования полупроводников с целью создания диодных и транзисторных структур. Однако, за последние десять лет широкое применение получил и другой способ легирования - ионная имплантация, который рассматривается ниже.
Травление.
Это химические способы изменения рельефа поверхности твердого тела.
Техника масок.
Маски обеспечивают локальный характер напыления, легирования, травления. Всякая маска содержит совокупность заранее спроектированных отверстий - окон. Изготовление таких масок, задача литографии (графирование).
Нанесение тонких пленок.
Существуют три основных метода нанесения тонких пленок на подложку.
- термическое (вакуумное) напыление
- ионно-плазменное напыление;
- электрохимическое осаждение;
Металлизация.
Процесс металлизации призван обеспечить омические контакты со слоями полупроводника, а также рисунок межсоединений и контактных площадок.
Сборочные операции.
Литература
1. А.Н. Игнатов. Методическое указание "Разработка интегрального аналогового устройства", Новосибирск, 1999.
2. П. Хоровиц, Ц. Хила. Искусство схемотехники - Москва.: Мир, 1993г.
. Транзисторы для аппаратуры широкого применения. Справочник под редакцией Б.Л. Перельмана - Москва.: Радио и связь, 1981 г.
. Безладнов. Н.Л. Проектирование транзисторных усилителей звуковых частот - Москва.: Связь, 1978 г.
. Цыкина А.В. Электронные усилители - Москва.: Радио и связь, 1982 г.



 ,
, - площадь резистора.
- площадь резистора.






 ,
,