Содержание
Введение…………………………………………………………………………...7
1. Литературный обзор……………………………………………………………9
2. Обоснование выбора параметров, определяющих аналитические характеристики микрофлюидного чипа………………………………………..23
2.1. Изготовление стеклянных МФУ…………………………………….23
2.2. Изготовление полимерных МФУ…………………………………...28
3. Оборудование и методы исследований………………………………..…….33
3.1. Оптический микроскоп Carl Zeiss Axio Observer D1…………...….33
3.2. Зондовая нанолаборатория NTEGRA Solaris ………………………34
3.3. Установка SPI Module Sputter/Carbon Coater ………………………35
3.4. Экспериментальная установка для измерения контактных углов смачивания…………………………………………………………………….....39
4. Смачиваемость поверхности………………………………………………....42
4.1. Изменение смачиваемости в зависимости от шероховатости поверхности………………………………………………………...42
4.2. Определение контактного угла методом лежащей капли……….47
5. Экспериментальные исследования………………………….…………….....49
5.1. Образцы и материалы………………………………………..…..…..49
5.2. Измерение профиля каналов микрофлюидных чипов, полученных разными методами…………………………………………………………...…..53
5.3. Измерения контактных углов после физической обработки поверхности……………………………………………………………….55
5.4. Измерения контактных углов после химической обработки поверхности…………………………………………………………….....59
5.5. Исследование влияния методов обработки на рельеф поверхности………………………………………………………………...…….63
6. Выводы………………………………………………………………………...70
Заключение………………………………………………………………….……72
Список используемой литературы…………………………………………...…74
Введение
Актуальность и практическая ценность данных исследований обусловлена требованием перехода от единичного производства микрофлюидных чипов (МФЧ) в лабораторных условиях к масштабному производству.
На данный момент микросистемы полного анализа (μTAS и Lab-on-a-Chip) существуют уже более 20 лет, однако за это время появились лишь отдельные коммерческие продукты этой технологии. В значительной степени это обусловлено тем, что на данный момент не существует единых стандартов, которые применялись бы при изготовлении МФЧ. Нет единого регламента, определяющего выбор материалов, технологий обработки и герметизации микрофлюидных чипов, а также методик контроля их основных характеристик.
При выборе основных характеристик чипа, как правило, не учитывается, что на гидродинамические, и как следствие, на аналитические характеристики микрочипа значительно влияют свойства поверхности формируемых микро- и наноструктур, в частности, способность к смачиванию. Кроме того, ряд важных характеристик определяется физико-химическими свойствами поверхности. Таким образом, при реализации любых сепарационных методов на МФЧ все вышеперечисленные свойства будут определять качество разделения пробы на компоненты, т.е. аналитические характеристики чипа. Поэтому необходимой и актуальной задачей становится создание новых и развитие существующих методов контроля характеристик МФЧ на всех стадиях изготовления. Такой подход позволит разрабатывать и создавать современные аналитические приборы и системы на микрочиповой платформе.
Стандартизация размеров и форм, материалов и методов их обработки, методик контроля и измерения основных характеристик МФЧ позволит создать единую базу для разработчиков аналитических приборов на микрочиповой платформе. Кроме того, полученные результаты будут способствовать упрощению процесса создания новых МФЧ, а инженерам позволит продвинуться в разработке новых топологий и конструкций современных приборов.
Целью данного исследования является обоснование, выбор и изучение основных характеристик микрофлюидного чипа, определяющих его аналитические свойства.
В работе использовались прототипы МФЧ полученные:
из полиметилметакрилата – методом лазерной абляции с последующей герметизацией каналов способом термического связывания;
из стеклянных материалов – методами фотолитографии, кислотного травления и герметизацией микроканалов при высокой температуре.
Литературный обзор
Успешному решению ряда фундаментальных и прикладных задач способствует применение микрофлюидных устройств (МФУ). В свою очередь серийный выпуск устройств подобного типа позволит существенно улучшить качество исследований и диагностики в области современной биотехнологии, медицины, биологии, аналитической химии. Однако серийное производство таких систем все еще находится в состоянии исследований и разработок. Одним из основных факторов, замедляющих организацию серийного выпуска устройств, является проблема контроля характеристик МФУ и метрологического обеспечения их измерений [1]. Выполнение отдельных функций в МФУ зависит от наличия разнообразных встроенных элементов: механических, оптических, электрических, химических и прочих. Из-за одновременной интеграции в единой системе устройств разномасштабного характера сложность метрологических измерений повышается. Такую закономерность можно наблюдать, например, при наличии в МФУ, основанном на анализе с применением массива консолей (размеры лежат в нм-диапазоне), жидкостного канала, длина которого достигает нескольких см, а ширина и глубина — несколько десятков мкм, в то время как общий размер чипа составляет несколько см2. В этом случае требуется произвести измерения в диапазоне как минимум 4-х порядков. Вместе с тем очевиден тот факт, что никаким инструментом невозможно достичь приемлемой точности в таком широком диапазоне [2].
Метрология, предназначенная для микроаналитических систем, включающих и микрофлюидные устройства, нуждается в развитии. Это позволит обеспечить требуемое качество компонентов и элементов устройств, а также даст возможность выбора необходимых режимов для технологических процессов, изготовления и формирования как микро-, так и наноразмерных структур с заданными свойствами.
Метрологию принято считать основной дисциплиной, участвующей при создании промышленного производства элементов. Так с ее помощью осуществляется управление технологическими процессами на основании выполненных измерений отдельных конкретных компонентов или определенных характеристик текущего процесса. После этого производится соотношение имеющихся метрологических параметров с полученными размерами структур, включая их возможные допуски. С уменьшением размеров, подвергаемых контролю, до микро- и нанометрового диапазона сама метрология становится более сложной. Микро- электромеханические системы (МЭМС) с точки зрения метрологического обеспечения наиболее схожи с микрофлюидными устройствами. Применение в МЭМС стекла, полимеров, керамики, кварца, различных полимерных и металлических пленок отличает их от продукции полупроводниковой промышленности. За счет этого становится возможным создание управляемых функциональных микросистем. В МЭМС могут входить различные компоненты, в том числе детали микроэлектронной техники, а также микросистемы, содержащие подвижные элементы и устройства. Благодаря механическим и движущимся частям, имеющимся в МЭМС, во время измерений система становятся особенно чувствительными к деформации. Это обуславливает необходимость применения методов, которые способны оказывать минимальное воздействие на элементы. Ряд задач измерения, находящихся в сфере нанотехнологий, связан с поверхностью [3]. Это касается не только размерных и геометрических, но и физико-химических свойств структур.
Сложности при разработке единых подходов метрологического обеспечения измерений многокомпонентных устройств наиболее ярко проявляются в метрологии микрофлюидных устройств. К примеру, отдельные виды МЭМС могут выступать в качестве компонентов микрофлюидной интегрированной системы (МФИС) или так называемой «лаборатории на чипе». Помимо прочего, такие полимерные материалы как поликарбонат(ПК), полиметилметакрилат (ПММА) и полидиметилсилоксан (ПДМС) считаются перспективными для промышленного использования. На сегодняшний день к ним относятся также материалы, используемые в области «бумажной» микрофлюидики. Все это еще больше усложняет метрологическое обеспечение измерений МФУ [4].
Среди важных характеристик МФУ, которые необходимо измерять и контролировать, можно выделить следующие:
ü геометрические и размерные, включающие само устройство, а также его элементы и составные части;
ü электрические и все, что с ними связано — наличие проводимости, сопротивления металлизированных дорожек и прочих компонентов;
ü функциональные, к которым относятся механические, оптические, химические характеристики (последние могут включать в себя реагенты либо наполнения реакционной камеры) и т.д.
Иногда некоторые из вышеприведенных характеристик могут быть связаны друг с другом. В качестве примера можно рассмотреть определение проводимости с помощью измерения толщины металлизированной дорожки и выявления чистоты используемого материала.
Принято выделять следующие виды общих задач измерений, выполнение которых необходимо в микро- и нанометрологии [5]:
ü высоту или глубину реактора, канала либо структуры;
ü ширину реактора, канала или характерный размер структуры;
ü расстояние между границами раздела сред, двумя линиями либо плоскостями в микроструктурах;
ü текстуру и шероховатость;
ü геометрию (форму) — сечение канала или другого элемента;
ü толщину слоев;
ü отношение ширины структуры к его глубине — аспектное соотношение.
Следует отметить, что охватить всю область измерений с целью дать полную характеристику МФУ при помощи перечисленных видов задач измерений невозможно. Если, например, используются эластомерные композиции, то кроме этих задач возникает необходимость в измерении модуля Юнга, то есть контроле упругости локальных участков поверхности.
Метрологический процесс значительно осложняется тем, что измерения должны производиться в процессе получения (формирования) структур. В некоторых случаях основополагающими операциями становятся точность наложения маски и позиционирования, например, при создании многослойных устройств или аналогичных систем. Контролирование и измерение толщины образуемых пленок также является нетривиальной задачей, т.к. одновременно необходимо контролировать состояние материала с целью предотвращения появления на нем каких-либо загрязнений, а также изменений его свойств и характеристик во время обработки [2].
Все структурные элементы, входящие в МФУ (даже при рассмотрении самого простого микрофлюидного чипа (МФЧ)) обладают рядом геометрических характеристик: формой, размерами, пропорциями, способными определять течение жидкости. Свойства материала, используемого для изготовления структур, влияют на характеристики, от которых зависит движение частиц либо молекул аналита и самой жидкости. Благодаря таким свойствам можно наблюдать разнообразные поверхностные эффекты, сложные электромеханические процессы и пр. Акцентируем внимание на том, что в МФУ можно встретить компоненты различных размеров, начиная от нм и доходя до тысяч мкм.
Для контроля таких МФУ необходимо получение данных на нескольких размерных уровнях, включая нанометровые размеры (шероховатость поверхности и др.), микрометровые (диаметр реакционной камеры, ширина и глубина структур), миллиметровые (длина канала, радиус его изгиба, размеры микрореакторов). В связи с тем, что требуется получение всей информации о конкретном МФУ, то возникает потребность в измерениях всего размерного диапазона с помощью одного прибора. Однако на данный момент не существует ни одной методики измерения МФУ, которая позволила бы достичь высокого разрешения при большом поле зрения. Т.е. невозможно применение одного и того же инструмента для получения абсолютно всех требуемых сведений об имеющихся свойствах и характеристиках, представляющих важность для работы МФУ [6]. Чаще всего получить все результаты измерений удается с помощью нескольких инструментов, что вызывает впоследствии определенные затруднения при сравнении, интерпретации и согласовании данных, полученных разными приборами. Значительная площадь измерений с разрешением в нм может быть достигнута посредством методов «сшивки» изображений. При этом необходимо обеспечить реперные точки, с помощью которых можно будет ориентировать отдельные локальные изображения относительно друг друга. Применение методов сканирующей интерферометрии (СИ), конфокальной лазерной сканирующей микроскопии (КЛСМ) и атомно-силовой микроскопии (АСМ) обеспечивает получение изображения с достаточно протяженного поверхностного участка, при этом уровни разрешения будут зависеть от используемого способа. Так, метод КЛСМ обеспечивает грубое качество изображения, которое позволяет сделать оценку высоты или глубины формируемых микроструктур, а метод АСМ — четкие детальные изображения, разрешение которых высоко. Для получения изображения с максимально высоким разрешением участка большой протяженности (АСМ способ) требуется изначально произвести распределение меток, предназначенных для дальнейшей «сшивки» снимка. При этом площадь всех отдельных участков и метки на них должны определяться возможностями конкретного метода и применяемого прибора. Так как метод АСМ способен выдать максимальное значение пространственного разрешения, то метки будут ограничены максимальным полем зрения данного микроскопа. Расположение меток фиксируется с помощью прибора, обладающего наибольшим полем зрения — КЛСМ или СИ. Следует учитывать, что высота измерений (если необходимо провести точные измерения) будет ограничена возможностью АСМ, глубокие структуры сложно точно измерить. В работе [6] был предложен метод сшивания профиля изображений, в котором используется перекрытие координатных маркеров для выравнивания и «сшивания» отдельно измеренных профилей устройства. Измерения микрофлюидных каналов, проведенные с помощью атомно-силового микроскопа, сшиты с точностью 0,086 мкм. Использовалось сочетание АСМ и сканирующего интерферометра белого света.
Оказывающие на работу МФУ факторы можно отнести к трем категориям, на которые в свою очередь, влияют следующие параметры [4]:
ü размеры и геометрия микроструктур, включая ширину канала, его глубину и длину, форму сечения, высоту структур, перпендикулярность образующих поверхностей, а также параллельность стенок каналов;
ü свойства поверхности, включая топологию поверхности, ее шероховатость и химические свойства, биосовместимость;
ü суб-поверхностные свойства, включая дефекты различного характера, такие как образование пузырьков в толщине слоя или на границах фаз, характеристики межслойных границ, а также дефекты, возникающие при пересечении каналов.
В зависимости от того, какой метод производства используется при изготовлении МФУ из полимерных материалов, могут появляться разнообразные источники погрешности, способные вызывать отклонения размеров выпускаемых элементов. Так, например, при грубой отделке мастер-форм необходимых для репликации устройств, все дефекты формы переходят на формируемую деталь. Отклонение от разработанного технологического процесса также способно привнести в изделие определенные искажения и дефекты. Для предотвращения подобного результата необходимо периодически контролировать характеристики реплицируемых изделий и оперативно устранять или корректировать выявленные источники ошибок.
При проведении измерений в микро- и нанометрологии наиболее часто пользуются следующими методами:
ü интерференционными, включая сканирующую интерферометрию (СИ);
ü микротопографическими, включая оптическую микроскопию, стилусную профилометрию, СЗМ;
ü методами сканирующей электронной микроскопии.
Посредством механических стилусных профилометров обычно измеряются твердые материалы в сравнительно больших диапазонах — около 100 мкм. Приборы позволяют определить высоту компонентов до нескольких мм иногда с нанометровом разрешением, а сама площадь измерений при этом может составлять сотни мм. Стилус представляет собой алмазный наконечник с углом при вершине 60 или 90о и радиусом скругления в диапазоне от 1 до 10 мкм. Таким стилусом можно обнаружить склоны поверхности 60 и 45о соответственно. В среднем разрешение стилусных профилометров находится в диапазоне 2-20 мкм, зависит от геометрии зонда, от характеристик измеряемой поверхности (склон поверхности, перепад высот и т.д.). Помимо этого, сила давления стилуса на поверхность может приводить к пластической деформации, что делает этот метод неприемлемым при измерениях мягких и эластичных поверхностей.
Использование оптических методов сканирования применяется в таких приборах, как конфокальные микроскопы, оптические профилометры и интерферометры. Такие методы проведения бесконтактных измерений позволяют получить информацию о мягких поверхностях. Но в этом случае следует учитывать ошибки, возникающие из-за отражения от поверхности исследуемого элемента фонового и полезного сигналов. Прибор с лазерным источником излучения дает возможность преобразовать излучение в фокусированное пятно, диаметр которого обычно составляет не менее 1 мкм. С помощью оптических приборов возможно обнаружение угла наклона поверхности равного 15о. В свою очередь лазерную конфокальную микроскопию следует рассматривать как иную оптическую технику, в основе которой лежат принципы фокусировки излучения в области небольшого размера, а также регистрации отраженного и рассеянного излучения от этой области. С помощью сканирования определенной плоской поверхности получается изображение отраженного света от данной плоскости, а при сканировании объема строится распределение отражения от участка образца в пространстве. При использовании конфокального микроскопа можно проводить исследования крутых участков поверхности с углом наклона, доходящим до 75о. У самого конфокального микроскопа пространственное разрешение (аксиальное и латеральное) ограничено уровнем 0,2-0,3 мкм.
Для реализации скоростного высокочастотного циклического измерения или для бесконтактного измерения плоских поверхностей в реальном времени необходимо сочетать оптическую микроскопию и интерферометрию, также называемую интерференционной микроскопией. При измерении поверхностей, средняя шероховатость которых достигает 0,1 нм при высотах до нескольких миллиметров, необходимо высокое аксиальное разрешение и большой диапазон измерений высот. Достичь субнанометрового разрешения позволяет использование интерферометрических методов. Латеральная разрешающая способность оптического микроскопа составляет около 400 нанометров ввиду ограничения дифракционным пределом. При использовании интерферометрии невозможно обнаружить наклон поверхности, превышающий значение 30о. Методами интерферометрии можно получить только 3D профили однослойных образцов, а в настоящее время достаточно много разработок многослойных МФУ. Дисперсия материала, из которого состоит пленка, а также отражение света от границы раздела сред сильно влияют на точность, если измеряется толщина слоя. Ввиду того, что боковая поверхность микроканала отражает световой поток крайне малой интенсивности, интерферометр не может ее зарегистрировать.
Благодаря методам СЗМ, а также АСМ, есть возможность проводить измерения с высоким пространственным разрешением. Для использования СЗМ требуется минимальная подготовка образцов. Метод позволяет проводить измерения на площади до 100 мкм2 при локальных изменениях высоты до 10 мкм с горизонтальным разрешением от 2 до 10 нм, а с вертикальным порядка 0,1 нм. Для этого в коммерческих целях созданы кремниевые зонды с радиусом кривизны до 10 нм, а одной из последних разработок являются зонды с углеродными нанотрубками диаметром около 0,5 нм. Минусом использования таких зондов, приводящих к ошибкам измерения, связанным с размерами зонда, является его механический контакт с поверхностью. Поэтому точное измерение боковой поверхности канала практически не осуществимо, в частности при вертикальном размере структуры, превышающем несколько микрон, а также при высоком аспектном соотношении. Некоторые топографические особенности поверхности, например, форма ступеньки или неоднородности, сравнимой с размером зонда будут сглажены (скруглены) на получаемом изображении. Применение зондов с малым радиусом скругления не всегда позволяет точно отобразить поверхность пластичного объекта, так как требуется длительная и кропотливая работа по выбору режимов измерений. Использование методов конфокальной микроскопии позволяет улучшить латеральную разрешающую способность микроскопов примерно на 20% по сравнению с обычными микроскопами. Существенным в конфокальной микроскопии является ограничение, связанное с тем, что аксиальное и латеральное разрешение зависит от объектива. Наименьшее теоретическое значение латерального разрешения составляет около 300 нм, а аксиальное – порядка 700 нм для длины волны 550 нм для объектива с числовой апертурой 0,9. Лишь при использовании источников УФ-излучения можно добиться более высокого разрешения, но при измерении полимеров это не дает результата, т.к. полимерные материалы значительно рассеивают и поглощают в ультрафиолетовой области. Трехмерные реконструкции изображений методом комбинирования двухмерных изображений на разных глубинах, можно получить благодаря использованию конфокальной микроскопии. Это дает возможность определить размеры пузырьков, толщины пленки и др. дефектов в МФУ. Варианты функционального тестирования МФУ возможно при применении флуоресцентных красителей для визуализации движения потоков жидкости в каналах.
Одним из методов микроскопии с высоким разрешением, существующий порядка нескольких десятков лет, является сканирующая электронная микроскопия (СЭМ). Ее принцип работы состоит в том, что образец сканируется электронным пучком, причем эффекты, полученные в результате взаимодействия между поверхностью образца и пучком, могут быть использоваться для характеристики химических и физических свойств исследуемого образца. СЭМ проявляет уникальные свойства и в топографии, которые не наблюдаются ни в одной другой микроскопии. К этим свойствам относят максимальное увеличение с разрешением до 2 нанометров, возможность изменения увеличения в широких пределах (100х-100.000х), большое рабочее расстояние и глубина резкости, минимальные эффекты дифракции и возможность элементного анализа [7]. У метода СЭМ есть и недостатки: относительно медленная скорость измерений, необходимость использования образцов из проводящих материалов или специального покрытия поверхности образца проводящим материалом (золотом), ограничение при измерении диэлектрических образцов и необходимость в высоком вакууме для осуществления измерений. Методы СЭМ могут быть использованы для качественного анализа рельефа поверхности, т.к. визуализация с высоким разрешением достигается за счет высокой глубины резкости этого метода. По существу СЭМ- изображения являются двухмерными и непосредственно из таких изображений получают информацию о высоте структур. Построение трехмерных изображений возможно путем реконструкции из нескольких изображений. Тем не менее, этому препятствуют некоторые факторы. Главным ограничением выступает то, что параметры шероховатости должны быть рассчитаны на сравнительно большую площадь в то время как, при больших увеличениях, область измерения является относительно небольшой. Также, немаловажным является то, что реконструкция гладких поверхностей весьма затруднительна из-за малого количества (а иногда отсутствия) узнаваемых признаков [2].
В работе [4] рассмотрены 3 метода: интерферометрии, атомно-силовой микроскопии и конфокальной микроскопии для измерений характеристик МФУ. Использование АСМ дает преимущество высокого пространственного разрешения, но метод пригоден только для локальной характеристики поверхности в связи с длительным временем сканирования. Методом АСМ невозможно проводить измерения объектов больше нескольких микрон или структур с высоким аспектным соотношением. Интерферометры, основанные на сканировании, достигают нанометрового разрешения и используются для быстрого измерения больших полей зрения. Благодаря конфокальной микроскопии стало доступным измерение трехмерных объектов и ее использование для обнаружения суб-поверхностных дефектов.
В таблице 1 приведены данные, характеризующие различные методы измерений, которые могут быть использованы при исследовании и контроле элементов МФУ.
Сложными и важными элементами метрологического обеспечения являются эталоны и стандартные инструменты. Нанометровый диапазон (от 0,1 нм до 100 нм) – переходная область между атомно-молекулярной физикой и механикой сплошных сред. Именно здесь (мезоскопическая область) является крайне затруднительным описание взаимодействия измеряемой структуры и зонда (датчика). Но в то же время это необходимо для достижения надежного и правильного результата измерения. Также очень сложно создать эквивалент прямого края, либо другие эквиваленты объектов обычных для макромира. В данном случае важную роль при получении результатов играет влияние метода измерения (длина волны излучения, размер зонда и т.д.). Не существует также единых стандартов для отдельно взятых областей измерения с использованием метода АСМ (например, шероховатость поверхности). Имеющиеся стандарты изготовлены из неорганических материалов, а для нанотехнологий (мониторинг, проведение измерений, производство) во многих случаях необходимо использовать органические материалы для стандартов (особенно при измерениях живых клеток и подобных структур). Хотя на данный момент нет четких рамок отслеживания и содержания стандартов вне пределов национальных метрологических служб и институтов, на рынке уже есть тестовые образцы, производимые некоторыми коммерческими компаниями и позиционируемые как стандарты, изготовленные их полупроводниковых материалов. Главной на данный момент является задача создания и разработки физических стандартов шероховатости и свойств поверхности, ее формы (асферичность, сферичность либо плоскостность) для керамики, металла, стекла, неорганических материалов. Эти стандарты необходимо вводить совместно с процедурами калибровки. Также требуется решить задачи моделирования взаимодействия исследуемой структуры с измерительным инструментом именно на этапе разработки наноразмерных стандартов. Организация межлабораторных (не исключая международные) сравнений является не менее важным направлением деятельности метрологии [2].
Таким образом, на настоящий момент времени не существует единого эффективного подхода для того, чтобы проводить адекватные измерения характеристик МФУ как в процессе их изготовления, так и при выходном контроле изделий. Ввиду этого крайне актуальной выглядит разработка, исследование, создание и развитие методов, которые позволять характеризовать МФУ в широком диапазоне размеров из материалов различного типа. Выбор наиболее приемлемой технологии производства и минимизация затрат на технологические процессы при тиражировании МФУ возможны при контроле размерных характеристик устройства.
Таким образом, восстребованным является развитие методов измерения и контроля основных функциональных параметров МФУ, поскольку эти характеристики определяют аналитические характеристики (воспроизводимость, точность получаемых результатов, время анализа и т.п.), а также эксплуатационные свойства (возможность регенерации, пригодность устройства для последующих анализов). Совершенно новой областью измерений является измерение и контроль поверхностных свойств структур при модификации. В данном случае актуальными являются задачи: придания поверхности определенных одинаковых (однородных) свойств на заданном участке (от микронных до сантиметровых размеров), контроль сплошности покрытия (если производится модификация другими материалами, физическим или химическим методами) и контроль размерных характеристик модифицированных поверхностей.
Таблица 1
Характеристики некоторых методов, используемых при измерениях МФУ [2, 4, 6].
| Метод
| Латераль-ный размер сканирова- ния, мкм
| Латераль-ное разрешение, нм
| Диапазон по вертика-ли, мкм
| Вертика-льное разреше-ние, нм
| Ограничения
|
| Стилусная профилометрия
| -
| 2000-20000
| До неск. мм
| До 3-5 (предель-ное)
| Силовой контакт при измерении, влияние геометрии наконечника
|
| СИ
|
| ≈550
|
| <1
| Дифракционные явления
|
| АСМ
|
| <10
|
| <1
| Низкая скорость сканирования, ограниченная область измерений
|
| СБОМ
|
| 20-50 (наилучшее), 100 – типичное
|
| ≈1
| Низкая скорость сканирования, ограниченная область измерений
|
| КЛСМ
| 100 (1500)
| ≈250 (300)
|
| <800 (750)
| Ограниченно латеральное и аксиальное разрешения
|
Выявлено, что наиболее существенными параметрами для микрофлюидики являются: шероховатость поверхности, смачиваемость поверхности (гидрофильная или гидрофобная), геометрические характеристики микроканалов (форма сечения, длина, ширина каналов), физико-химические характеристики материала микрочипа. При использовании электрокинетических методов разделения (анализа) пробы в МФЧ качество разделения пробы на компоненты и, следовательно, аналитические характеристики, также будут зависеть от указанных параметров микрочипа и характеристик пробы и реагентов.
В ходе реализации проекта будет проведен обоснованный выбор наиболее существенных характеристик МФЧ, которые необходимо контролировать в процессе изготовления. Предполагается проведение исследований и выбор наиболее приемлемого метода контроля этих характеристик. В качестве объектов исследований будут использованы прототипы микрофлюидных чипов для электрофоретического разделения пробы, полученных методом лазерной абляции поверхности полимера, а также методом фотолитографии и кислотного травления стеклянной подложки. Будут проведены измерения профилей каналов указанных МФЧ.
Предполагается проведение изучения и анализа влияния основных технологических погрешностей изготовления МФЧ на его характеристики.
Будут проведены исследования по выявлению возможности направленного изменения свойств поверхности (при физической и химической обработке) с целью улучшения аналитических характеристик микрочипа.
Полученные результаты будут подвергнуты анализу, в результате которого будут выработаны рекомендации для их практического применения и рассмотрена перспектива дальнейших исследований.
Изготовление стеклянных МФУ
Исходная заготовка представляет собой стеклянную пластину, на которую нанесен слой хрома (100-150 нм) и слой фоторезиста (0,56±0,02 мм).
1-й этап: разработка топологии – рисунок с каналами, реакторами и др. структурами (CAD).
2-й этап: Изготовление фотошаблона.
На данном этапе необходимо контролировать следующие параметры:
ü фотошаблон – плоская структура, контролируются только размеры, соответствующие плоским объектам;
ü ширину канала;
ü длину канала;
ü диаметр реакторов и микрокамер;
ü точность формирования рисунка.
3-й этап: перенос рисунка фотошаблона на заготовку под действием УФ-излучения. Применение метода оптической микроскопии для контроля. Обработка растворителем (щелочью).
4-й этап: снятие слоя хрома. Профилометры. Оптическая микроскопия.
5-й этап: снятие экспонированного фоторезиста. Оптическая и интерференционная микроскопия, КЛСМ.
6-й этап: травление стекла. Скорость травления контролируется по образцу-свидетелю (обычно – плоской пластины, толщина которой измеряется в процессе травления).
7-й этап: снятие хрома. Последующий контроль полученных структур. Глубина каналов (от мкм до 200 мкм) – КЛСМ, интерференционная микроскопия. Длина канала от 2 мм до 100 мм, диаметр реакторов от 50 мкм до мм.
На данном этапе необходимо контролировать параметры:
ü высоту или глубину реактора, канала либо структуры;
ü ширину канала;
ü текстуру и шероховатость;
ü геометрию (форму) — сечение канала;
ü длину канала;
ü размеры реакторов и микрокамер;
ü отношение ширины структуры к его глубине — аспектное соотношение;
ü свойства поверхности (гидрофильность/гидрофобность);
ü точность формирования рисунка.
8-й этап: подготовка к герметизации. Здесь контролируется чистота поверхности, ее смачиваемость и т.д.
9-й этап: склеивание и термическое связывание.
Термическое связывание: высокотемпературное от 500 до 1200 оС. Низкотемпературное (анодное связывание) от 90 до 350 оС. 200-1500 В. Выходной контроль полученного чипа – методы КЛСМ, оптической интерферометрии, эллипсометрии и т.п.
Фотолитография – процесс формирования на поверхности подложки требуемых элементов устройства с помощью чувствительных к высокоэнергетическому излучению (ультрафиолетовому свету, электронам, ионам, рентгеновским лучам) покрытий, способных воспроизводить заданное взаимное расположение и конфигурацию этих элементов.
На рис. 1 показано схематическое изображение литографического процесса.

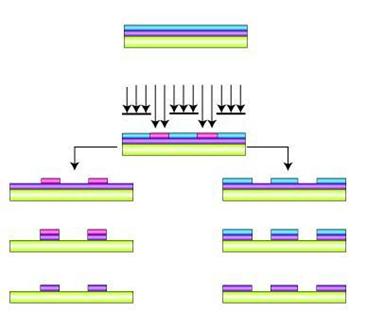
| | | | | | | | |
| | |  |
| |
| | |
| | | |
| |
| |
| | | | Кислотное травление:Фтористоводородная (плавиковая) кислота
| |
Рис. 1. Схематическое изображение фотолитографического процесса.
Процесс литографии состоит из следующих стадий.
1. Очистка поверхности подложки и подготовка ее к нанесению слоя фоторезиста. Этап состоит из механической (в том числе и ультразвуковой) обработки, химических обработок, удаляющих органические загрязнения, плазмохимического травления тонких слоев.
2. Нанесение слоя фоторезиста на поверхность подложки и его сушка. Обычно эту операцию осуществляют при помощи нанесения капли фоторезиста на быстро вращающуюся подложку, закрепленную на роторе центрифуги. Сушка необходима для удаления остатков растворителя. Правильный выбор ее режимов позволяет уменьшить дефектность слоя и улучшить воспроизводимость результатов фотолитографии.
3. Избирательное экспонирование фоторезиста УФ светом. Такую операцию можно осуществить облучением светочувствительного слоя через фотошаблон.
4. Проявление изображения в слое резиста (например, избирательное удаление экспонированных участков – в случае позитивных резистов или избирательное удаление неэкспонированных участков – в случае негативных резистов). Этот этап определяет функциональные характеристики резистных масок, а также технологические параметры фотолитографии. При проявлении используется разница в устойчивости экспонированных и неэкспонированных участков слоя фоторезиста по отношению к действию проявляющего химического вещества (агента) или физического воздействия (например, нагревания).
5. Модификация поверхнос