В толстопленочной технологии изготовления гибридных ИС используются материалы и технологии близкие к технологии изготовления печатных плат. В качестве подложки и используются фольгированный текстолит и гетинакс. В качестве проводников, пластин конденсаторов и элементов индуктивности используется фольга или гальваническое и химическое осаждение металлов: Al, Cu, Ag, Au. Для изготовления резистивных элементов используют эмульсии и суспензии содержащие NiCr или SiCr. В качестве диэлектриков используют эпоксидные смолы, силиконовые резины, лаки. Процесс изготовления гибридных ИС по толстопленочной технологии сходен с типографским процессом печати книг. Все требуемые материалы подготавливают в виде суспензий, эмульсий, лаков, красок. Методом печати наносят защитный слой кислотоустойчивого лака на фольгу гетинакса. После сушки производят травление металла в растворе кислоты. Затем печатью последовательно наносят резисторы, изоляторы, обкладки конденсаторов. Далее, после сушки, впаивают нелинейные и активные элементы (диоды, транзисторы). На последних этапах изготовления ИС наносят защитные диэлектрические покрытия и упаковывают схему в пластмассовый или металлический корпус. Гибридные ИС имеют специальное функциональное назначение, выполняются небольшими партиями, каждый тип микросхемы может иметь свою уникальную технологию.
В тонкопленочной технологии процесс изготовления полупроводниковых ИС состоит из следующих основных этапов: диффузии, эпитаксиального выращивания, оксидирования, фотолитографии, селективного травления и вакуумного осаждения тонких пленок. Некоторые из них повторяются по несколько раз.
Материалы. В качестве подложек полупроводниковых тонкопленочных ИС используют пластины из кристаллического кремния, арсенида галлия, фосфида галлия. Наибольшее распространение получила кремниевая технология, в которой используются стандартные планшайбы из легированного кремния толщиной 0,5 мм и диаметром 70, 100 и 150 мм. Пластины поставляют в виде дисков с шлифованными и полированными поверхностями. Непосредственно перед процессом изготовления их протравливают в растворе плавиковой кислоты, промывают в деионизованной воде и сушат потоком фильтрованного воздуха.
В основе изготовления тонкопленочных микросхем лежат вакуумные процессы последовательного нанесения тонких пленок на планшайбу.
Рассмотрим кратко перечисленные технологические процессы.
Диффузия. Большинство методов образования р-n -переходов в ИС основано на использовании явления диффузии в твердом теле. Современная кремниевая технология получения микросхем основана на диффузии легирующих присадок в кремниевой пластине при температуре 1000-1300о С. Обычно, берут кремниевую пластину (подложку), легированную акцепторной примесью - бором (р -область) и помещают её в диффузионный кварцевый реактор. При температуре 1200оС в реактор подают газ с донорной примесью (например, фосфор). Если нижняя часть подложки защищена, то после обработки в течение 30 минут на глубине 0,1 мм от верхней поверхности, где концентрация донорной и акцепторной примесей равны, образуется р-п -переход. При дальнейшем пребывании в реакторе р-п -переход будет смещаться вглубь подложки.
Для формирования р-п-р -перехода необходимо чередовать подачу газа с разными легирующими примесями. В результате в подповерхностном слое создается распределение диффундирующих веществ с р- п- и р- областями, характерными для биполярных транзисторов.
Окисление. Тонкая пленка двуокиси кремния (SiO2, кварц) является хорошим изолирующим материалом. Она прочна, однородна, не имеет пор, химически инертна, имеет хорошую адгезию с кремниевой поверхностью, хорошо защищает поверхность микросхем от воздействия окружающей среды. Пленка SiO2 широко используется для маскирования поверхности кремния при проведении диффузии, так как она препятствует диффузии легирующих примесей в кремниевую подложку. Равномерную пленку двуокиси кремния получают на подложке в диффузионном реакторе при температуре 1200оС подачей влажного (с водяным паром) или чистого (сухого) кислорода. Поверхностный слой кремниевой пластины окисляется кислородом с образованием пленки SiO2. Для эффективного маскирования требуется пленка толщиной от 0,2 до 1 мкм. Для удаления пленки в соответствующих местах (под контакты или для диффузии) методом фотолитографии (см. далее) наносят защитный рисунок из фоторезиста, а затем протравливают пленку методом ионно-плазменного травления фторсодержащим газом (фреоном).
Пленки двуокиси кремния могут синтезироваться на поверхности полупроводниковой структуры из тетрахлорида кремния (SiCl4) в кислородной среде по следующей реакции: SiCl4 + О2 ® SiО2 + 2Cl2. При температуре выше 1200оС тетрахлорида кремния разлагается на кремний и хлор. Хлор улетучивается, а кремний соединяется с кислородом и осаждается на поверхность полупроводниковой структуры в виде пленки SiО2.
Эпитаксиальное выращивание. Это такой процесс, в результате которого атомы нового вещества надстраиваются на монокристаллическую подложку, повторяя её структуру. При жидкостной и газовой эпитаксии атомы беспорядочно движутся вдоль кристаллической поверхности, пока не займут устойчивое положение и не образуют жесткую структуру, повторяющую структуру поверхности кристалла. Этот процесс похож на рост природных и синтетических кристаллов. Он отличается тем, что наращиваемые слои имеют другое атомное строение и, потому, упорядоченность атомов после несколько атомных слоев нарушается. Основным требованием при эпитаксиальном выращивании является близость межатомного расстояния наращиваемого вещества и вещества подложки.
В последнее время интенсивно развивается новое направление – молекулярно-пучковая эпитаксия. В этом процессе эпитаксиальное выращивание пленки с упорядоченной кристаллической структурой производится в вакуумной установке молекулярным (или атомным) пучком, формируемым дуговым, плазменным или магнетронным распылением вещества. Пучок молекул падает на поверхность подожки. Отличительной особенностью молекулярно-пучковой эпитаксии от вакуумного напыления является то, что подложка нагревается до высокой температуры (для кремниевой технологии до 1000оС). При этом молекулы (атомы) не могут сразу закрепиться на поверхности кристалла, и, за счет температурных колебаний, перемещаются по поверхности кристалла до ближайшей границы роста. Здесь они занимают устойчивое положение с прочными молекулярными связями кристаллической решетки и начинается рост кристаллического слоя.
Фотолитография. Для формирования заданного микроскопического рисунка на поверхности кремниевой подложки, по которому необходимо проводить диффузию необходимо нанести слой двуокиси кремния и в нем протравить соответствующие «окна». Для этого на пластину кремния со сплошным слоем двуокиси толщиной около 1 мкм наносится слой светочувствительного вещества (фоторезиста). Затем пластину накрывают металлической маской (на фотопленке) с фотоизображением схемы (фотошаблоном) с прозрачными и непрозрачными областям и облучют ультрафиолетовым (УФ) светом. Под прозрачными участками УФ свет полимеризует фоторезист, и он становится нерастворимым в трихлорэтилене, в то время как неполимеризованный хорошо растворяется в нем. После обработки в трихлорэтилене на поверхности подложки фоторезист остается только в местах подверженных УФ-свету, т.е. под прозрачными местами маски. Затем пластину помещают в сосуд с разбавленной плавиковой кислотой, которая в течение нескольких минут растворяет двуокись кремния в местах незащищенных фоторезистом. Полимеризованный фоторезист удаляют горячей серной кислотой и подложка готова к процессу диффузии.
Для изготовления микросхемы требуется нанесение нескольких слоев с разным типом легирования в разных местах подложки. Для этого изготавливают несколько фотошаблонов с разными рисунками и метками совмещения. После проведения одной операции диффузии снова окисляют поверхность, наносят фоторезист, устанавливают фотошаблон, совмещая под микроскопом метки совмещения, и повторяют операции фотолитографии и диффузии. Таким образом, благодаря процессу фотолитографии можно получить на одной кремниевой пластине до 100 микросхем 4-й или 5-й степени интеграции.
Вакуумное напыление. Осаждение тонких пленок металла в соединительных проводниках ИМС, для формирования резисторов, конденсаторов и индуктивностей, производят методом вакуумного напыления. При термическом напылении металл в «лодочке» из тугоплавкого материала нагревается высокочастотным индуктором до высокой температуры. Металл плавится, начинает испаряться и оседать (конденсироваться) на соседние, более холодные поверхности, покрывая их тонким слоем. Если кремниевую пластину накрыть трафаретом, или использовать технику фотолитографии, то на ней можно создать все перечисленные тонкопленочные элементы. Благодаря вакууму получают хорошую адгезию к кремниевой подложке и однородные плотные слои металлических пленок толщиной от 0,5 до 1 мкм.
По методу испарения металла, вакуумное напыление разделяют на: термическое (нагрев), дуговое (в дуге электрического тока), электронно-лучевое, катодное распыление, магнетронное распыление, лазерное испарение. По типу осаждения на поверхность выделяют обычное (на холодную поверхность), эпитаксиальное (на горячую) и ионное осаждение. При последнем способе создается разность потенциалов между нагреваемым металлом и подложкой. Ионное осаждение упорядочивает поток молекул металла и дает повышенную адгезию (прилипание) пленки к подложке.
Химическое осаждение из газовой фазы. Этот метод заключается в том, что в реактор подается газовая или парогазовая смесь и реактор нагревается. Под действием высокой температуры происходит разложение вводимых химических веществ и образование новых веществ, которые оседают на поверхность подложки.
Химическим осаждением из газовой фазы можно получить все необходимые для микроэлектроники типы тонких пленок – изолятор, проводник и полупроводник.
Анодирование. Наиболее распространен метод анодного окисления танталовой плёнки в окись тантала, которая служит диэлектриком конденсатора. К танталовой пленке, служащей анодом, прикладывается напряжение. В качестве электролита используют раствор уксусной кислоты. На пленке образуется равномерный слой окиси тантала, толщина которого зависит от приложенного напряжения. Затем снова осаждают металл. В результате формируются конденсаторы большой емкости со стабильными характеристиками.
Процессы металлизации, плазмохимического осаждения и анодирования проводят с использованием фотолитографии и травления. Обычно поверхность кремниевой планшайбы (подложки) окисляют. Методом фотолитографии наносят защитный рисунок из фоторезиста. Удаляют двуокись кремния плазмохимическим или химическим травлением, проводят диффузионные процессы. Там, где должны быть контакты напыляют тонкий (1 мкм) слой алюминия. Далее опять проводят процессы фотолитографии, анодирования, нанесения новых металлических пленок.
Последовательность изготовления планарных ИС
На рис. 3.1 показана полупроводниковая микросхема транзисторного усилителя - инвертора в интегральном исполнении и его электрическая схема (элементы для наглядности расположены в одну линию над структурой).
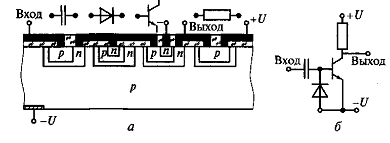
Рис. 3.1. Структура (а) и схема (б) усилительного каскада полупроводниковой интегральной микросхемы
Все элементы усилительного каскада размещены в одной кремниевой пластине р -типа. Для исключения взаимного влияния активные и пассивные элементы размещаются в островках, изолированных от подложки. Сверху подложка защищена изоляционным слоем, на который нанесены проводящие дорожки, соединяющие элементы между собой.
Активные элементы полупроводниковых микросхем (транзисторы, диоды, тиристоры и оптоэлектронные приборы) состоят из одного или более р-п -переходов. Любой р-п -переход обладает барьерной емкостью аналогично плоскому конденсатору, и такие конденсаторы чаще всего и применяются в микросхемах. В качестве резисторов используются участки полупроводника, обычно ограниченные р-п -переходами, т. е. слой кремния может выполнять функции резистора, а р-п -переходы могут быть границами.
Таким образом, в полупроводниковом кристалле с р-п -переходами можно создать набор элементов, достаточный для большинства радиотехнических схем. Наиболее трудно создать в интегральном исполнении индуктивность требуемых номиналов и добротности.
Для производства микросхем применяется планарная технология, позволяющая одновременно получать большое число микросхем в едином технологическом процессе. Для изготовления микросхем наиболее удобными оказались пленки кремния, полученные методом эпитаксиального выращивания. В этом случае процесс изготовления микросхем называется планарно-эпитаксиальным.
Основой современных информационных технологий является работа вычислительных устройств с цифровыми данными, представленными в двоичных цифровых кодах. Современные системы передачи информации также работают с двоичными цифровыми последовательными кодами в режиме импульсно-кодовой модуляции. При этом обеспечивается высокая помехоустойчивость и точность передачи. Цифровая обработка данных также обеспечивает высокую точность получения конечного результата.
Представление информации в двоичной цифровой форме используется и в микропроцессорных устройствах, широко применяемых в системах автоматики и управлении технологическими процессами на промышленных предприятиях и в бытовой технике.